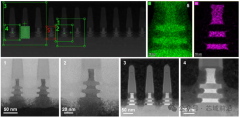 [芯片制造] 半导体失效分析(Failure Analysis)简介 日期:2026-04-19 15:03:00 点击:155 好评:4
[芯片制造] 半导体失效分析(Failure Analysis)简介 日期:2026-04-19 15:03:00 点击:155 好评:4
为什么先进芯片越难做,越离不开FA?半导体失效分析全景图 很多人第一次听到半导体失效分析FA(Failure Analysis),脑子里会自动浮现一个画面:工程师拿着工具,把坏芯片切开、磨开...
 [芯片制造] 车规芯片到底比普通芯片多测了什么? 日期:2026-04-07 21:50:11 点击:159 好评:0
[芯片制造] 车规芯片到底比普通芯片多测了什么? 日期:2026-04-07 21:50:11 点击:159 好评:0
今天就先聊两个最核心的测试组: A组(环境应力)和 B组(寿命与封装可靠性) 。 一、A组:环境应力测试 A组的逻辑其实很简单: 模拟汽车环境。 车里的芯片环境有多恶劣? 东北的...
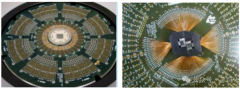 [芯片制造] 晶圆CP开发调试与量产测试流程 日期:2026-03-29 20:44:22 点击:146 好评:0
[芯片制造] 晶圆CP开发调试与量产测试流程 日期:2026-03-29 20:44:22 点击:146 好评:0
晶圆探针测试(Chip Probe Test,晶圆探针测试)是在晶圆切割前,对每一个裸片(Die)进行电性能和基本功能的筛选。它的作用是尽早剔除不良Die,降低封装成本、提升成品率和出货质量...
 [芯片制造] 生活中常见的芯片类型有哪些? 日期:2026-03-05 18:35:00 点击:122 好评:0
[芯片制造] 生活中常见的芯片类型有哪些? 日期:2026-03-05 18:35:00 点击:122 好评:0
在智能化时代的今天,芯片无处不在。它们融入到手机、家电、汽车、医疗设备、办公用品等各种各样的智能电子设备里。芯片为现代生活带来了便捷与智能。那么,生活中都有哪些常...
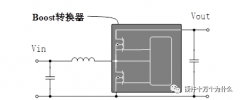 [芯片制造] Boost电路的工作过程 日期:2025-12-07 17:49:00 点击:329 好评:2
[芯片制造] Boost电路的工作过程 日期:2025-12-07 17:49:00 点击:329 好评:2
Boost电源电路是一种DC-DC升压电路,能够将低电压升高到较高电压。其基本原理是利用电感储能和电容储能的方式,通过开关管的开关控制,将输入电压进行短时间内的变化,从而使输出...
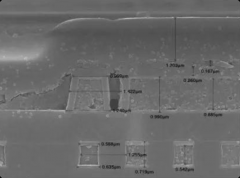 [芯片制造] 芯片失效分析(FA)介绍 日期:2025-12-05 21:39:41 点击:298 好评:2
[芯片制造] 芯片失效分析(FA)介绍 日期:2025-12-05 21:39:41 点击:298 好评:2
失效分析 (Failure Analysis,简称FA) 是对已失效的半导体器件进行的一种事后检查活动。它依据失效模式和现象,通过电测试及必要的物理、化学分析技术,探究并验证失效行为,最终...
 [芯片制造] 芯片制造中的OCD是什么? 日期:2025-12-04 21:21:00 点击:219 好评:0
[芯片制造] 芯片制造中的OCD是什么? 日期:2025-12-04 21:21:00 点击:219 好评:0
在半导体制造中,关键尺寸(CD)是指集成电路中的栅极线条宽度,其精度直接影响器件性能、成品率和可靠性。随着制程节点向2nm及以下推进,以及Chiplet异构集成架构的快速发展,对...
 [芯片制造] 芯片制造中的GIDL效应是什么?如何应对? 日期:2025-12-04 20:58:00 点击:389 好评:0
[芯片制造] 芯片制造中的GIDL效应是什么?如何应对? 日期:2025-12-04 20:58:00 点击:389 好评:0
栅致漏极泄漏(Gate Induced Drain Leakage,简称GIDL) 是金属氧化物半导体场效应晶体管(MOSFET)在关断状态下发生的一种重要漏电机制。该效应主要出现在栅极与漏极的交叠区域,由带间隧...
 [芯片制造] 芯片的详细制造流程! 日期:2025-12-02 19:46:00 点击:258 好评:0
[芯片制造] 芯片的详细制造流程! 日期:2025-12-02 19:46:00 点击:258 好评:0
硅锭和晶圆 █ 氧化 首先,在切割和抛光后的晶圆上,我们要先做一层氧化。氧化的目的,是在脆弱的晶圆表面,形成一层保护膜(氧化层)。氧化层可以防止晶圆受到化学杂质、漏电...
 [芯片制造] 集成电路的基本制造工艺-126页.pptx 日期:2025-11-28 21:28:59 点击:226 好评:0
[芯片制造] 集成电路的基本制造工艺-126页.pptx 日期:2025-11-28 21:28:59 点击:226 好评:0
封测实验室 整理半导体封装测试最新资讯、技术前言、发展趋势。提供专业讲解、讨论热点话题、资源分享。专注半导体技术、制造、封测、材料和设备等领域 62篇原创内容...