 [芯片制造] 芯片前端设计与后端设计的区别 日期:2025-05-13 22:00:00 点击:211 好评:0
[芯片制造] 芯片前端设计与后端设计的区别 日期:2025-05-13 22:00:00 点击:211 好评:0
一、前端设计与后端设计的核心定义 前端设计(Front-end Design) :聚焦于 电路的逻辑功能实现 。本质上是在纸上设计电路,包括芯片要干什么,要如何运算。 后端设计(Back-end Design)...
 [芯片制造] IC使用寿命测试项目(Life test items):EFR, OLT (H 日期:2025-05-09 20:27:00 点击:431 好评:0
[芯片制造] IC使用寿命测试项目(Life test items):EFR, OLT (H 日期:2025-05-09 20:27:00 点击:431 好评:0
IC使用寿命测试项目(Life test items):EFR, OLT (HTOL),LTOL ① EFR: 早期失效等级测试( Early fail Rate Test ) 目的:评估工艺的稳定性,加速缺陷失效率,去除由于天生原因失效的产品。 测试条...
 [芯片制造] 详解芯片制造全流程 日期:2025-05-07 22:31:45 点击:804 好评:0
[芯片制造] 详解芯片制造全流程 日期:2025-05-07 22:31:45 点击:804 好评:0
在现代科技推动下,芯片制造全流程堪称一场精密的工艺之旅。从最初的设计阶段开始,工程师们运用复杂的计算模型和仿真技术,确保每一个电路和晶体管都完美契合。接着,设计图...
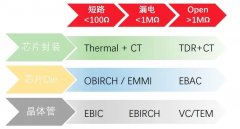 [芯片制造] 浅谈IC失效分析 日期:2025-05-05 14:09:02 点击:413 好评:0
[芯片制造] 浅谈IC失效分析 日期:2025-05-05 14:09:02 点击:413 好评:0
失效分析(FA) 今天和大家一起学习总结芯片失效分析(Failure Analysis)。 当一颗IC 完成design,并不意味着designer研发工作的结束,这一点作为IC designer是一定要明确的。做IC不是纸上谈...
 [芯片制造] 预非晶化注入(Pre-Amorphization Implant,PAI)技术介 日期:2025-04-23 20:23:00 点击:1066 好评:0
[芯片制造] 预非晶化注入(Pre-Amorphization Implant,PAI)技术介 日期:2025-04-23 20:23:00 点击:1066 好评:0
在半导体制造工艺不断向更小节点推进的今天, 预非晶化注入(Pre-Amorphization Implant,PAI) 已成为不可或缺的关键技术之一。 PAI工艺的基本原理与作用机制 预非晶化注入(PAI)是半导...
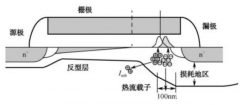 [芯片制造] 芯片寿命的"隐形杀手":热载流子注入效应( 日期:2025-04-22 19:05:00 点击:2040 好评:16
[芯片制造] 芯片寿命的"隐形杀手":热载流子注入效应( 日期:2025-04-22 19:05:00 点击:2040 好评:16
什么是热载流子注入效应 热载流子注入效应(Hot Carrier Inject, HCI)是 半导体器件(如晶体管)工作时,高能电子或空穴突破材料势垒、侵入绝缘层的物理现象 。当芯片中的载流子(电...
 [芯片制造] 半导体中芯片的功耗和速度应该如何平衡? 日期:2025-04-17 19:23:00 点击:410 好评:0
[芯片制造] 半导体中芯片的功耗和速度应该如何平衡? 日期:2025-04-17 19:23:00 点击:410 好评:0
在半导体芯片设计中,功耗与速度的平衡是核心挑战之一,两者往往存在此消彼长的权衡关系。以下是更系统、更落地的平衡策略: 1. 基础原理:功耗与速度的冲突 功耗来源:动态功...
 [芯片制造] 芯片测试中,leakage与IDDQ有什么异同? 日期:2025-04-14 22:00:56 点击:1205 好评:0
[芯片制造] 芯片测试中,leakage与IDDQ有什么异同? 日期:2025-04-14 22:00:56 点击:1205 好评:0
在芯片的晶圆测试(CP测试,Wafer Sort)中, leakage(漏电流) 和 IDDQ(静态电源电流) 都是 衡量芯片电路健康状况的重要电流类测试指标, 它们都可以用来发现某些制造缺陷,但它们...
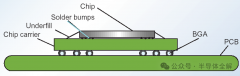 [芯片制造] 一文了解先进封装之倒装芯片(FlipChip)技术 日期:2025-04-14 20:38:00 点击:585 好评:2
[芯片制造] 一文了解先进封装之倒装芯片(FlipChip)技术 日期:2025-04-14 20:38:00 点击:585 好评:2
一、什么是芯片封装? 芯片是电子元件的重要组成部分,芯片必须与印刷电路板(Print Circuit Board,PCB)之间形成电互连,以实现芯片之间或芯片与其它电子元器件之间的沟通。 芯片主...
 [芯片制造] 芯片失效分析中的 Hot Spot 技术 日期:2025-04-07 21:33:46 点击:1210 好评:0
[芯片制造] 芯片失效分析中的 Hot Spot 技术 日期:2025-04-07 21:33:46 点击:1210 好评:0
在芯片失效分析(Failure Analysis, FA)过程中,Hot Spot技术主要用于定位芯片内部产生过热或异常电流密度区域,帮助工程师快速找到潜在的故障点或缺陷。随着半导体工艺不断缩小、集成...