|
在半导体制造中,关键尺寸(CD)是指集成电路中的栅极线条宽度,其精度直接影响器件性能、成品率和可靠性。随着制程节点向2nm及以下推进,以及Chiplet异构集成架构的快速发展,对纳米级结构尺寸的精确控制要求日益提升,计量与检测技术已成为保障良率和推动工艺演进的核心能力。 OCD的基本原理与工作流程 光学关键尺寸测量(OCD)是一种基于光学散射原理的非接触式计量技术,其基本原理是在周期性纳米结构表面照射特定偏振状态、波长和入射角的光,利用结构对光的衍射、反射和干涉效应,使反射光谱或椭偏信号携带结构尺寸和形貌特征。OCD测量通常采用散射度量术,也称为衍射度量术,其流程包括正问题和逆问题两部分:正问题是通过光学设备获取衍射光信号,逆问题则是通过模拟计算反演得出微结构的关键尺寸。 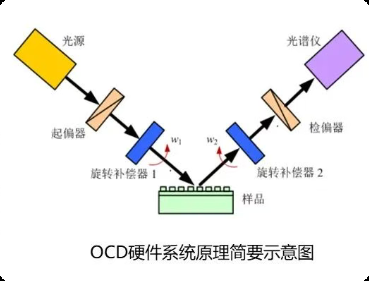 具体工作流程首先涉及采集光谱信号,通常基于宽带光谱的偏振反射测量技术或椭圆偏振测量技术,光束经过起偏器入射样品,衍射光通过检偏器被光谱传感器接收,形成特征测量光谱。随后,系统根据待测样品的工艺和结构建立高自由度模型,将复杂器件用一系列参数表征,并采用严格耦合波分析(RCWA)、有限元法(FEM)等电磁模拟算法构建理论光谱库。最后,通过光谱匹配,将实测光谱与理论库逐一比对,寻找均方差最小的匹配,索引出对应的结构参数作为测量结果。 OCD的技术优势与应用场景 与传统的关键尺寸扫描电子显微镜(CD-SEM)相比,OCD具有非接触、高通量、无损、纳米级精度以及较好的重复性和稳定性等优势。CD-SEM虽具备高精度测量能力,但测量速度慢、设备体积大,且不能有效测量多边结构或多晶硅栅极线宽等复杂形貌,而OCD可一次获取较多工艺参数,弥补了这些不足。因此,OCD广泛应用于光刻后图形监测、刻蚀控制和后段封装验证中,成为先进制程主流的在线计量技术。 在应用层面,OCD不仅适用于前端晶圆图形工艺,还逐步渗透进后端封装结构的高精度监测。例如,在3D NAND、高深宽比通孔(TSV)和混合键合等场景中,OCD能有效测量侧壁角、顶部和底部CD等参数,确保器件性能与界面完整性。其灵活性和可扩展性使其在复杂结构环境中保持核心地位。 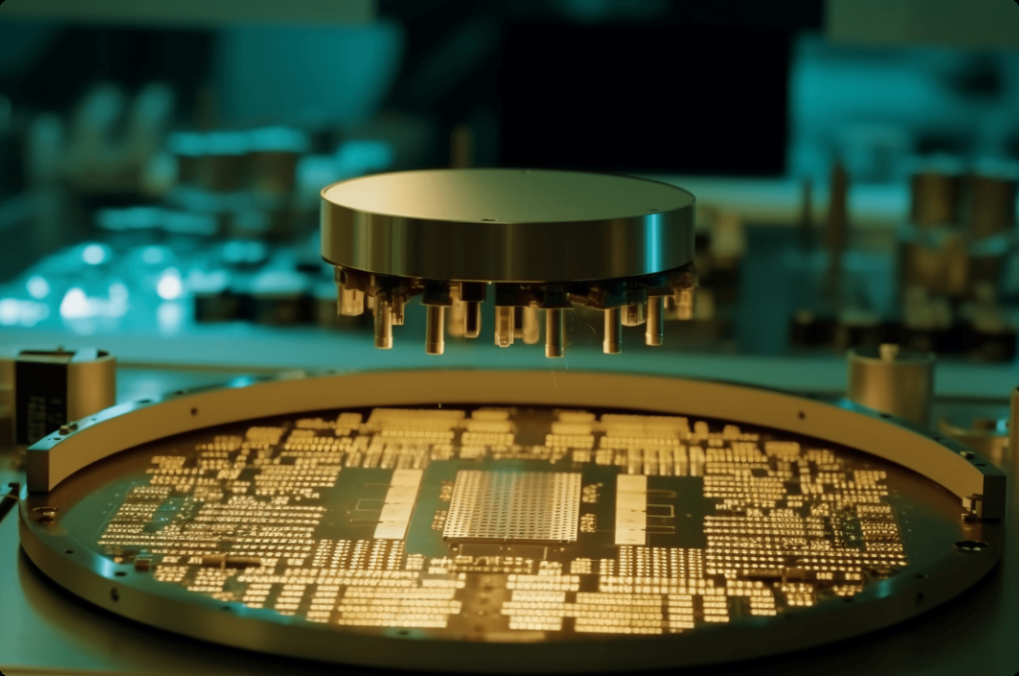 扩展与技术创新 随着3D集成电路、高深宽比结构和异构封装技术的发展,纳米结构在垂直方向和多材料界面上的复杂性显著提升,OCD测量技术亦不断演进以应对新需求。通过优化光源波长、入射角范围及偏振态设置,并结合精准仿真建模,OCD实现了对多参数的有效解耦和高精度预测,展现出向“准三维参数获取”发展的潜力。 在技术创新方面,人工智能(AI)和机器学习(ML)的引入显著提升了OCD系统的反演效率与鲁棒性。通过构建多层感知机(MLP)、卷积神经网络(CNN)等可训练模型,替代传统查找表或优化算法,OCD在结构参数反演中实现了反应时间缩短、误差收敛更快及抗噪性能增强。同时,光谱结构优化如深紫外(DUV)OCD和中红外(MIR)OCD,增强了对小开口、深层特征及掩埋结构的探测能力,适用于高纵深互连和层间测量。改进的数据滤波与特征选择方法,如垂直行进散射测量法(VTS),进一步提升了多层堆叠结构中的参数重建精度。 尽管OCD技术在先进节点和封装工艺中广泛应用,其仍面临结构建模复杂性提升、强耦合多参数反演困难、对埋藏结构和纳米缺陷探测能力有限等挑战。此外,实时测量与大批量数据处理压力,以及计量标准和数据验证体系不完善,也限制了其进一步推广。为实现下一代工艺节点的计量需求,OCD需持续与物理建模优化、光谱创新、AI增强算法及其他计量手段(如SEM、SAXS)深度融合,构建具备更强适应性和更高通用性的混合计量框架。 |





