失效分析(Failure Analysis,简称FA)是对已失效的半导体器件进行的一种事后检查活动。它依据失效模式和现象,通过电测试及必要的物理、化学分析技术,探究并验证失效行为,最终确定失效模式、找出失效机理。失效分析的目的与意义 失效分析的直接目的是明确失效机理、查找失效原因、提出改进措施,从而提高产品的可靠性与质量。对于半导体行业而言,设计完成并流片成功并不意味着工作的结束,实际生产出来的芯片在测试、运输、封装乃至客户使用环节都可能出现失效。因此,失效分析是连接设计、制造与应用的关键环节,是提升产品成熟度与可靠性的必修课。 产品失效可能带来严重后果,不仅造成经济损失,甚至威胁生命安全。通过失效分析,可以从失效残骸中提取“记录”下的信息,准确找到原因,并采取有效对策以防止同类事件再次发生。这项工作不仅是技术活动,也需要与管理活动紧密结合。  失效发生的层次 半导体器件的失效可根据发生阶段划分为三个主要层次:首先是芯片(裸片)设计层次,因工艺复杂性、设计偏差等因素导致;其次是制程封装层次,涉及键合、打线、空洞等封装工艺问题;最后是客户应用层次,源于PCB设计不当或超出极限应用场景等因素。 失效分析的基本流程与主要内容 失效分析通常遵循系统的流程。首先,需明确分析对象,详细记录失效现象、使用环境,并掌握器件的技术规范与工作原理。其次,确认失效模式,通过外观检查和电学测试,判断失效发生于芯片、封装还是应用端。随后,进行失效定位与机理分析,利用显微观察、物理性能探测等手段,定位到具体失效区域并分析其物理化学根源。然后,寻找失效的根本原因,对失效类型进行推断,并通过实验复现或数据追查来验证。最后,基于确定的失效原因,提出有针对性的预防与改进措施,并在设计、工艺、封装等环节落实,同时总结改善措施以积累经验。 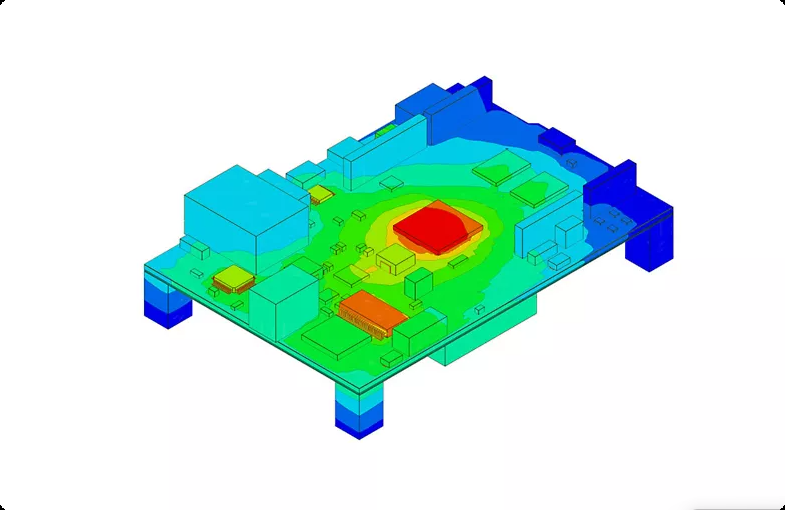 常见失效分析方法 失效分析按照对样品的破坏性,通常遵循先非破坏、后破坏的顺序进行。 非破坏性分析旨在不损坏芯片的前提下获取信息。主要包括:1. 外观检查(OM),利用肉眼或显微镜观察表面损伤、裂纹、沾污等;2. 电气测试,使用万用表、示波器等工具测量电参数,判断功能与性能是否正常;3. X射线检测(X-Ray/CT),通过对芯片内部进行2D或3D成像,检查引线键合、焊点、空洞等结构缺陷;4. 超声波扫描检测(SAT/SAM),利用超声波在不同材质界面的反射差异,检测内部的分层、裂缝或空洞。 破坏性分析在非破坏性分析无法确定原因时采用,会改变或损坏样品。主要步骤包括:1. 开盖(Decap),通过化学或激光方法去除封装,暴露内部芯片结构;2. 使用扫描电子显微镜(SEM)进行高分辨率微观形貌观察,检测金属线断裂、晶体管破损等,并可配合能谱仪(EDS)进行成分分析;3. 探针测试(Probe),利用探针台对芯片内部节点进行电学测量,定位电路内部的失效点;4. 热点/亮点分析,通过热辐射(Thermal)、光子探测(InGaAs)或激光诱导电阻变化(OBIRCH)等技术,定位短路或发热异常区域;5. 去层(Delayer)与聚焦离子束(FIB)分析,逐层去除芯片介质以检查布线,或利用离子束进行纳米级的切割、连接等操作,以验证电路设计或检查缺陷。 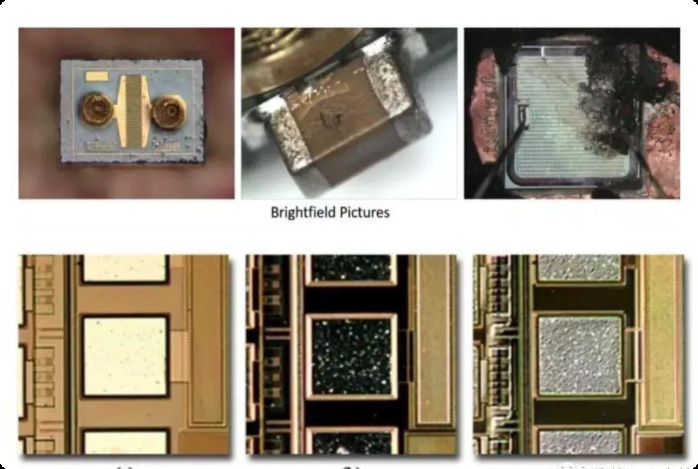 此外,还有扫描电容显微镜(SCM)、红外热成像等物理探测与成分分析技术,用于更深入的机理研究。 失效分析技术在国内日益受到重视,众多研究院所、高校及企业实验室均已开展相关工作。它将贯穿于电子元器件的设计、研制、生产、试验和使用全生命周期。可靠性是通过不断与失效做斗争来维持和提高的,失效分析正是理解失效本质、获取改进依据的关键技术。在半导体等领域,通过系统性的失效分析,可以解决“器件为何失效”的核心问题,为产品优化与可靠性提升提供坚实支撑。 |





