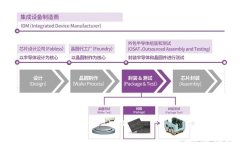 [芯片制造] 半导体测试 日期:2025-10-25 20:47:28 点击:172 好评:0
[芯片制造] 半导体测试 日期:2025-10-25 20:47:28 点击:172 好评:0
制作半导体产品的第一步,就是根据所需功能设计芯片(Chip)。然后,再将芯片制作成晶圆(Wafer)。由于晶圆由芯片反复排列而成,当我们细看已完成的晶圆时,可以看到上面有很多...
 [芯片制造] 芯片封装制作测试流程 日期:2025-10-25 20:35:00 点击:206 好评:0
[芯片制造] 芯片封装制作测试流程 日期:2025-10-25 20:35:00 点击:206 好评:0
介绍: 电子结构封装(Electronic Packing),也常被称为配给封装(Assembly),是半导体产业中所谓的后段,它的目的在赋予集成电路组件组装的基础架构,使其能进一步与其载体(常指印...
 [芯片制造] 芯片ESD失效分析:从认知误区到精准定位的完整 日期:2025-10-21 20:18:00 点击:216 好评:0
[芯片制造] 芯片ESD失效分析:从认知误区到精准定位的完整 日期:2025-10-21 20:18:00 点击:216 好评:0
在芯片失效案例中,静电放电(ESD)导致的损伤占比超过25%,却常因无明显物理痕迹被误判为设计缺陷或批次质量问题。ESD损伤具有微观性与隐蔽性,许多工程师在分析时仅盯着I/O端口...
 [芯片制造] 芯片失效分析步骤全流程 日期:2025-10-21 19:17:00 点击:279 好评:0
[芯片制造] 芯片失效分析步骤全流程 日期:2025-10-21 19:17:00 点击:279 好评:0
芯片失效分析步骤全流程 芯片失效分析是一个系统性工程,通常包括以下全流程步骤: 1.前期信息收集与失效现象确认 失效背景调查:收集芯片型号、应用场景、失效模式(如短路、漏...
 [芯片制造] 65页PPT,彻底看懂数字芯片设计! 日期:2025-10-07 16:03:00 点击:318 好评:0
[芯片制造] 65页PPT,彻底看懂数字芯片设计! 日期:2025-10-07 16:03:00 点击:318 好评:0
...
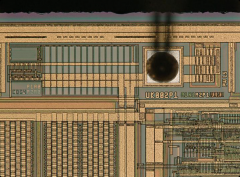 [芯片制造] 芯片Decap是什么? 日期:2025-10-07 11:27:02 点击:245 好评:0
[芯片制造] 芯片Decap是什么? 日期:2025-10-07 11:27:02 点击:245 好评:0
芯片Decap,全称为 芯片开封(Decapsulation) ,也被业内称为开盖或开帽,是指对已完成封装的集成电路(IC)芯片进行局部处理,通过物理或化学方式去除外部封装材料,从而暴露出内部...
 [芯片制造] 芯片DFT设计是什么? 日期:2025-10-07 10:15:00 点击:294 好评:2
[芯片制造] 芯片DFT设计是什么? 日期:2025-10-07 10:15:00 点击:294 好评:2
可测性设计(Design for Testability, DFT) 是芯片设计中的关键技术,全称为设计用于测试。它是指在芯片生产制造过程中,由于不可避免的制造缺陷,如金属线短路、断路或掺杂浓度异常,...
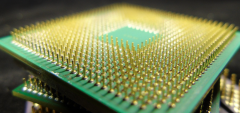 [芯片制造] 简述芯片的制造流程详细 日期:2025-09-22 20:27:00 点击:259 好评:0
[芯片制造] 简述芯片的制造流程详细 日期:2025-09-22 20:27:00 点击:259 好评:0
芯片,也称为集成电路,是现代电子设备的核心部件。其制造过程复杂且精密,涉及多个环节和高度先进的设备。 1. 设计阶段 芯片制造始于设计阶段。工程师使用专门的电子设计自动...
 [芯片制造] 一文了解芯片BGA封装的工艺流程 日期:2025-09-22 19:19:00 点击:388 好评:0
[芯片制造] 一文了解芯片BGA封装的工艺流程 日期:2025-09-22 19:19:00 点击:388 好评:0
球栅阵列(简称BGA)封装作为现代电子封装的重要形式,因其优异的性能和高密度的引脚排列被广泛应用于微处理器、存储器及各类集成电路中。 BGA封装简介 BGA封装通过在芯片下方布...
 [芯片制造] 芯片失效分析:EMMI与OBIRCH的原理、作用与区别 日期:2025-09-17 20:43:37 点击:1156 好评:8
[芯片制造] 芯片失效分析:EMMI与OBIRCH的原理、作用与区别 日期:2025-09-17 20:43:37 点击:1156 好评:8
概述 EMMI和OBIRCH都是用于集成电路(IC)失效分析和缺陷定位的非侵入式、高精度的光学检测技术。它们就像给芯片做CT扫描和B超,帮助工程师看见肉眼和传统电子测试无法发现的微小缺...