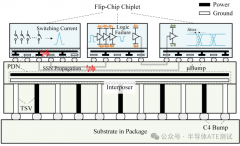 [测试工程] 半导体ATE中高频高速接口测试的“速度与激情” 日期:2026-03-15 16:23:00 点击:137 好评:2
[测试工程] 半导体ATE中高频高速接口测试的“速度与激情” 日期:2026-03-15 16:23:00 点击:137 好评:2
感恩科技的发展,AI 正在逐步改写我们的工作学习模式,Q4各家半导体设备厂商举办的技术峰会里,对AI的讨论也层出不穷。高速接口是谈及AI,一个无法绕过的话题。如今,数据传输速...
 [可靠性测试] HTOL与Burn-in的差异点 日期:2026-03-10 23:01:58 点击:309 好评:-2
[可靠性测试] HTOL与Burn-in的差异点 日期:2026-03-10 23:01:58 点击:309 好评:-2
HTOL(高温工作寿命测试)和 Burn-in(老化测试)在半导体可靠性测试中关系密切,它们有显著的重叠,但侧重点不同。简单来说,Burn-in 是 HTOL 的一种应用形式。 主要区别: 以下是HTOL(...
 [可靠性测试] 一文读懂芯片可靠性试验项目 日期:2026-03-10 20:14:00 点击:215 好评:0
[可靠性测试] 一文读懂芯片可靠性试验项目 日期:2026-03-10 20:14:00 点击:215 好评:0
可靠性试验的定义与重要性 可靠性试验是一种系统化的测试流程,通过模拟芯片在实际应用中可能遇到的各种环境条件和工作状态,对芯片的性能、稳定性和寿命进行全面评估。 在芯...
 [可靠性测试] 芯片半导体可靠性测试项目 日期:2026-03-10 19:09:00 点击:107 好评:0
[可靠性测试] 芯片半导体可靠性测试项目 日期:2026-03-10 19:09:00 点击:107 好评:0
芯片半导体可靠性测试项目 服务背景 当今的世界技术高度依赖集成电路(IC),其广泛应用在智能家居、机器人、移动电话、汽车及航空航天的各种设备中。其中,整个IC的产业链是由...
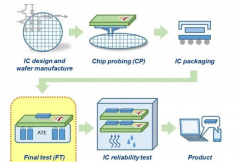 [可靠性测试] 半导体芯片老化与可靠性测试项目及方法 日期:2026-03-09 22:45:29 点击:205 好评:0
[可靠性测试] 半导体芯片老化与可靠性测试项目及方法 日期:2026-03-09 22:45:29 点击:205 好评:0
芯片可靠性测试主要分为环境试验和寿命试验两个大项,可靠性测试是确保芯片在实际应用中能够稳定运行和长期可靠的关键步骤。一般来说,可靠度是产品以标准技术条件下,在特定...
 [可靠性测试] 芯片工作寿命老化测试 (HTOL):芯片可靠性的"高 日期:2026-03-09 20:34:00 点击:211 好评:0
[可靠性测试] 芯片工作寿命老化测试 (HTOL):芯片可靠性的"高 日期:2026-03-09 20:34:00 点击:211 好评:0
在指甲盖大小的芯片上,承载着数亿晶体管的精密城市这是半导体技术的奇迹,也是现代科技的核心命脉。从智能手机到自动驾驶,从人工智能到航空航天,芯片的可靠性直接决定了这...
 [测试工程] 半导体制程测试分析利器:透射电子显微镜(T 日期:2026-03-04 22:57:00 点击:130 好评:0
[测试工程] 半导体制程测试分析利器:透射电子显微镜(T 日期:2026-03-04 22:57:00 点击:130 好评:0
一、TEM 简介 1.TEM 的加速电压远高于扫描电子显微镜(SEM); 2.中压电镜加速电压为 200-500 kV,相比低压电镜(80-120 kV)具备更优的透射效果和分辨率,超高压电镜加速电压可达 500 kV-...
 [可靠性测试] 可靠性基础知识 日期:2026-03-04 20:37:00 点击:141 好评:0
[可靠性测试] 可靠性基础知识 日期:2026-03-04 20:37:00 点击:141 好评:0
...
 [测试工程] 示波器如何接地?示波器接地步骤介绍 日期:2026-03-02 21:22:18 点击:240 好评:0
[测试工程] 示波器如何接地?示波器接地步骤介绍 日期:2026-03-02 21:22:18 点击:240 好评:0
什么是接地? 接地是电路中电流的回流路径。该参考点充当基准线或零伏点,其他电压均以此为基准进行测量。接地确保电气系统的一致性和稳定性,有助于从数据解读到噪声抑制等各...
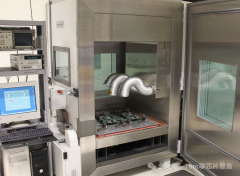 [测试工程] 什么是hast与uhast? 日期:2026-03-02 20:35:00 点击:205 好评:0
[测试工程] 什么是hast与uhast? 日期:2026-03-02 20:35:00 点击:205 好评:0
hast与uhast是半导体封装可靠性测试中两个非常容易混淆,但目的完全不同的测试。们都是抗湿气能力的加速测试,核心区别在于是否通电。 简单来说: HAST= 高温 + 高湿 +通电,测电路腐...