简介光电子集成技术在从电信到传感的广泛领域都有应用。然而,随着光电子集成芯片(PIC)变得越来越复杂,封装和测试已成为将这些器件推向市场的关键瓶颈。本文概述了光电子集成芯片的当前封装和测试技术,重点介绍了关键挑战和新兴解决方案。 光电子集成芯片的封装挑战 PIC的封装涉及多个复杂的组装步骤,包括:1. 光学封装——在光纤和片上波导之间高效耦合光2. 电气封装——提供电气连接,以驱动和控制光子器件3. 热管理——从有源元件散热4. 机械封装——保护PIC并提供与外界的接口 当前封装技术依赖于“封装级”工艺,在将PIC放置在封装中后完成光学和电气互连,这是当前封装技术面临的一大挑战。这种串联方法难以实现自动化,且吞吐量有限。因此,封装成本可占到PIC模块总制造成本的75%以上,而电子集成电路的成本仅占10-20%。 图1概述了PIC所需的主要封装技术:  图1 如图所示,PIC封装需要光学、电子、机械和热工程等多个领域的专业知识。将所有这些功能整合到一个紧凑、低成本的封装中仍然是重大挑战。 光学封装 在光纤和片上波导之间高效耦合光是PIC封装最关键、最具挑战性的方面之一。主要采用两种方法: 1. 边缘耦合——光直接耦合到片上波导的端面 2. 光栅耦合——光通过芯片表面的光栅垂直耦合 边缘耦合可以提供宽带、对极化不敏感的耦合,但需要精确对准。光栅耦合器更容易对准,但带宽有限。 图2展示了这两种耦合方法:  图2 目前的封装工艺通常采用主动对准,实时最大化耦合光功率。这种工艺非常耗时,每个器件的周期时间长达几分钟。 新兴的光学封装解决方案包括: 使用微透镜阵列扩展光束耦合 通过光学中介实现瞬态耦合 用于模式转换和光束转向的3D打印微光学器件 这些方法旨在放宽对准公差,实现更自动化的组装流程。 电子封装随着数据传输速率的提高,电子封装变得越来越具有挑战性。主要考虑因素包括: 高速信号完整性 热管理 机械应力 线键合通常用于电气连接,但在高频下存在局限性。对于高于20 GHz的速度,最好采用倒装芯片键合到电气interposer。 图3展示了用于将PIC与电子IC共封装的高速interposer: 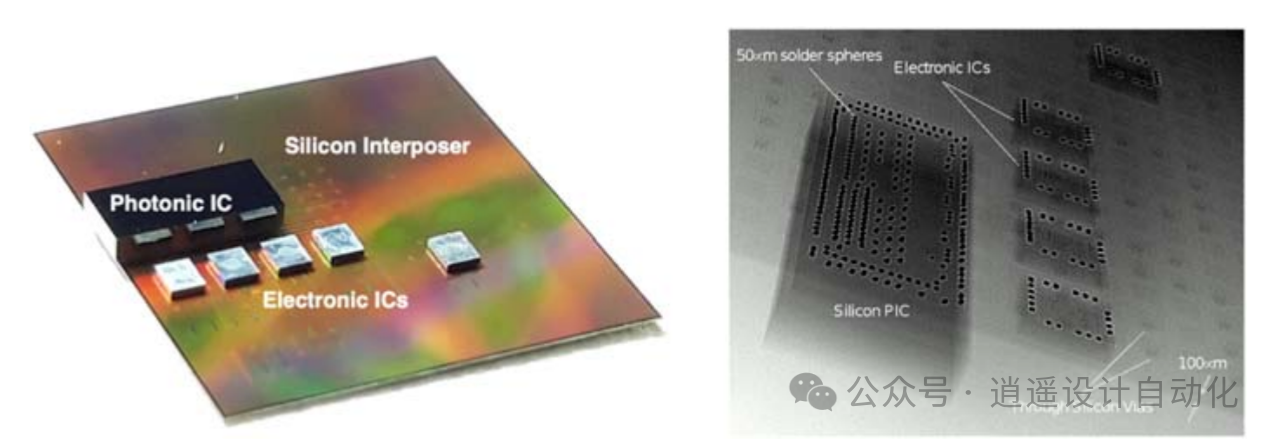 图3 硅中介层使用硅通孔(TSV)将信号从顶部表面传输到底部的球栅阵列。这样就可以直接焊接到PCB上,无需使用焊线。 热管理 主动光电子元件和电子元件会产生大量热量,必须有效散热。热管理注意事项包括: · 选择具有高热传导性的封装材料 · 集成散热器和散热器 · 对温度敏感的组件进行热隔离 光、电和热方面的协同设计对于优化整体封装性能重要。 测试挑战与电子集成电路相比,PIC测试面临独特的挑战: · 需要同时进行光学和电气测试 · 器件类型和应用多种多样 · 缺乏标准化的测试协议和设备 目前的测试方法通常依赖于封装层面的手动或半自动流程。这严重限制了吞吐量并增加了成本。 PIC测试需要改进的关键领域包括: 1.测试指标和协议标准化 2.设计和测试工作流程整合 3.开发高通量并行测试系统 4.晶圆级和在线测试能力 图4展示了为自动PIC测试开发的模块化测试框架示例: 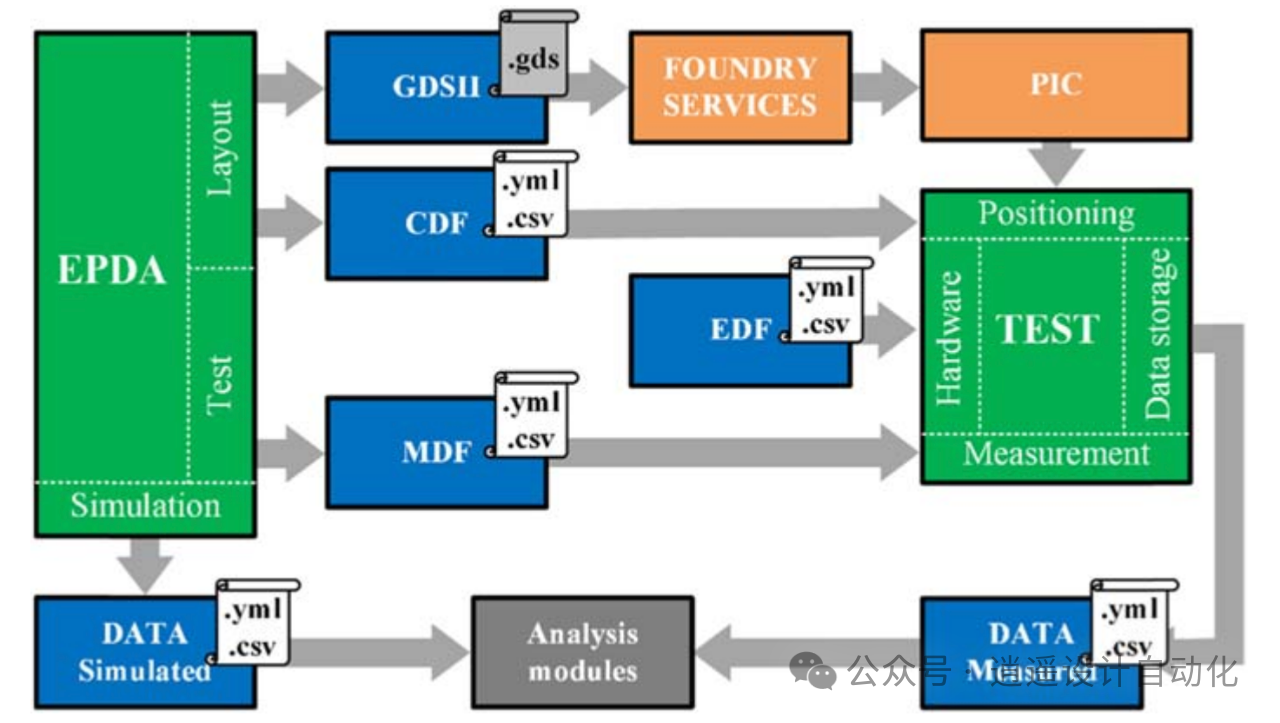 图4 这种方法旨在实现不同PIC平台和应用的可定制、高通量测试。 新兴技术 多项新兴技术有望改善PIC封装和测试: 1. 微光学3D打印双光子聚合(2PP)技术可在PIC上直接进行定制微光学元件的高分辨率3D打印。可用于制造: 用于高效光纤耦合的模式转换器 光束转向元件 可重构光互连 图5展示了用于将PIC与光纤连接的3D打印耦合器示例: 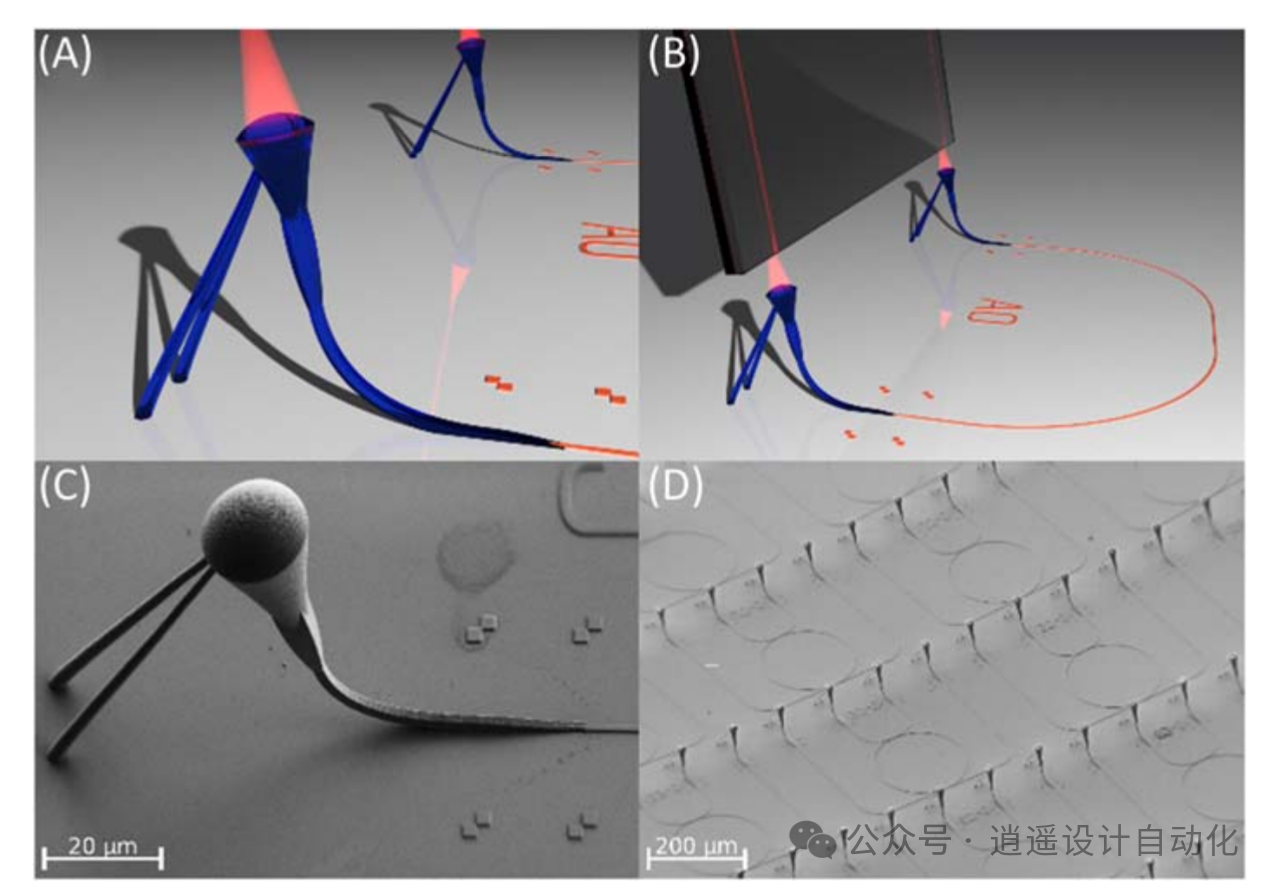 图5 这种方法具有以下优点: 为特定设备量身定制的光学器件 放宽对准公差 晶圆级加工的潜力 2. 晶圆级封装将封装工艺提升到晶圆级水平,有望大幅降低成本并提高产量。实现这一转变的关键技术包括: 晶圆级光学器件(微透镜阵列、衍射元件) 用于垂直电气连接的硅通孔 晶圆级芯片级封装 封装标准化和设计为了实现更自动化、大批量的生产,需要提高PIC设计和封装工艺的标准化程度。这包括: 标准化的光学和电气接口 封装设计规则 与PIC设计工具集成的组装设计工具包(PIC Studio ADKs) 在设计流程的早期阶段考虑封装要求,可以显著提高可制造性并降低成本。 路线图和未来展望 预计未来5-10年,PIC封装和测试领域将出现以下发展: 1. 提高自动化和晶圆级处理 - 从封装级过渡到晶圆级组装和测试 - 开发高通量并行测试系统 2. 改进光学耦合解决方案 - 扩展光束和瞬态耦合方法 - 用于模式转换和光束转向的3D打印微光学器件 3. 先进的电子封装 - 更广泛地采用倒装芯片和中介层技术 - 光学器件和电子器件的共封装4. 标准化- 封装设计规则和装配设计工具包 - 标准化测试协议和指标 5. 新材料和工艺 - 3D打印光电子技术 - 多种材料平台的异构集成 结论 在将集成光电子器件从实验室推向市场时,封装和测试仍然是关键挑战。目前的封装级工艺难以扩展到大批量应用。应对这些挑战的有前景的方法包括: 1.转向晶圆级和面板级封装工艺 2.开发新的光学耦合解决方案,以放宽对准公差 3.采用微电子行业先进的电子封装技术 4.提高设计和工艺的标准化程度 5.利用新兴技术,如微光学3D打印 在这些领域持续创新对于充分发挥集成光子学在各种应用中的潜力重要。通过解决封装和测试瓶颈,光电子行业能够降低成本并扩大规模,从而实现PIC技术的广泛应用。 |





