引言半导体行业正在快速发展,对更强大、高效和紧凑的电子设备的需求不断增长。先进封装技术在满足这些需求方面发挥着重要作用,它能够实现更高的性能、改进的功能和更小的尺寸。本文概述了各种先进封装技术、其应用及其发展的驱动力。 半导体应用和系统技术驱动因素 半导体行业已确定五大增长引擎或应用: 1.移动设备(智能手机、笔记本电脑、智能手表、可穿戴设备、平板电脑) 2.高性能计算(HPC) 3.自动驾驶汽车 4.物联网(IoT) 5.大数据(云计算)和即时数据(边缘计算) 这些应用主要由两个关键系统技术驱动因素推动: 1.人工智能(AI) 2.5G技术 AI需要高性能计算基础设施,如数据中心和超级计算机。AI应用所需的硬件组件包括CPU、GPU、FPGA、内存、服务器和交换机。  5G技术分为两大类: 1.中频段(Sub-6 GHz 5G):900 MHz < 频率 < 6 GHz,数据速率 ≤ 1 Gbps 2.高频段(5G毫米波):24 GHz ≤ 频率 ≤ 100 GHz, 1 Gbps < 数据速率 ≤ 10 Gbps 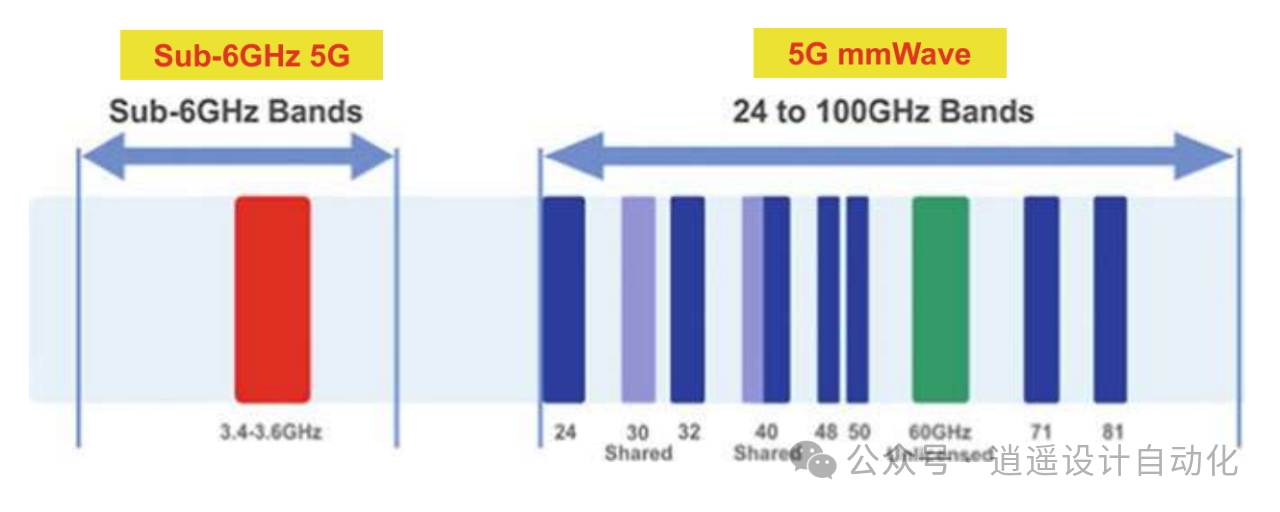 先进封装技术 为满足这些应用和驱动因素的要求,开发了各种先进封装技术。这些可以大致分为几个类别: 1. 2D集成: - 2D扇出(芯片先行)IC集成 - 2D倒装芯片IC集成 - 封装叠加(PoP) - 系统级封装(SiP)或异构集成 - 2D扇出(芯片后置)IC集成 2. 2.1D集成: - 2.1D倒装芯片IC集成 - 带桥接的2.1D倒装芯片IC集成 - 带桥接的2.1D扇出IC集成 3. 2.3D集成: - 2.3D扇出(芯片先行)IC集成 - 2.3D倒装芯片IC集成 - 2.3D扇出(芯片后置)IC集成 4. 2.5D集成: - 2.5D(C4焊球)IC集成 - 2.5D(C2微凸点)IC集成 5. 3D集成: - 微凸点3D IC集成 - 微凸点Chiplet 3D IC集成 - 无凸点3D IC集成 - 无凸点Chiplet 3D IC集成 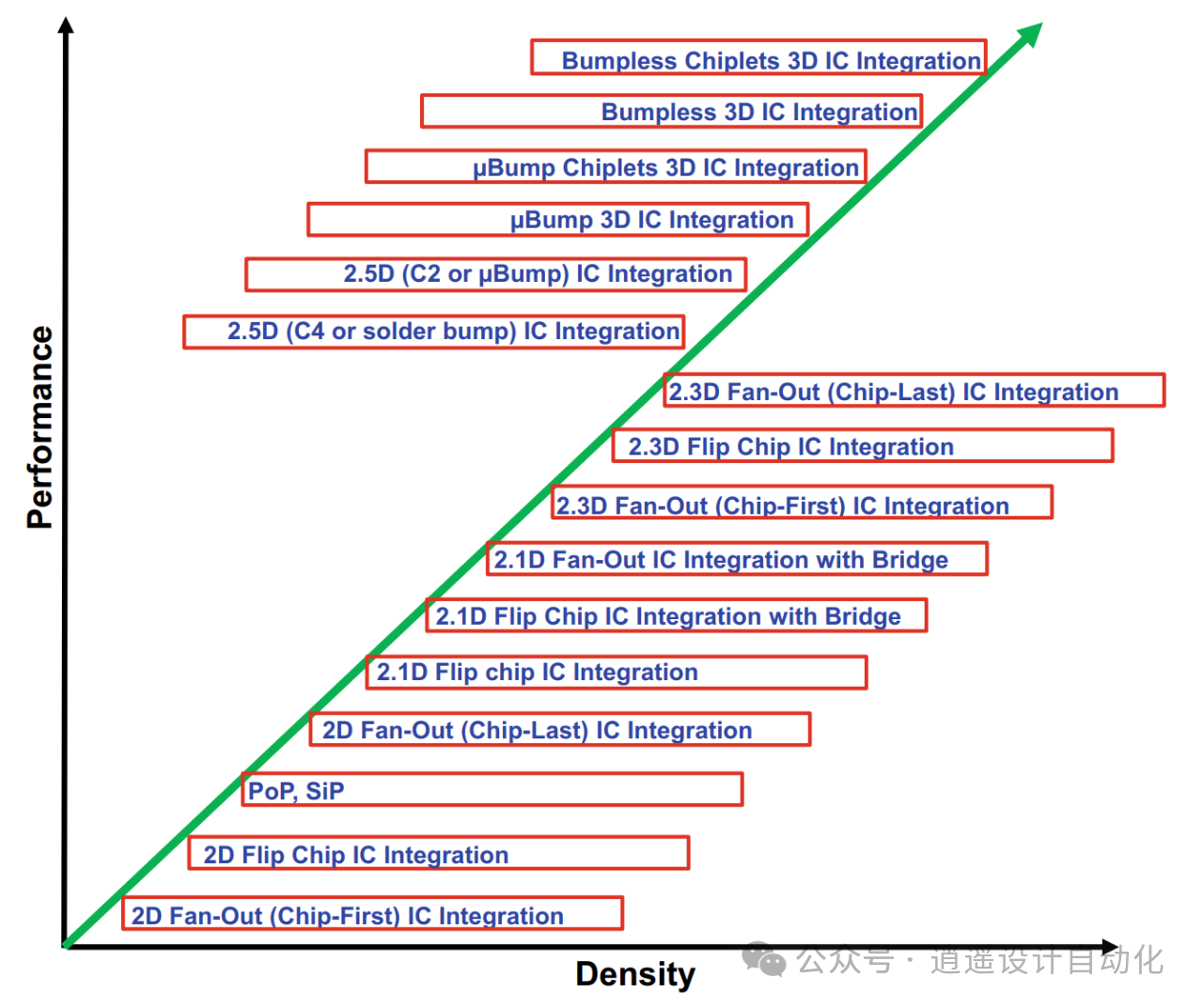 让我们更详细地探讨一些这些先进封装技术: 2D扇出(芯片先行)IC集成: 这种技术涉及将多个芯片嵌入环氧模塑料(EMC)中,然后扇出重分布层(RDL)以连接到焊球。这种方法允许更高的集成密度和改进的电气性能。 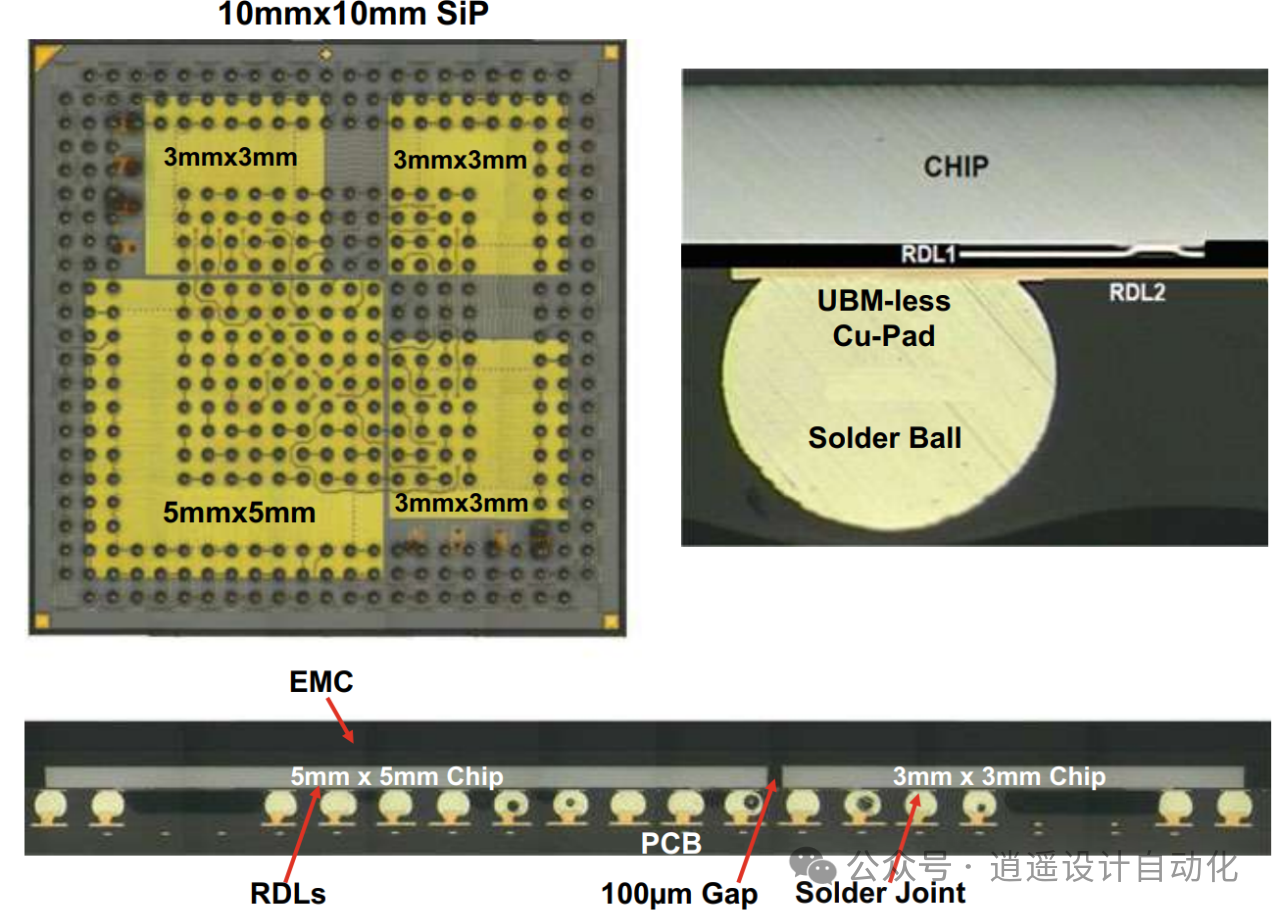 2D倒装芯片IC集成: 在这种技术中,芯片被翻转并使用C4(受控塌陷芯片连接)凸点或C2(芯片连接)凸点附着到构建封装基板上。通常在芯片和封装基板之间使用底填以提高可靠性。 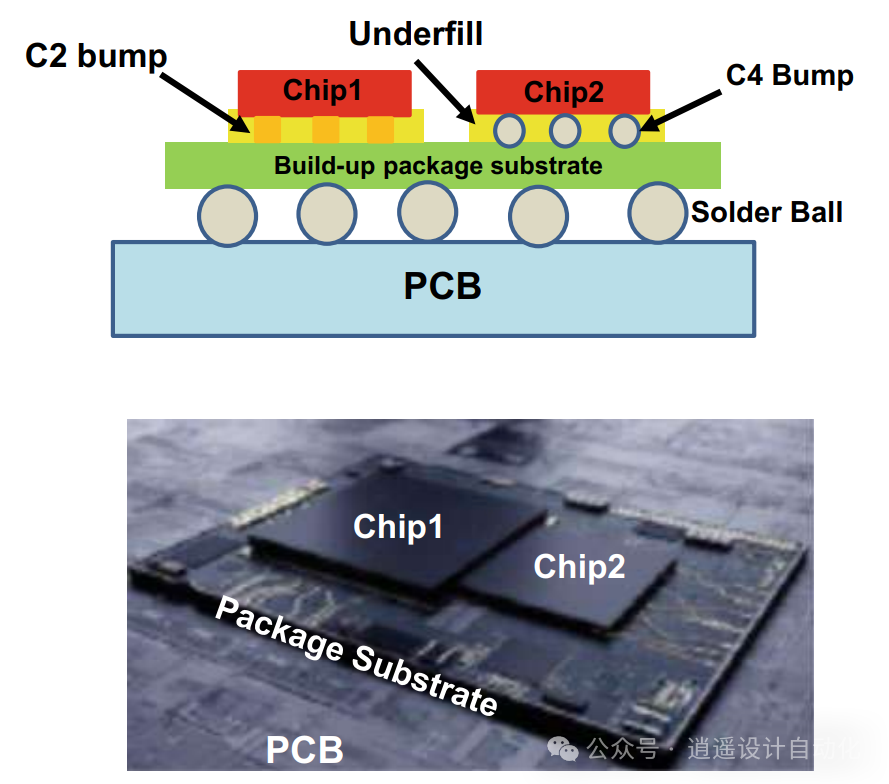 封装叠加(PoP)和系统级封装(SiP): PoP技术涉及将多个封装堆叠在一起,通常结合逻辑和存储组件。SiP技术将多个芯片和分立组件集成到单个封装基板中。 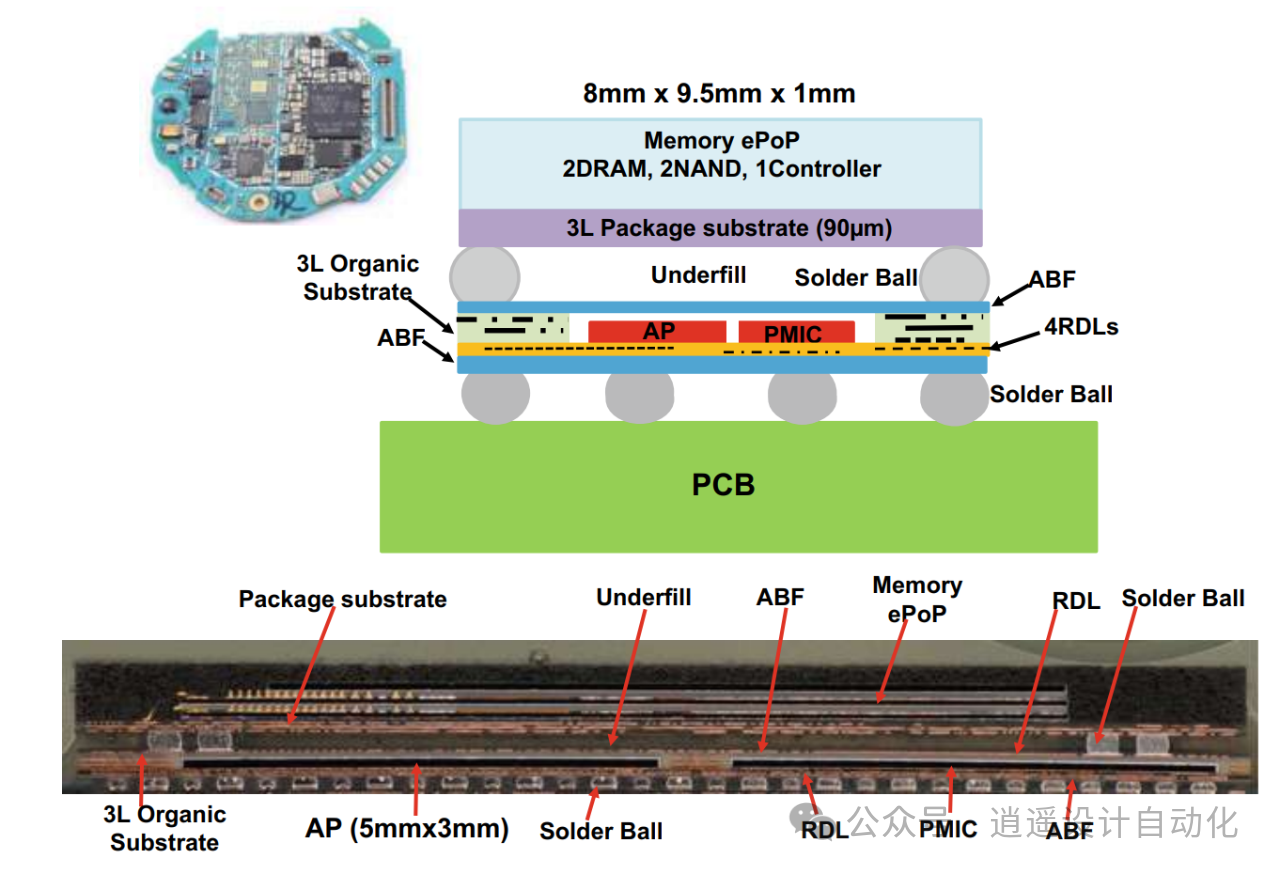 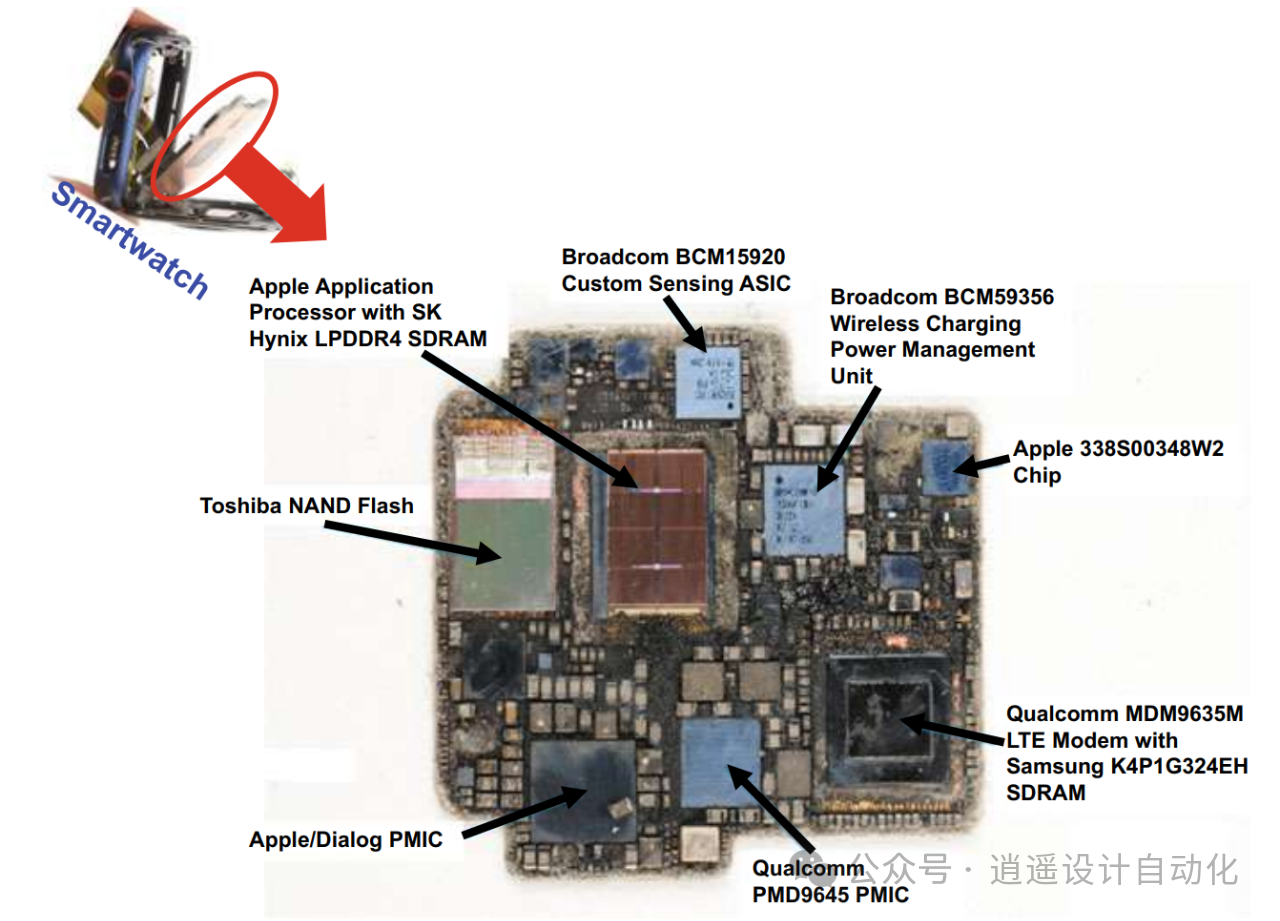 2.1D倒装芯片IC集成: 这种技术在构建封装基板顶部具有薄膜层。这些薄膜层的金属线宽和间距可以小到2/2 μm,支持带有微凸点的倒装芯片。 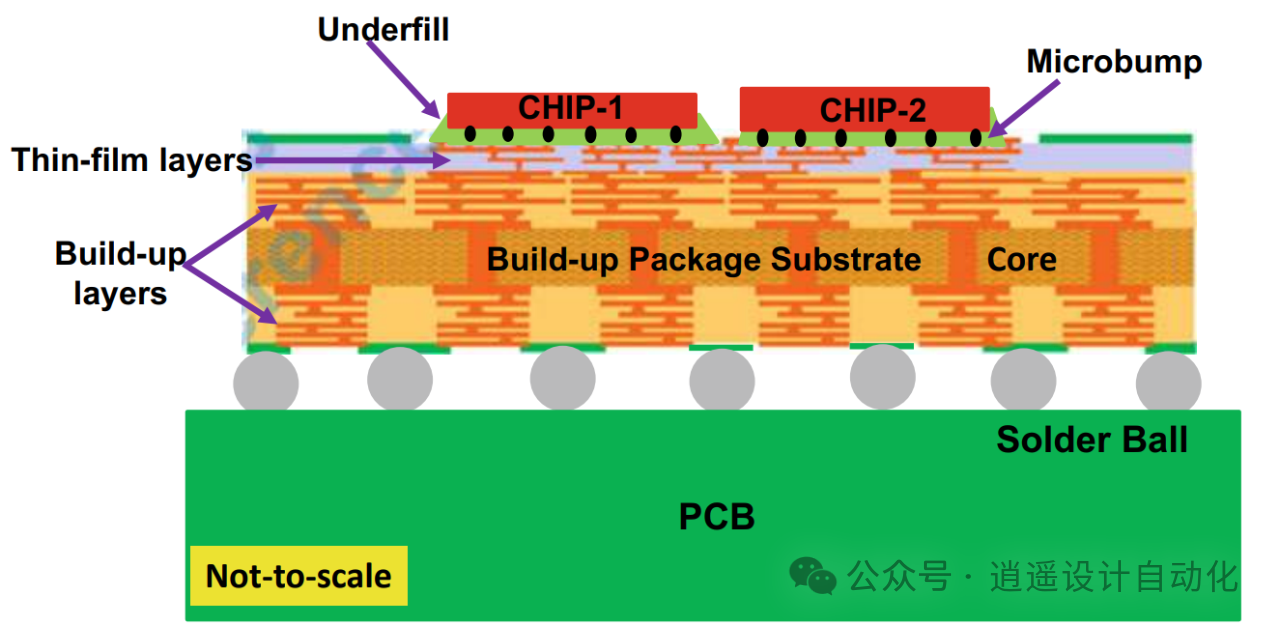 带桥接的2.1D倒装芯片IC集成: 这种技术,以英特尔的EMIB(嵌入式多芯片互连桥)为例,在构建封装基板的顶层嵌入一个桥,以支持倒装芯片之间的横向通信。旨在替代TSV(硅通孔)中间层技术。  2.3D扇出(芯片先行)IC集成:这种技术用扇出RDL中间层替代了TSV中间层、微凸点和底填。与传统的2D扇出技术相比,它提供了改进的性能和集成密度。 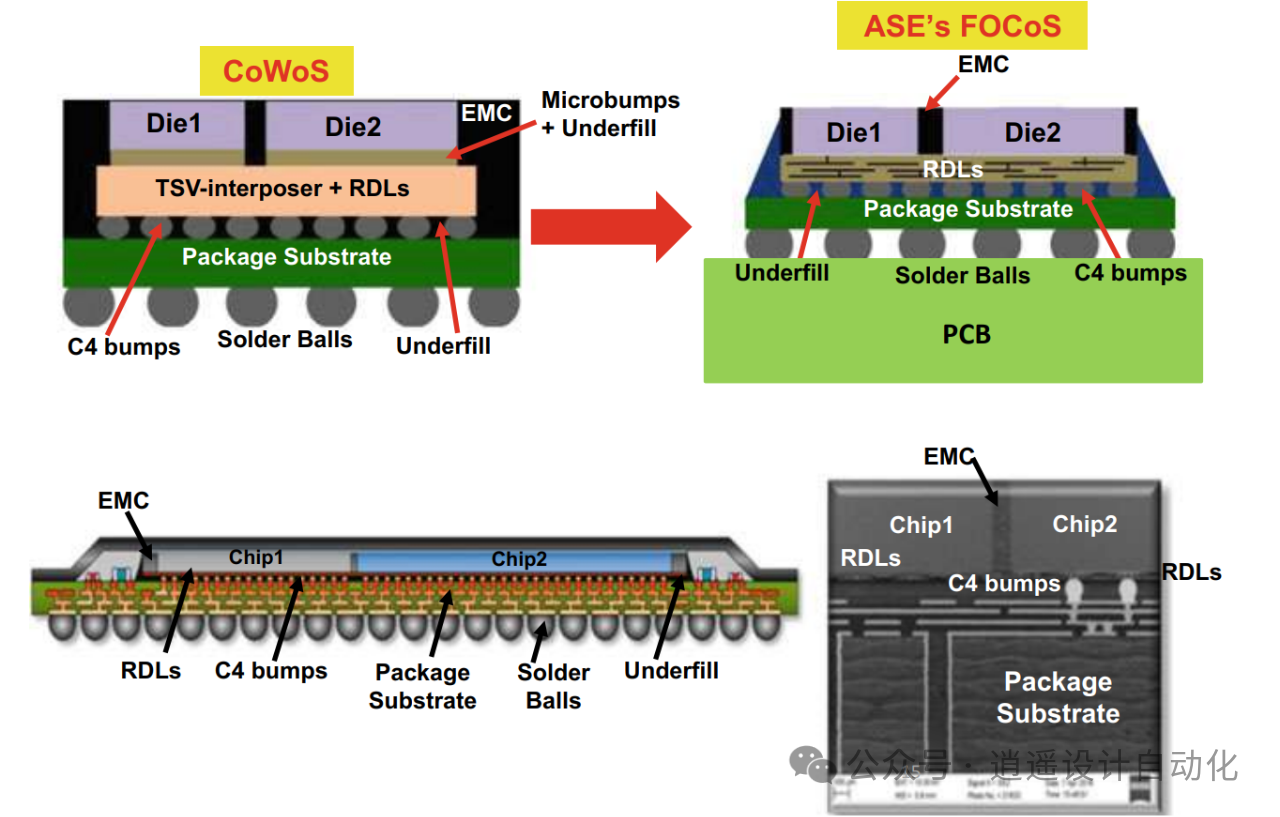 2.5D(C2凸点)IC集成: 在这种技术中,诸如GPU和高带宽存储器(HBM)等组件使用C2微凸点附着到无源TSV中间层上。然后整个模块使用C4凸点连接到封装基板。 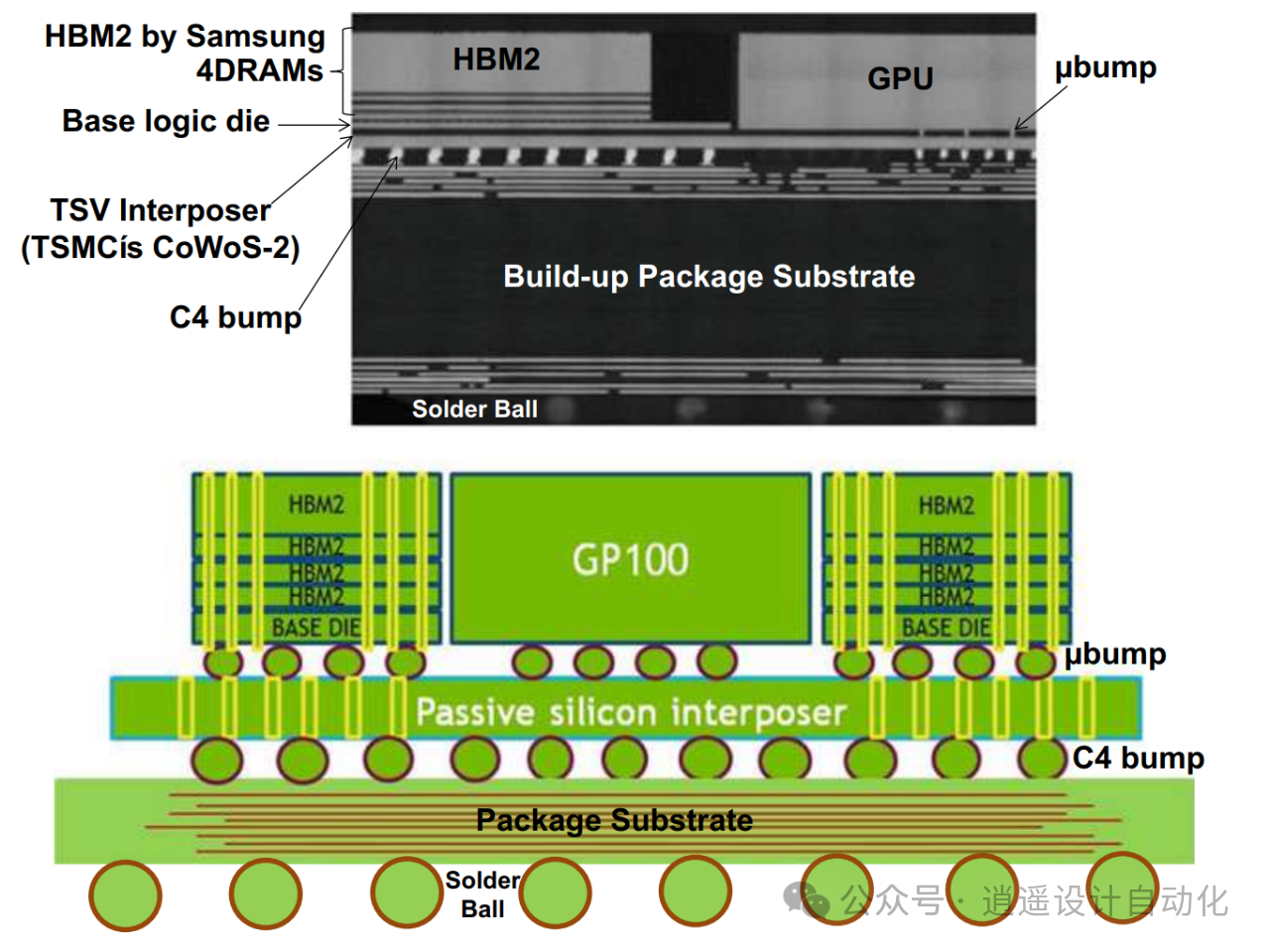 微凸点3D IC集成: 这种技术涉及垂直堆叠多个芯片并使用微凸点和TSV连接它们。顶部芯片使用微凸点连接到底部芯片(带有TSV),整个模块使用C4凸点附着到封装基板上。 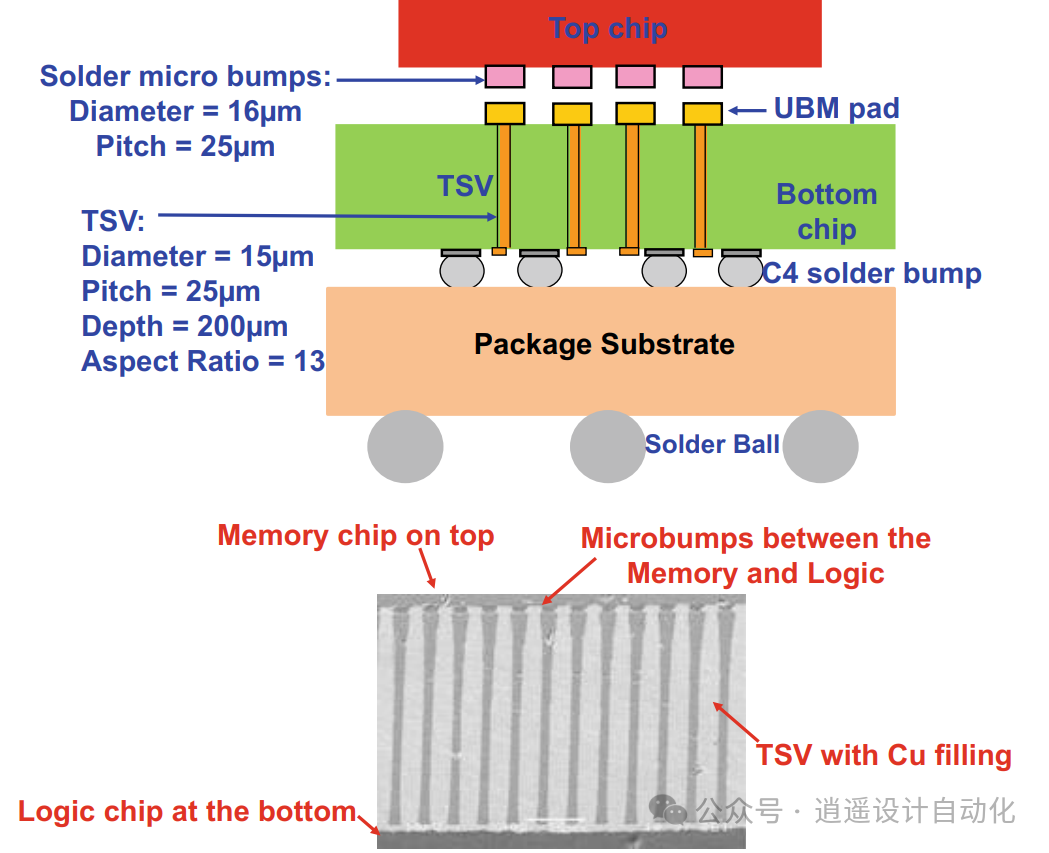 无凸点3D IC集成: 无凸点3D IC集成,也称为混合键合,可实现芯片之间更细的间距连接。这种技术可以实现小至10 μm的焊盘间距,与微凸点技术相比显着提高了互连密度。 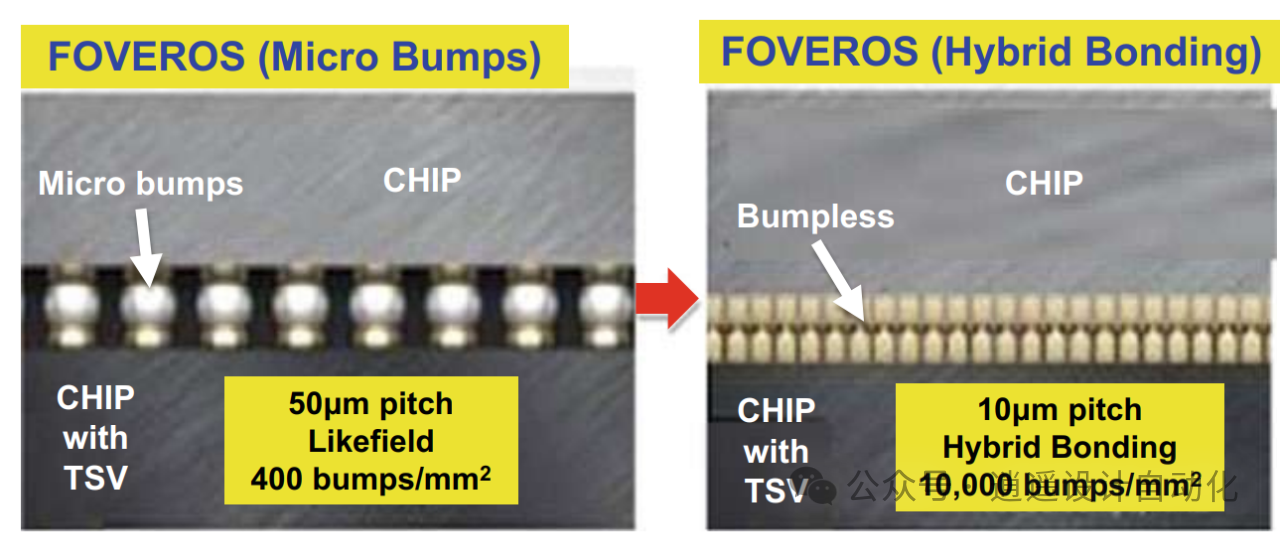 无凸点Chiplet 3D IC集成: 这种新兴技术,如台积电的SoIC(集成芯片系统),涉及通过芯片到晶圆(CoW)或晶圆到晶圆(WoW)工艺进行无凸点混合键合Chiplet。它承诺更高的集成密度和性能。 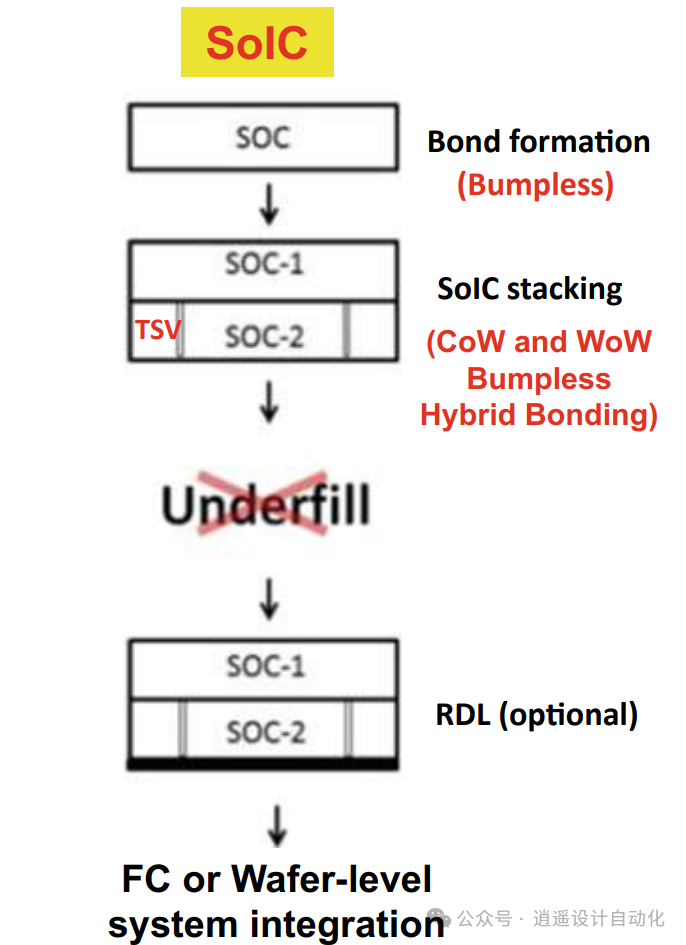 组装工艺 先进封装技术中使用了几种组装工艺: 1.线键合 2.表面贴装技术(SMT) 3.有机基板上的倒装芯片大规模回流 4.芯片到芯片(CoC)、芯片到晶圆(CoW)和晶圆到晶圆(WoW)热压键合和混合键合 结论 先进封装技术对于满足现代电子设备和应用的需求非常重要。随着半导体行业的不断发展,这些封装技术将在实现更高性能、改进功能和更小尺寸方面发挥越来越重要的作用。从2D集成到无凸点3D Chiplet集成,每种技术在性能、成本和可制造性方面都提供了独特的优势和权衡。 先进封装的未来会在材料、工艺和设计方法方面进行进一步创新,以解决功耗、热管理和信号完整性的挑战。随着AI、5G和其他新兴技术继续推动半导体行业向前发展,先进封装将继续成为下一代电子系统的关键赋能技术。 |





