引言随着摩尔定律接近极限,半导体行业正在探索新方法来持续提高集成线路的性能、功率效率和成本效益。Chiplet异构集成将传统的片上系统(SoC)设计重新设计为更小的功能块,称为Chiplet。本文将探讨Chiplet异构集成的概念、优势、挑战以及各种实现技术。 什么是Chiplet? Chiplet是功能性集成线路块,通常由可重用的IP(知识产权)块组成。与将所有功能集成到单个整体芯片的传统SoC不同,基于Chiplet的设计将这些功能分割成独立的较小芯片,可以使用不同的工艺制造,然后使用先进的封装技术集成。  图1:两种Chiplet异构集成方法:(a)芯片分割和集成,(b)芯片分区和集成。 Chiplet异构集成的优势 1. 良率提升:较小的芯片具有更高的良率,从而降低制造成本。图2说明了这一概念: 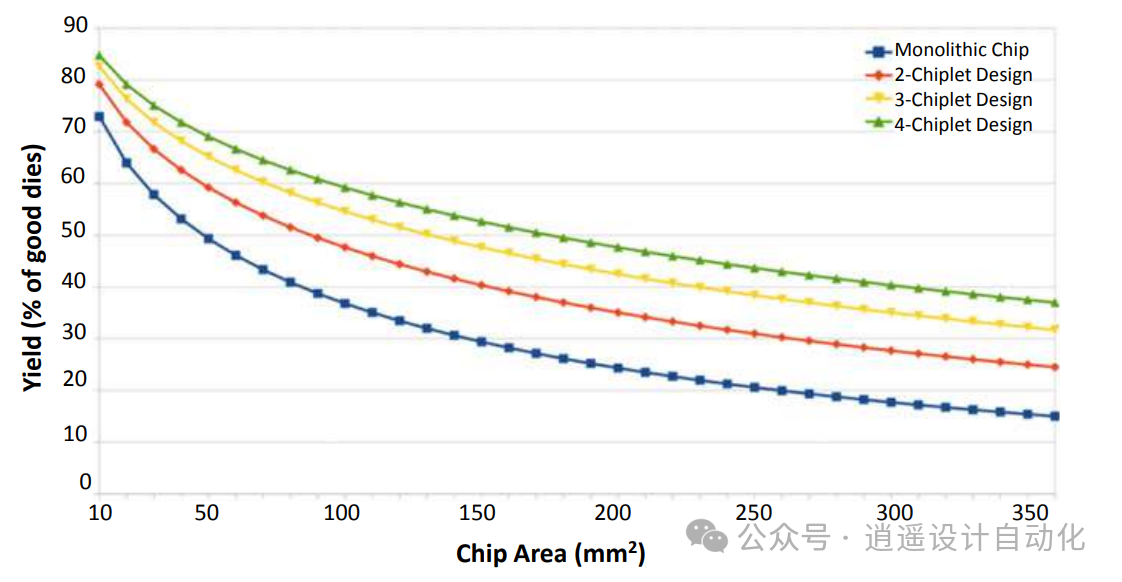 图2:整体设计和各种Chiplet设计的良率与芯片尺寸的关系。 2. 上市时间:芯片分区可以加快开发速度。 3. 成本降低:AMD证明,使用Chiplet进行CPU核心设计可以将32核CPU的硅设计和制造成本降低最多40%。 4. 散热优势:将芯片分散在封装中可以改善热管理。 Chiplet异构集成的挑战 1. 接口和复制逻辑需要额外面积 2. 更高的封装成本 3. 增加的复杂性和设计工作 4. 需要适合Chiplet设计的新方法 用于Chiplet集成的先进封装技术 为支持Chiplet异构集成,出现了几种先进的封装技术: 1. 有机基板上的2D Chiplet集成:这种方法将Chiplet并排放置在有机基板上。AMD的EPYC处理器使用了这种技术。 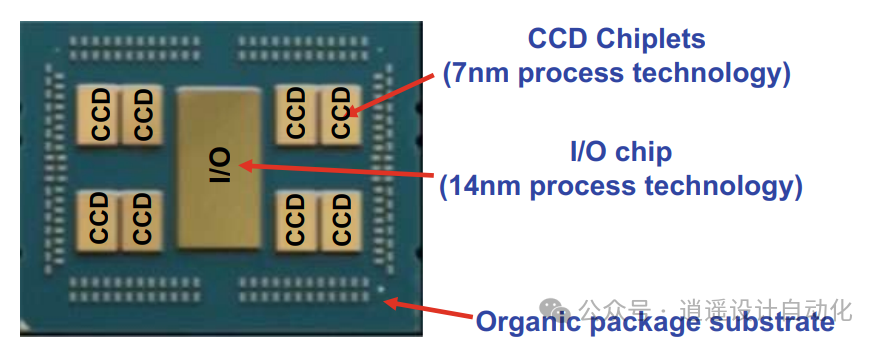 图3:AMD第二代EPYC在有机基板上的2D Chiplet异构集成。 2. 有机基板上的2.1D Chiplet集成:这种方法在有机基板上添加薄膜层,以提高互连密度。新光电气的i-THOP(集成薄膜高密度有机封装)是这种技术的一个例子。 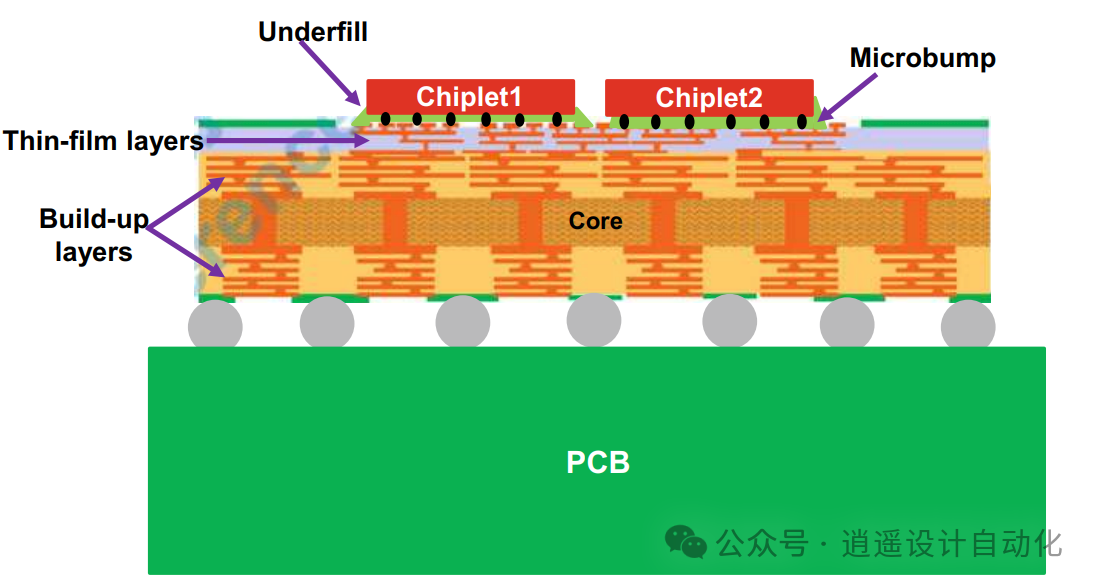 图4:新光电气在有机基板上的2.1D Chiplet异构集成。 硅中介层上的2.5D Chiplet集成 这种技术使用带有硅通孔(TSV)的无源硅中介层来连接Chiplet。台积电的晶圆级封装(CoWoS)是一个突出的例子。 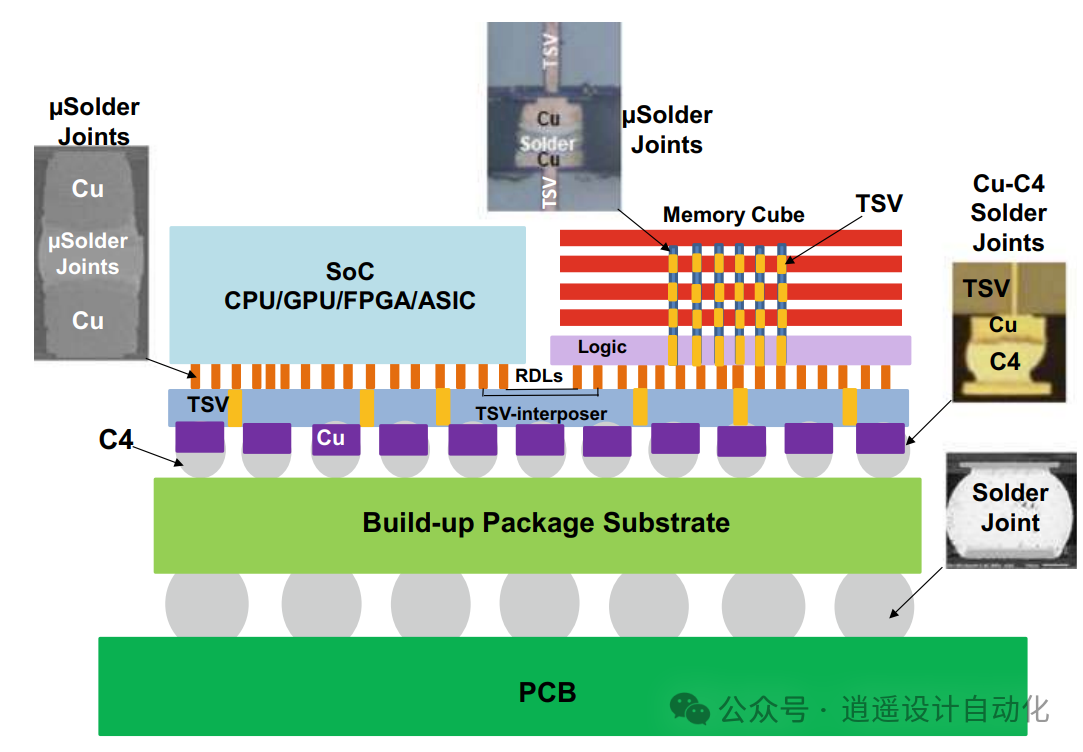 图5:在无源TSV中介层上的2.5D(CoWoS-2) Chiplet异构集成。 3D Chiplet集成 这种方法使用带有TSV的有源中介层垂直堆叠Chiplet。英特尔的Foveros技术是这种技术的主要代表。 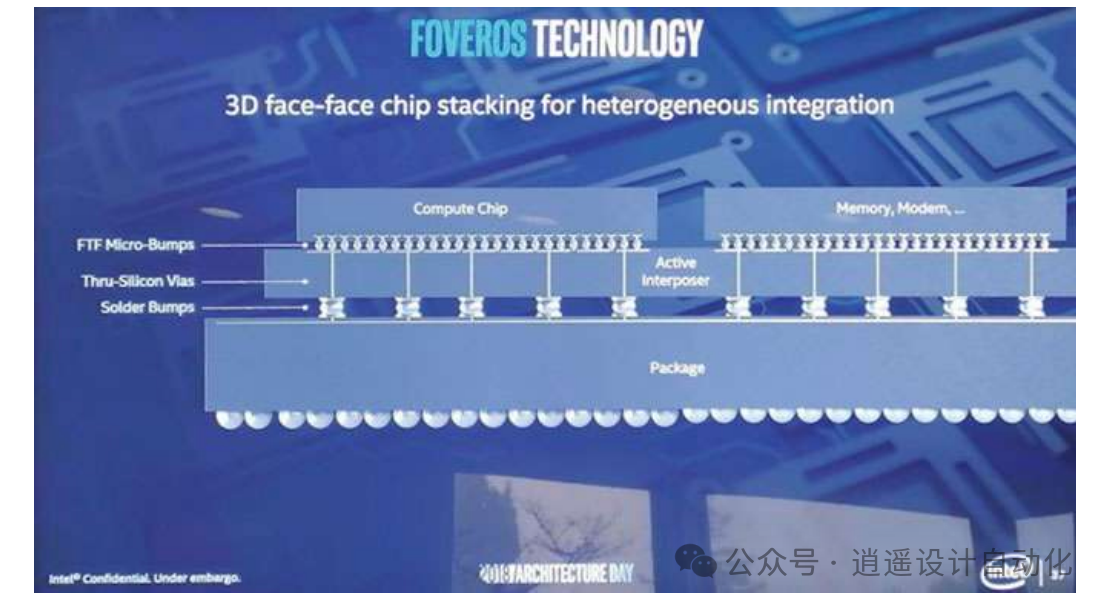 图6:英特尔的3D Chiplet异构集成(Foveros)。 带硅桥的Chiplet集成 这种方法在有机基板中嵌入硅桥来连接Chiplet。英特尔的EMIB(嵌入式多芯片互连桥)使用了这种方法。 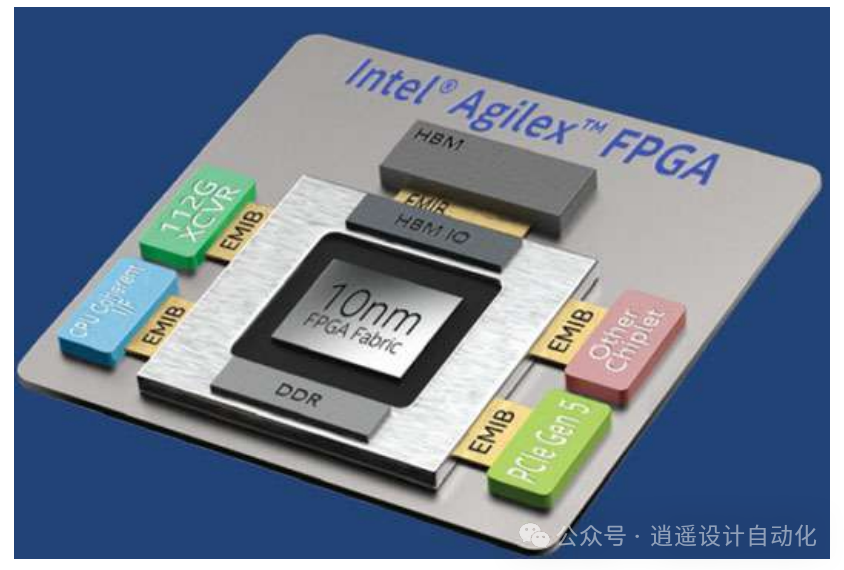 图7:英特尔在带硅桥的有机基板上的Chiplet异构集成(Agilex FPGA)。 封装叠加(PoP) Chiplet集成 这种技术垂直叠加封装,通常结合逻辑和存储Chiplet。苹果的A系列处理器使用这种方法,结合台积电的InFO(集成扇出)技术。 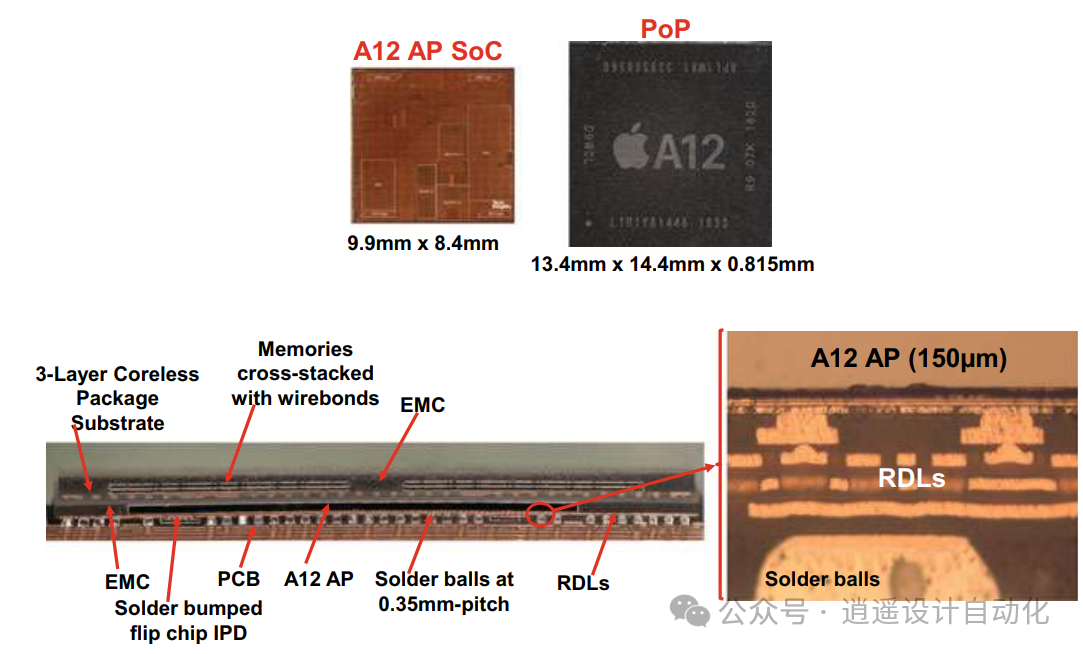 图8:苹果iPhone的PoP InFO Chiplet异构集成。 案例研究: 1. AMD的EPYC处理器: AMD的第二代EPYC服务器处理器展示了Chiplet设计的强大功能。通过使用Chiplet,AMD实现了比整体设计更高的核心数和性能,同时还降低了成本。 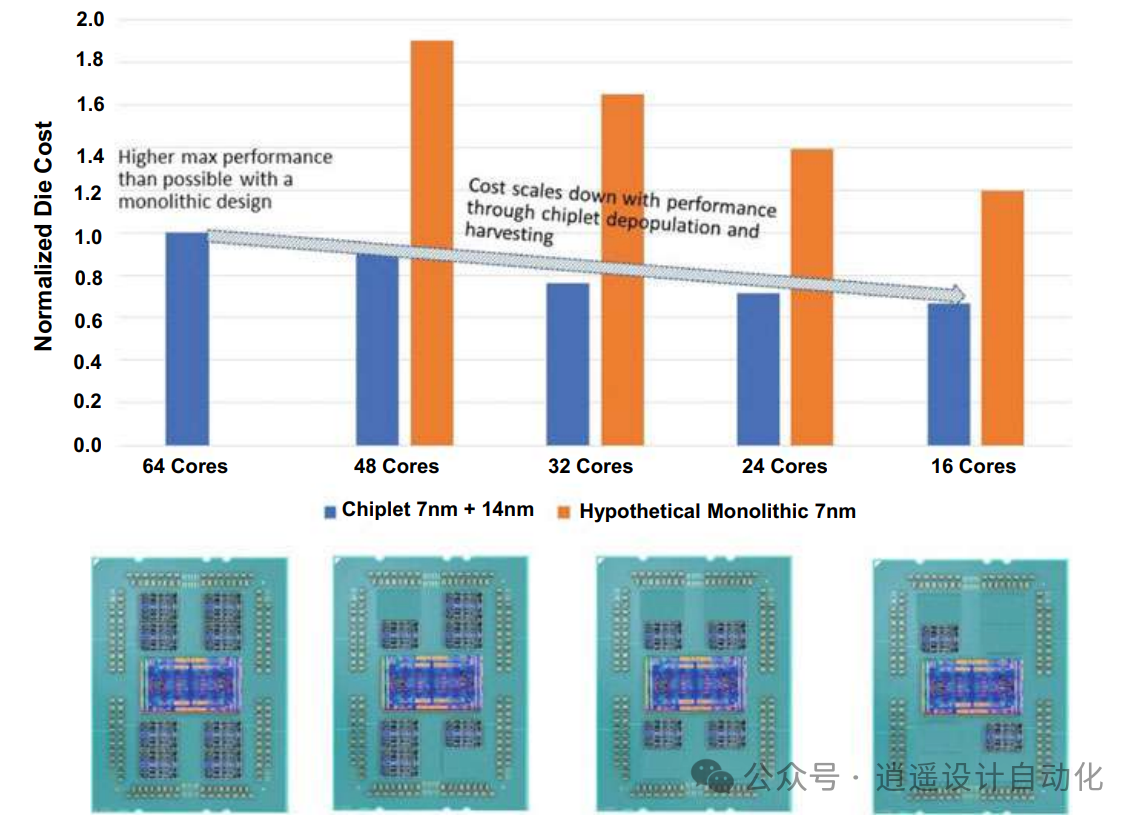 图9:AMD的芯片成本比较:Chiplet(7 nm + 12 nm)与整体(7 nm)。 2. 英特尔的Lakefield处理器: 英特尔的Lakefield移动处理器使用Foveros 3D封装技术垂直堆叠Chiplet。这种方法可以在适合移动设备的紧凑形态下实现高性能。 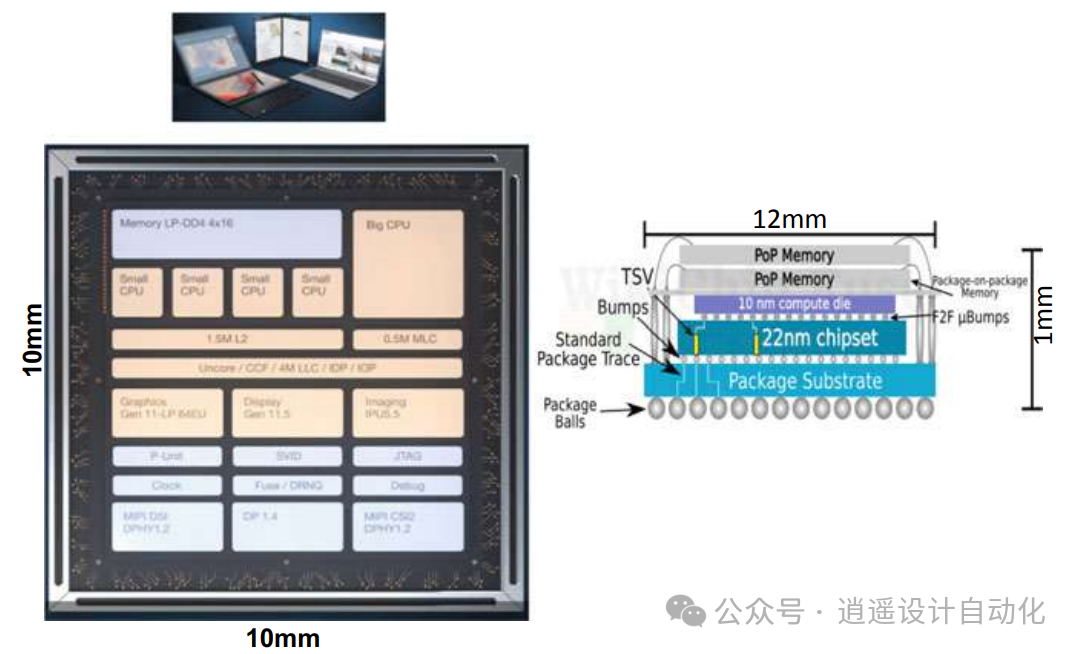 图10:使用Foveros技术的英特尔Lakefield移动处理器。 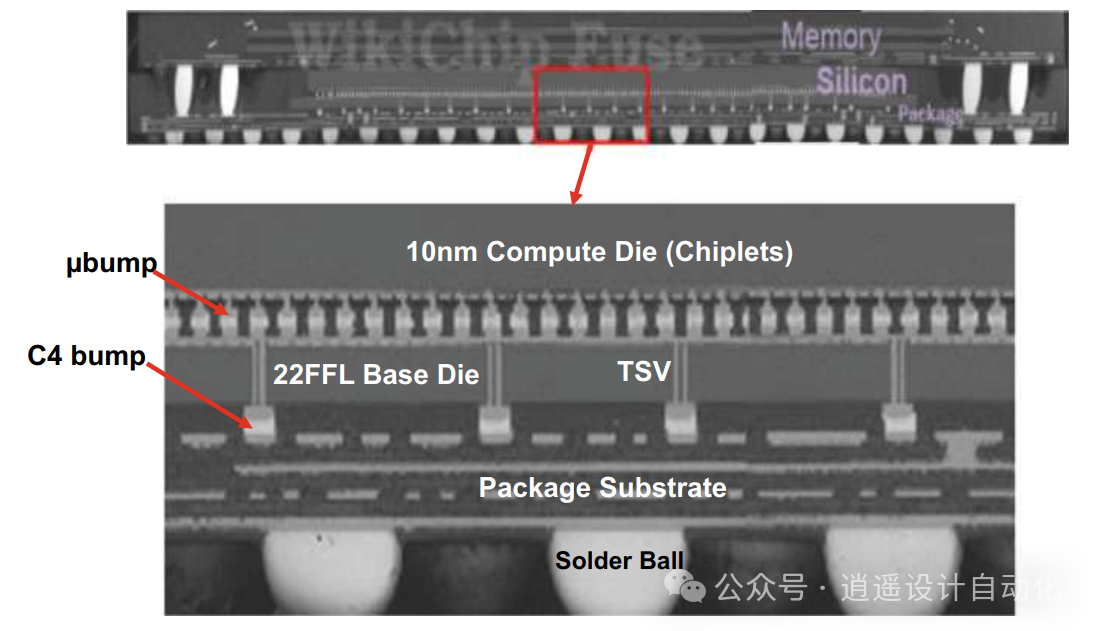 图11:Lakefield处理器横截面的扫描电子显微镜图像。 未来趋势 半导体行业在Chiplet集成技术方面不断创新,些新兴趋势包括: 1. 更细的互连间距: 英特尔已经展示了10 μm间距的混合键合技术,相比Lakefield使用的50 μm间距有了显著提升。 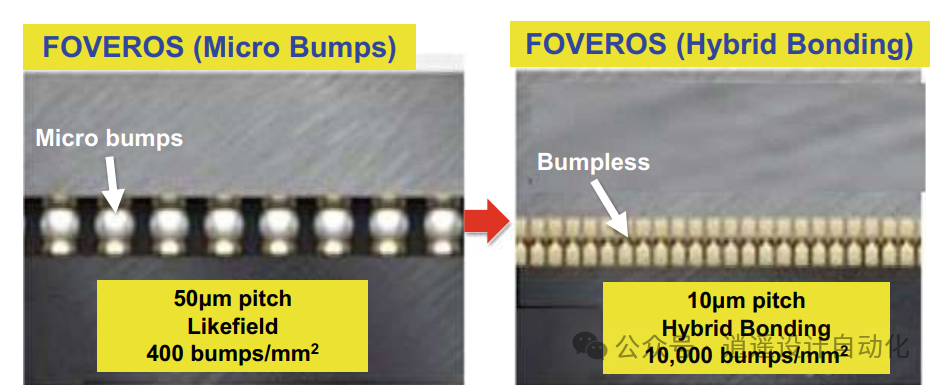 图12:英特尔的Foveros技术:微凸点(50 μm间距)和无凸点(10 μm间距)技术对比。 2. 3DFabric集成: 台积电的3DFabric技术为Chiplet集成提供全面的平台,涵盖前端到后端的工艺。  图13:台积电3DFabric集成概念。 3. 混合键合:台积电的集成芯片系统(SoIC)技术使用混合键合进行芯片到芯片和芯片到晶圆的集成,与传统的微凸点方法相比,提供了更好的热性能和能量性能。 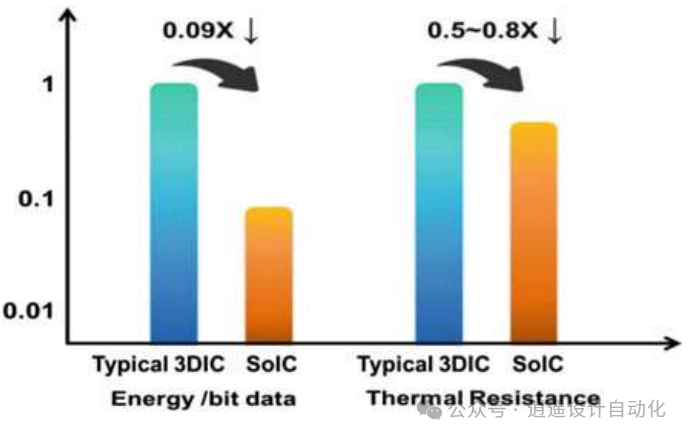 图14:SoIC与传统3D IC的热性能和能量性能比较。 结论 Chiplet异构集成代表了半导体设计和封装的范式转变。通过将复杂系统分解为更小、更易管理的Chiplet,制造商可以优化性能、降低成本并缩短上市时间。虽然在标准化和设计工具方面仍然存在挑战,但基于Chiplet设计的潜在优势正在推动行业快速创新。 展望未来,可以预期Chiplet集成技术将继续进步,包括更细的互连间距、改进的热管理和更复杂的3D集成技术。AMD EPYC处理器和英特尔Lakefield等产品的成功证明了基于Chiplet设计的可行性和潜力。 对于希望利用Chiplet技术的公司来说,权衡不同集成方法之间的利弊,并选择最适合其特定应用需求、性能目标和成本限制的方法非常重要。随着生态系统的成熟和标准的出现,Chiplet异构集成将在塑造半导体设计和制造的未来方面发挥重要作用。 |





