倒装芯片(Flip chip)是一种无引脚结构,一般含有电路单元。设计用于通过适当数量的位于其面上的锡球(导电性粘合剂所覆盖),在电气上和机械上连接于电路。它也被称为FC封装技术,是一种先进的集成电路封装技术。在传统封装技术中,芯片被封装在底部,并通过金线连接到封装基板上。而倒装芯片技术则将芯片直接翻转并安装在封装基板上,然后使用微小的焊点或导电胶水进行连接。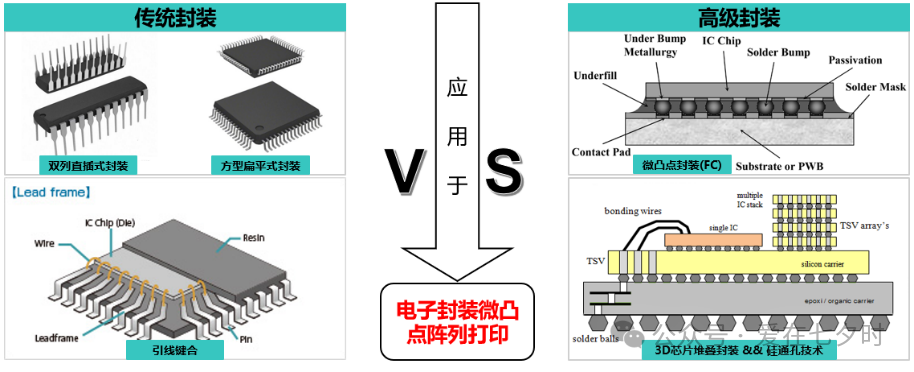 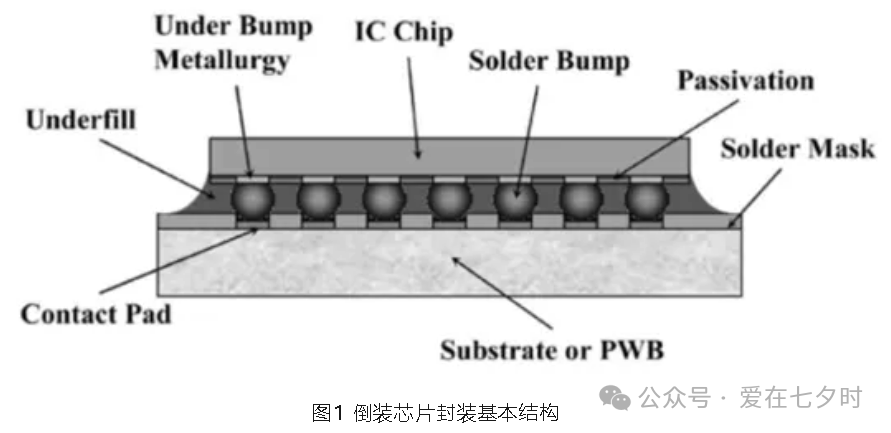 倒装芯片技术优势: 1、尺寸更小 相比传统封装技术,倒装芯片技术更加紧凑,可以显著减小电子产品的尺寸和厚度。 2、电性能更好 倒装芯片技术可以缩短电信号传输距离,减少电阻、电感等不良影响,提高芯片的电性能。 3、散热更佳 由于芯片直接与封装基板接触,倒装芯片技术可以更好地散热,提高芯片的稳定性和可靠性。 4、抗冲击性强 倒装芯片技术中的芯片与封装基板紧密结合,具有更高的抗冲击性,对于移动设备和工业应用等领域具有重要意义。 5、成本更低 倒装芯片技术可以简化封装流程,减少所需材料和设备,降低生产成本。 倒装芯片技术虽然具有许多优点,但也存在一些潜在的缺点,以下就是倒装芯片技术的劣势: 1、设计困难 倒装芯片技术需要在设计阶段考虑封装布局和连接方式,这增加了设计复杂性和挑战性。芯片和封装基板之间的连接方式需要精确控制,以确保可靠性和稳定性。 2、成本较高倒装芯片技术在生产过程中需要更高级别的设备和技术,以确保倒装芯片的准确安装和连接。这可能导致制造成本的增加,尤其对于规模较小的生产批量而言。 3、散热管理挑战 倒装芯片技术中,翻转的芯片直接与封装基板接触,散热困难较大。由于倒装芯片的背面无法自由散热,需要采取额外的散热措施来保持芯片的温度稳定,否则可能出现过热的问题。 4、机械脆弱性 由于倒装芯片技术中芯片直接暴露在外,容易受到机械应力和物理损伤的影响。这可能导致芯片的可靠性和寿命下降,特别是在受到震动、冲击和弯曲等力量作用时。 5、可维修性差 倒装芯片技术中,芯片直接连接在封装基板上,一旦出现故障,更换或维修芯片将更加困难。这可能导致维修成本的增加,并且对于一些应用场景可能带来挑战。 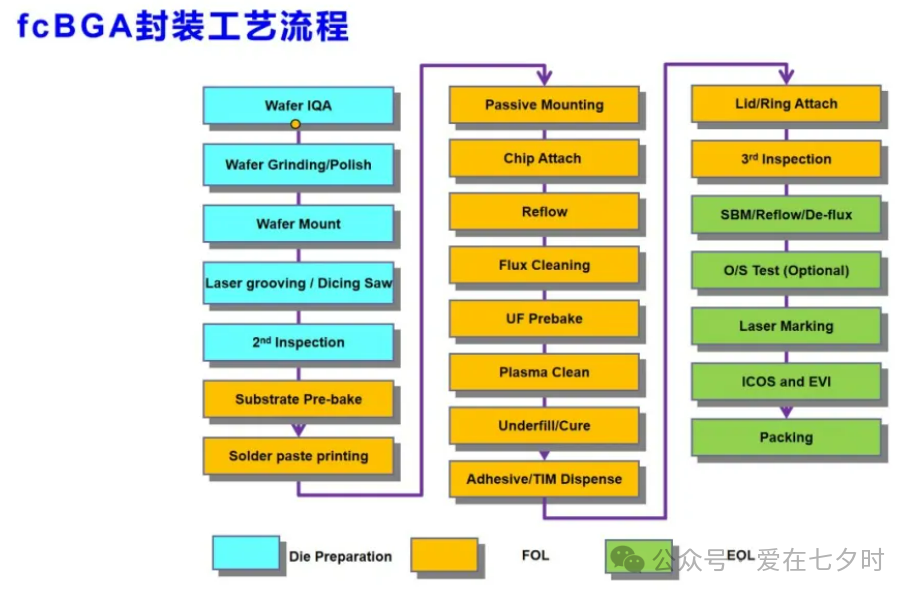 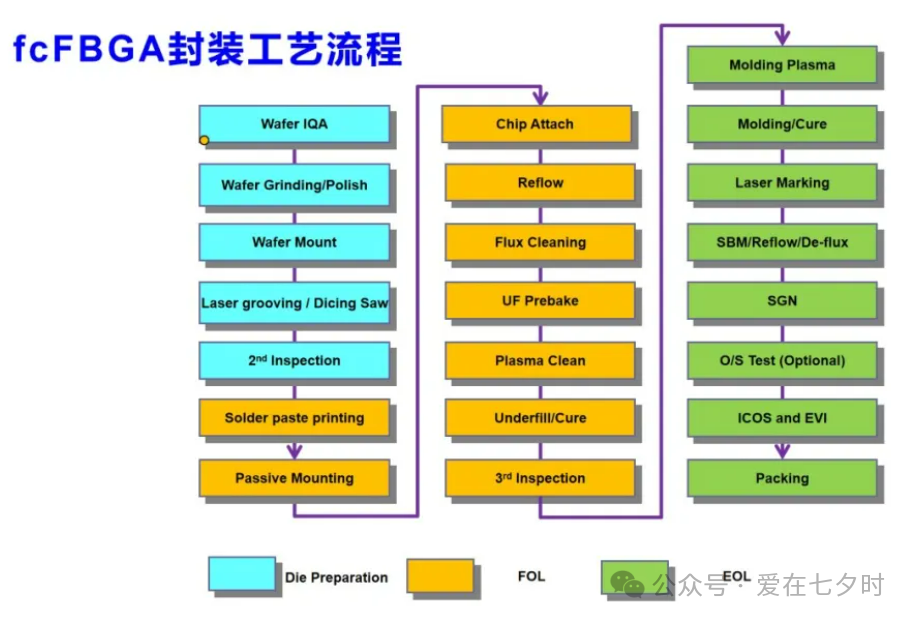 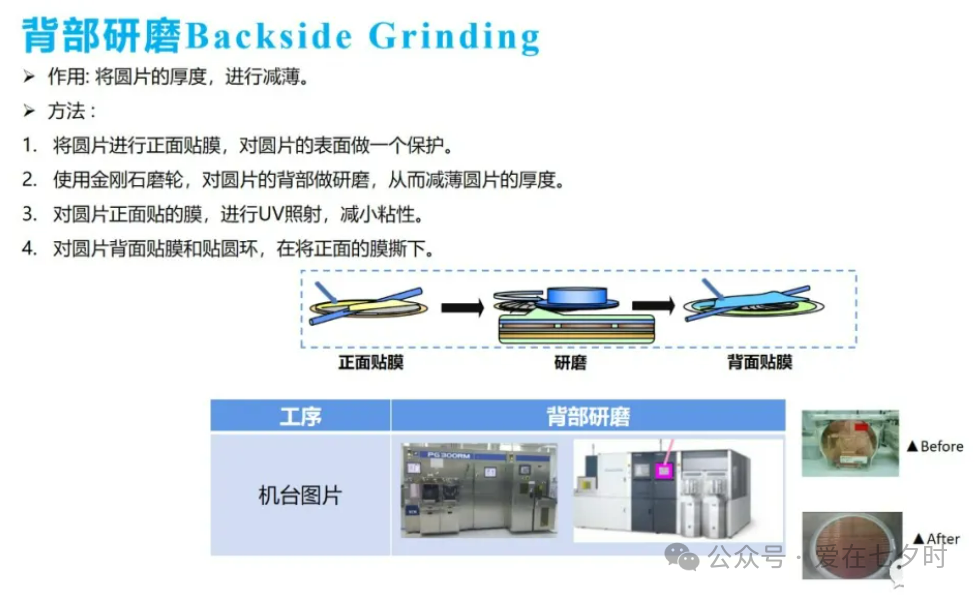 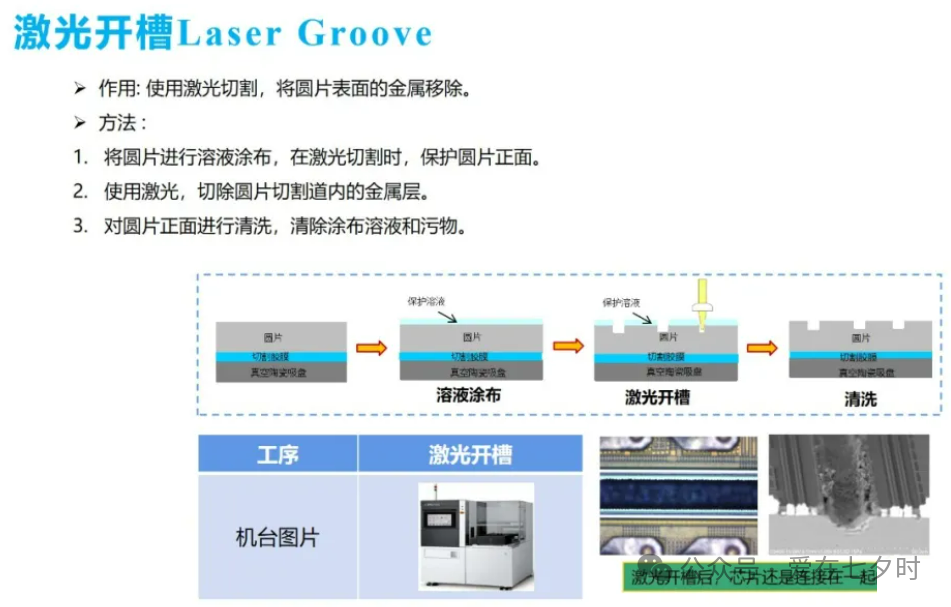 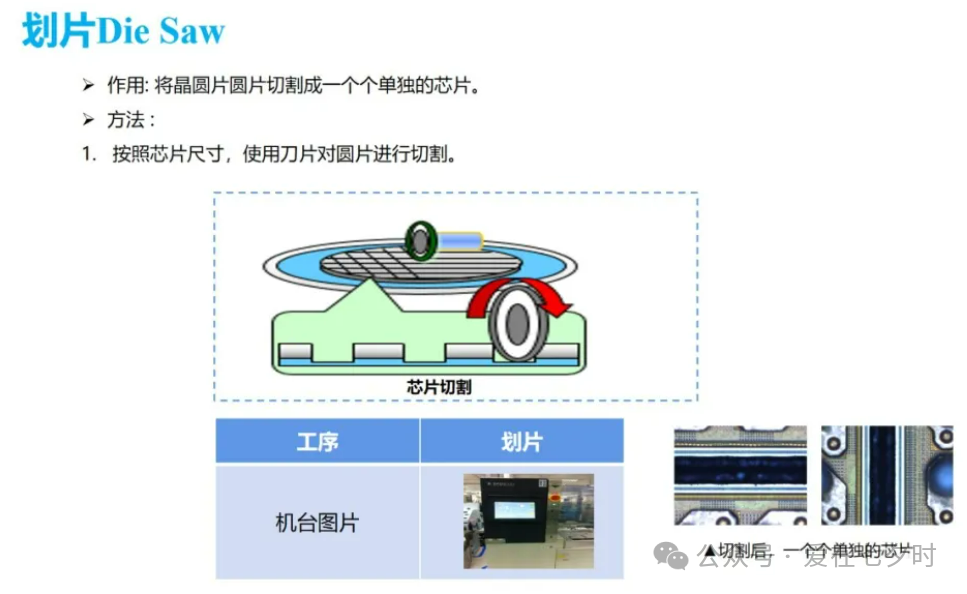 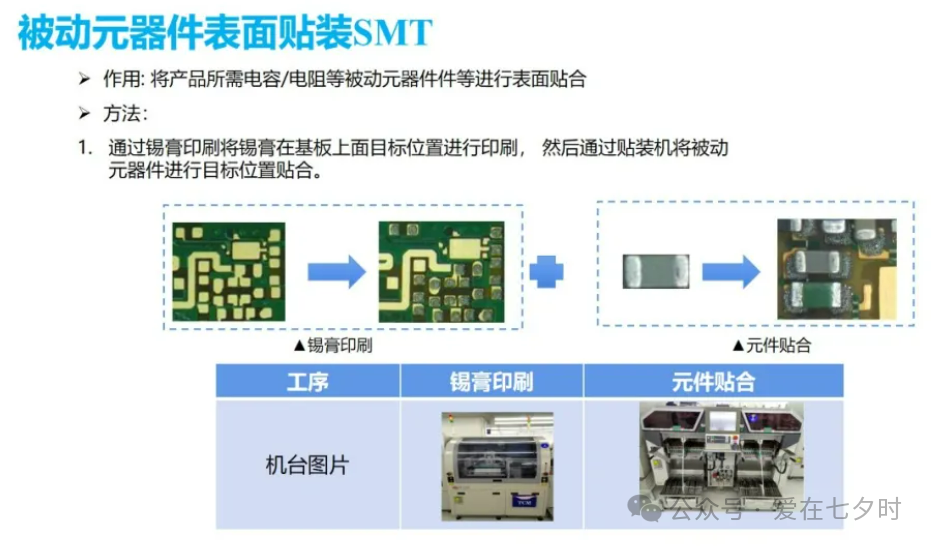 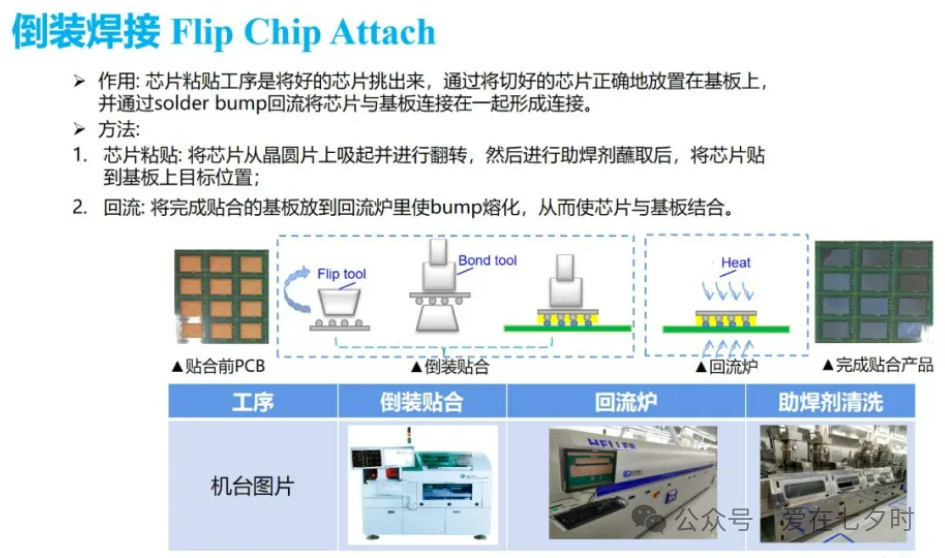 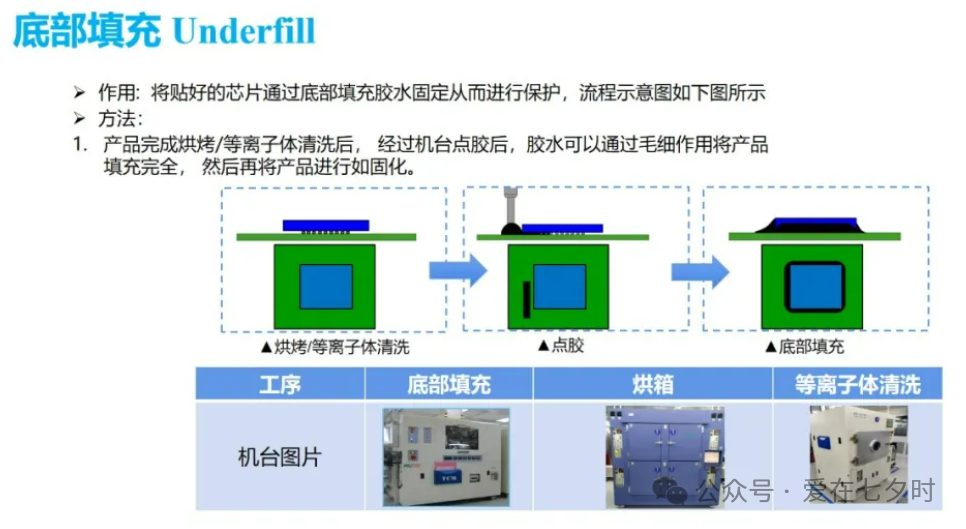 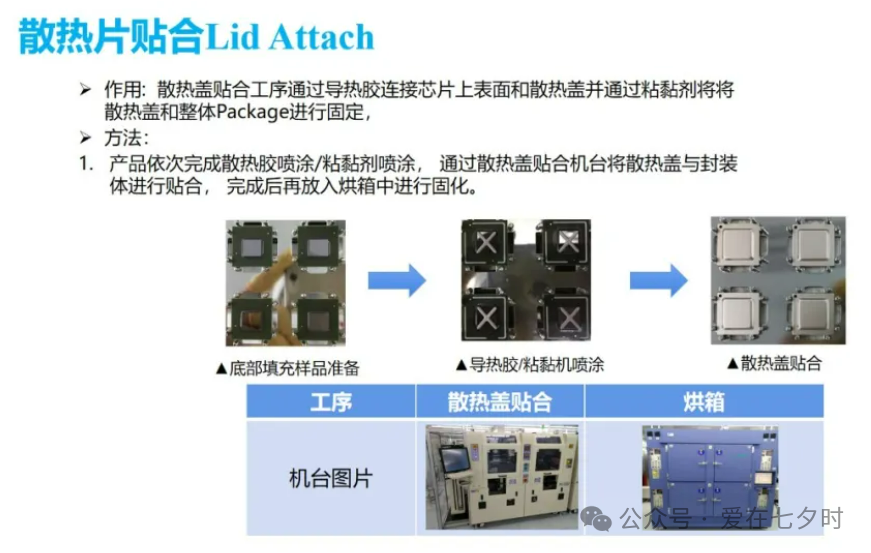  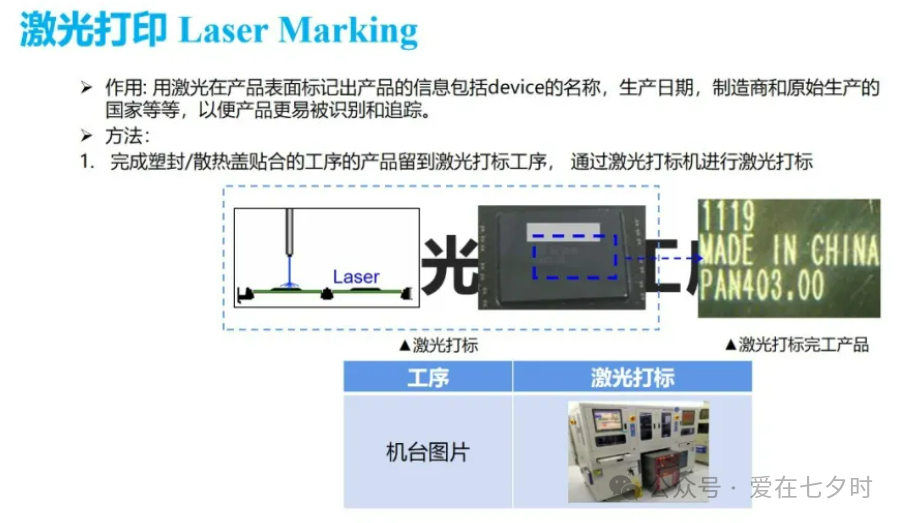      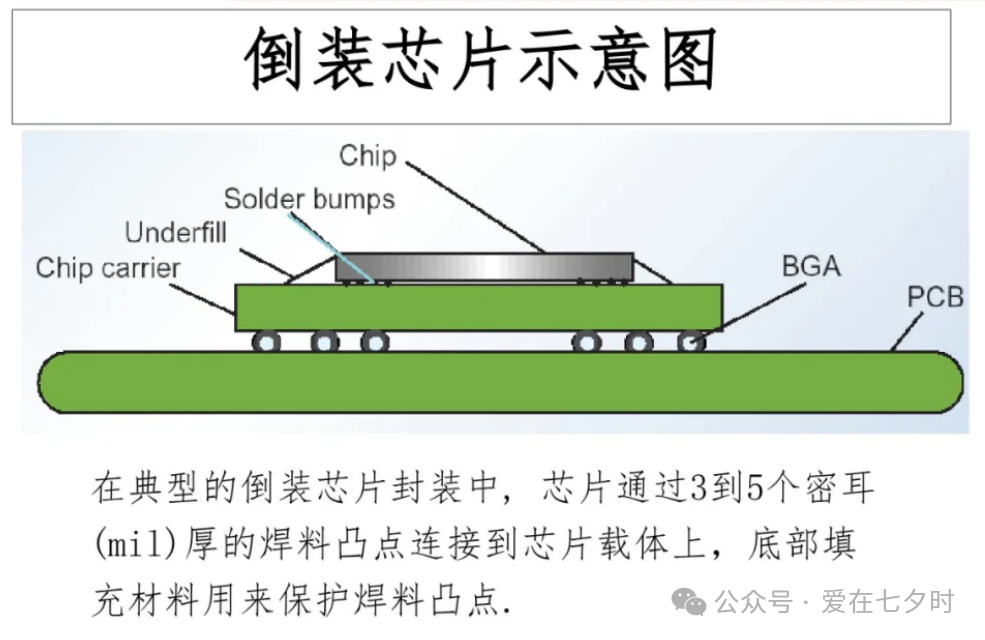            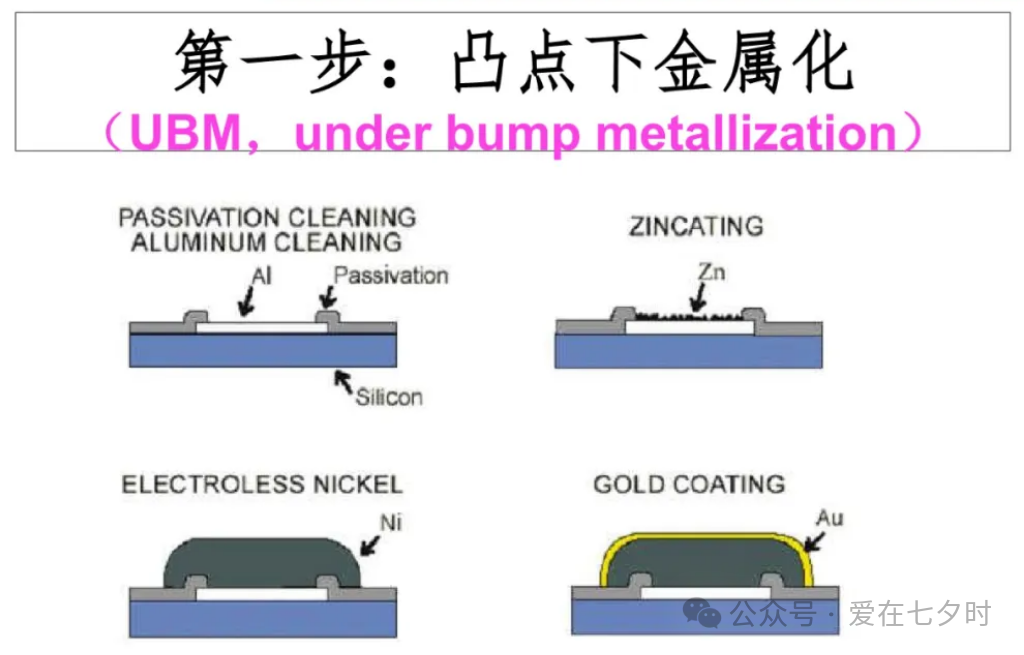 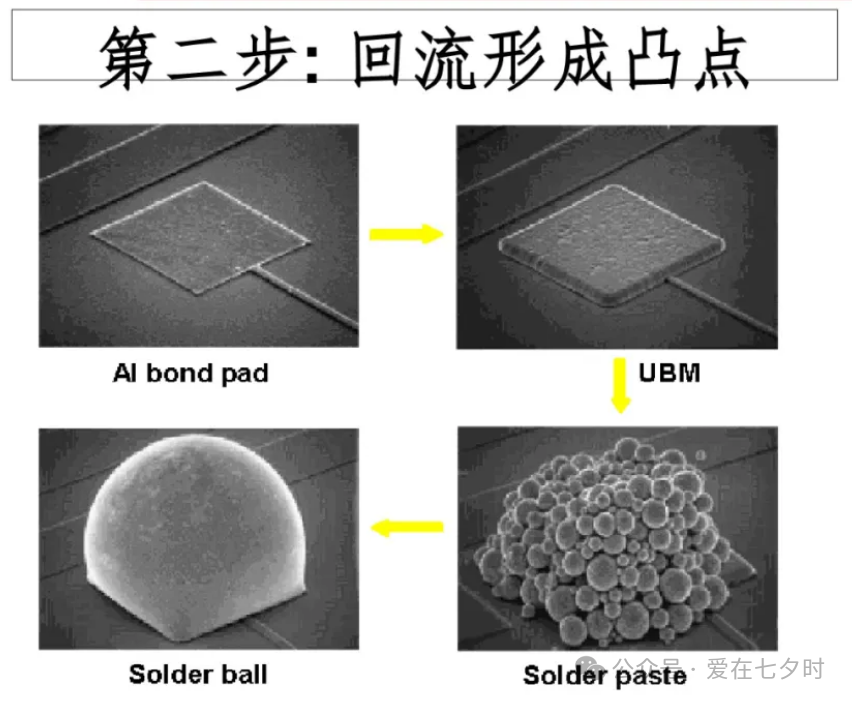 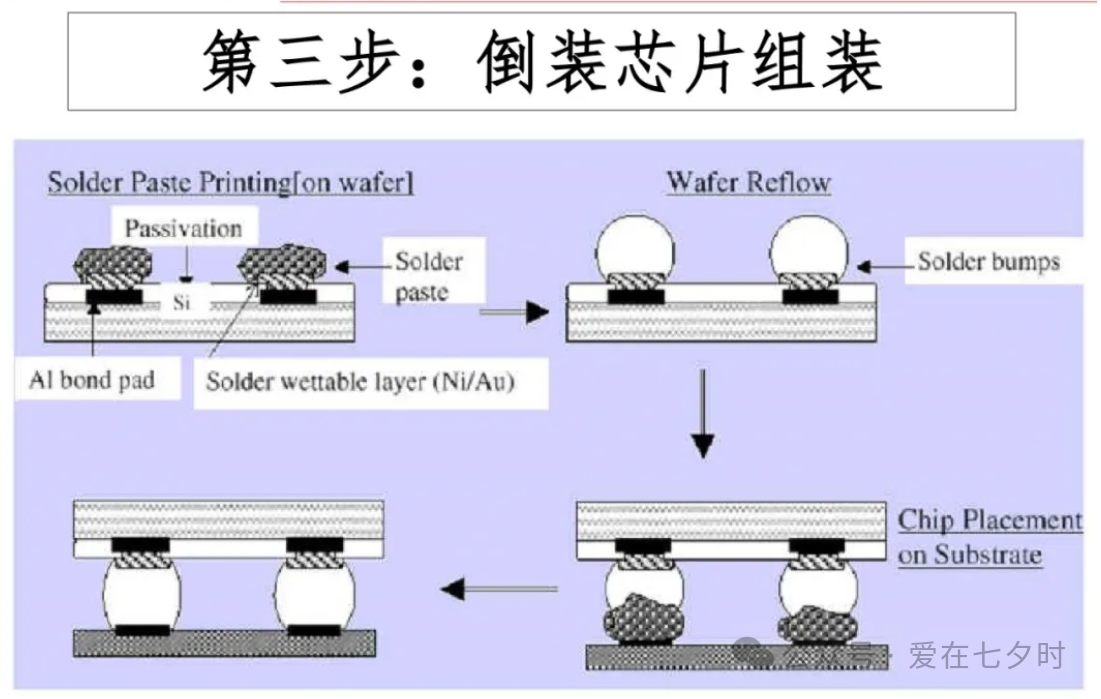 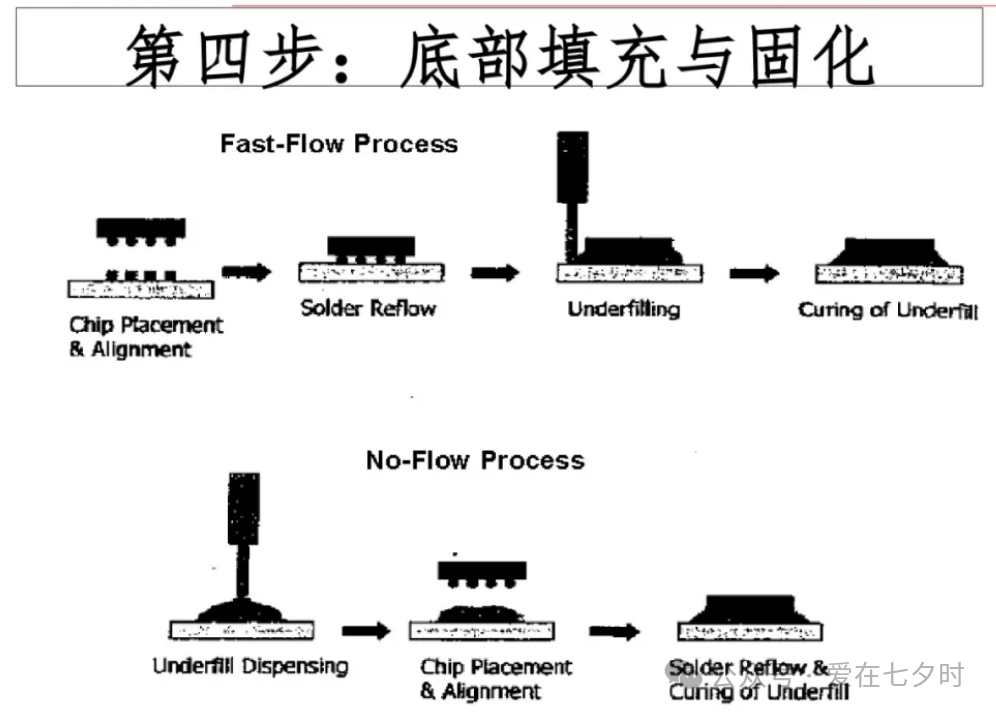 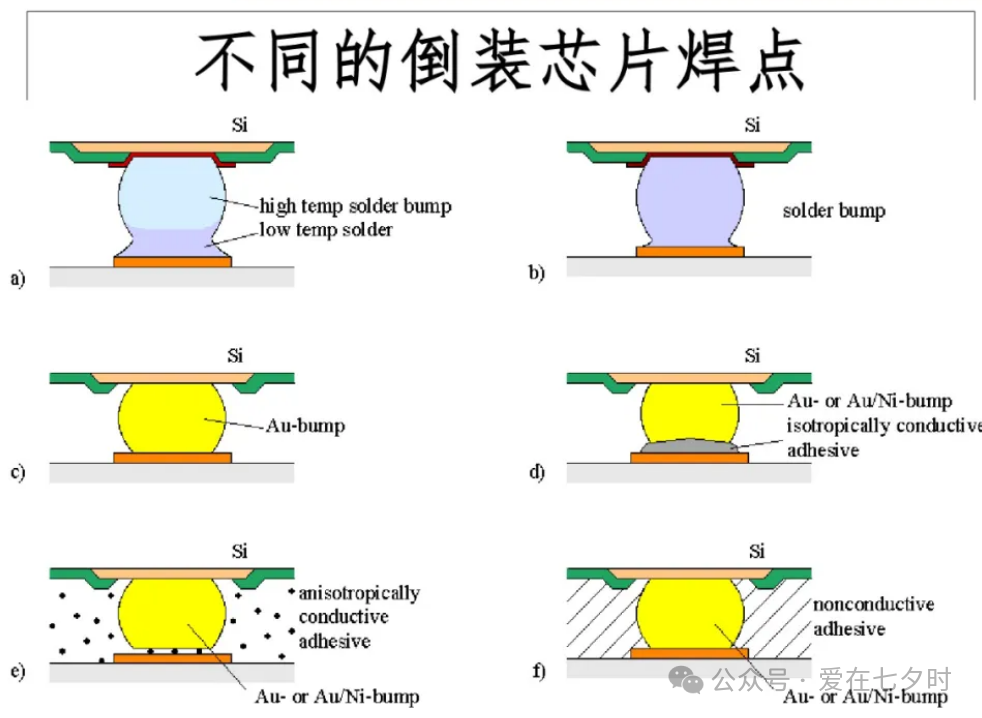 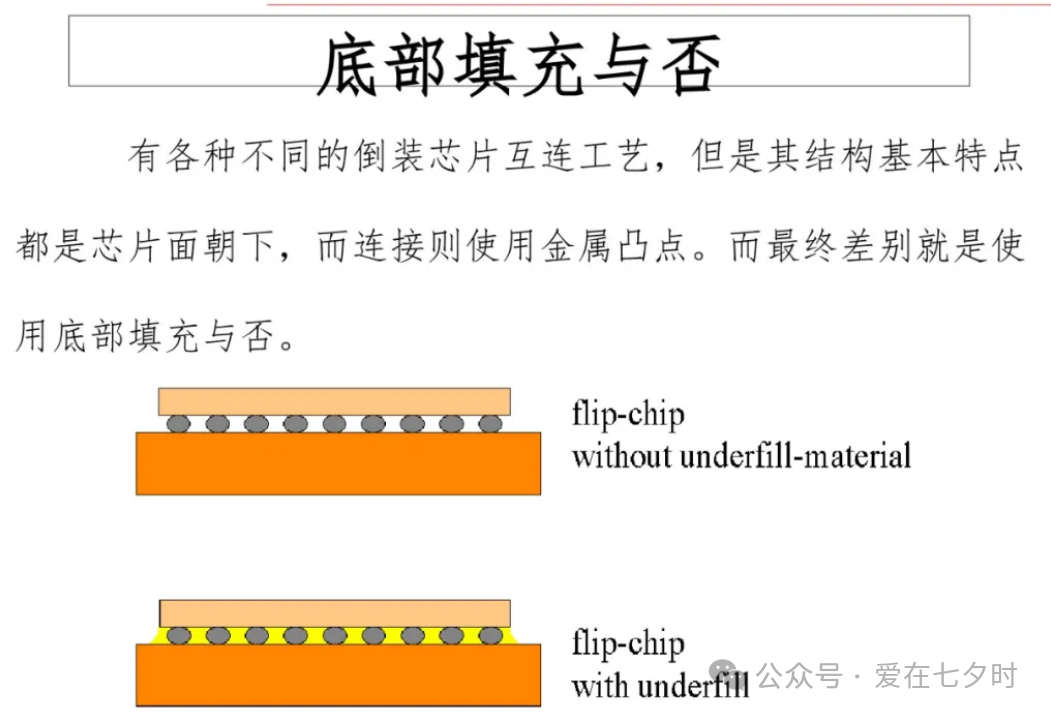       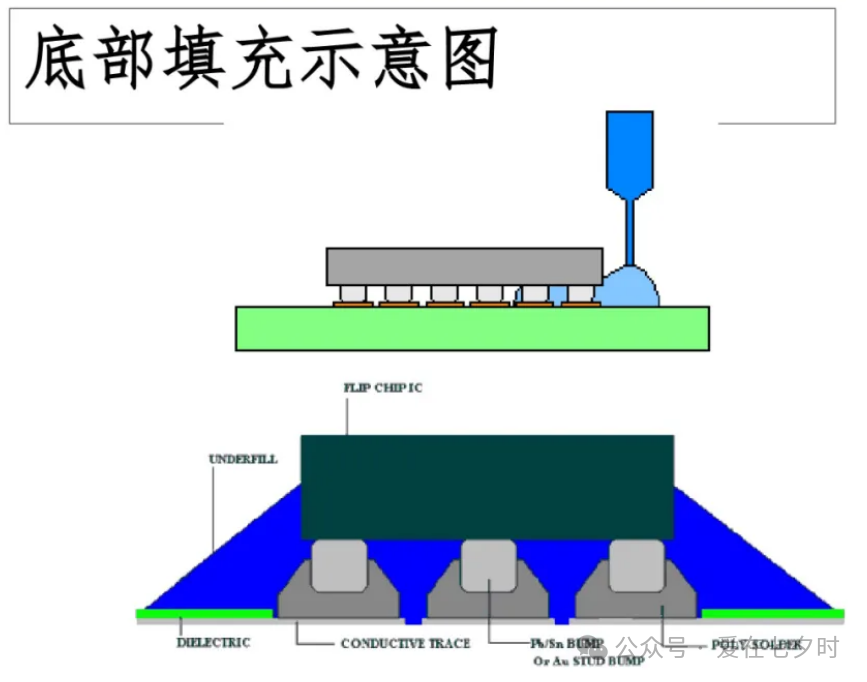  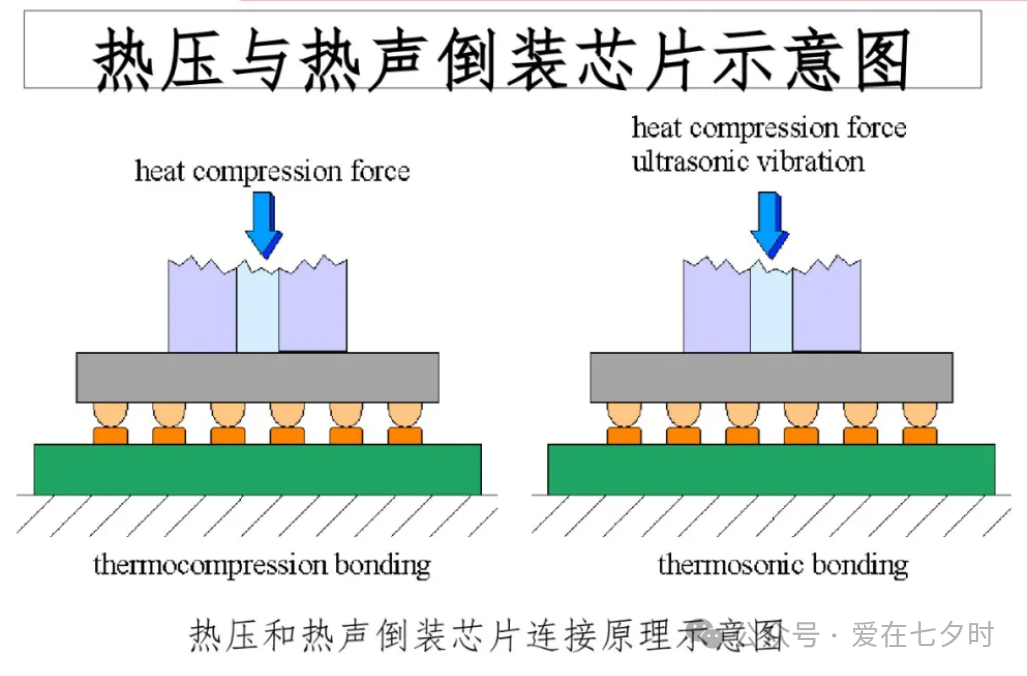                  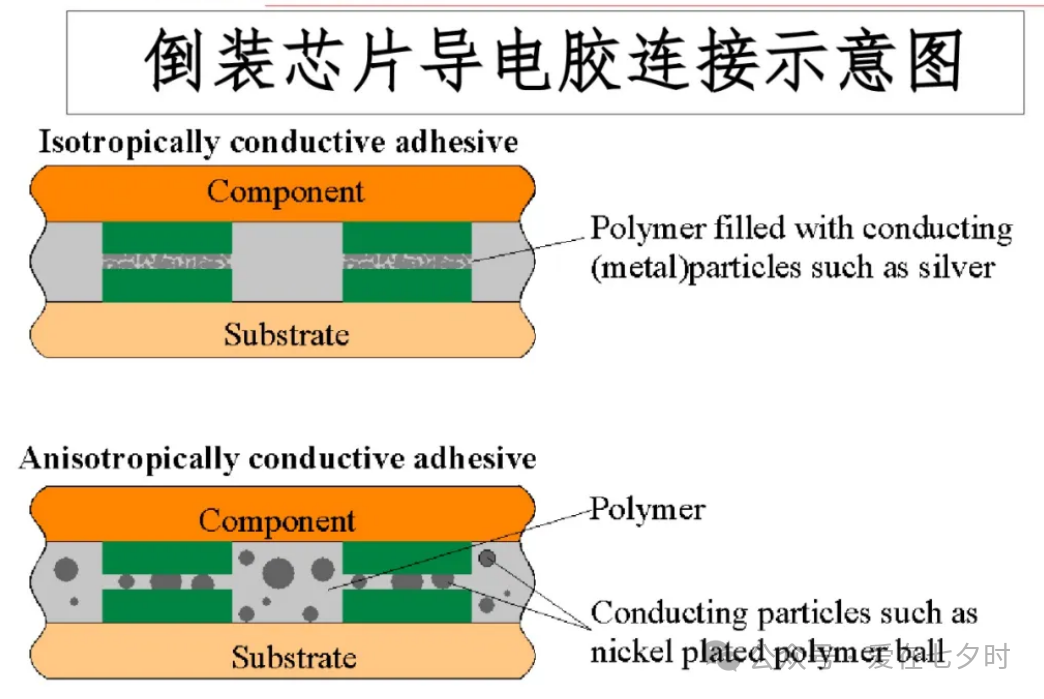      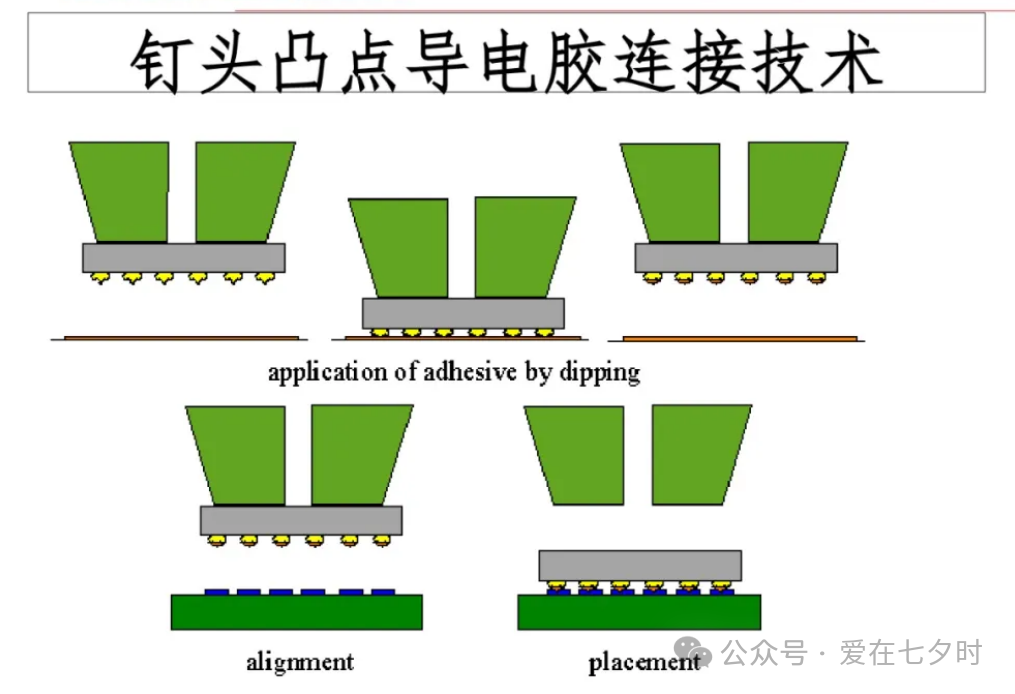       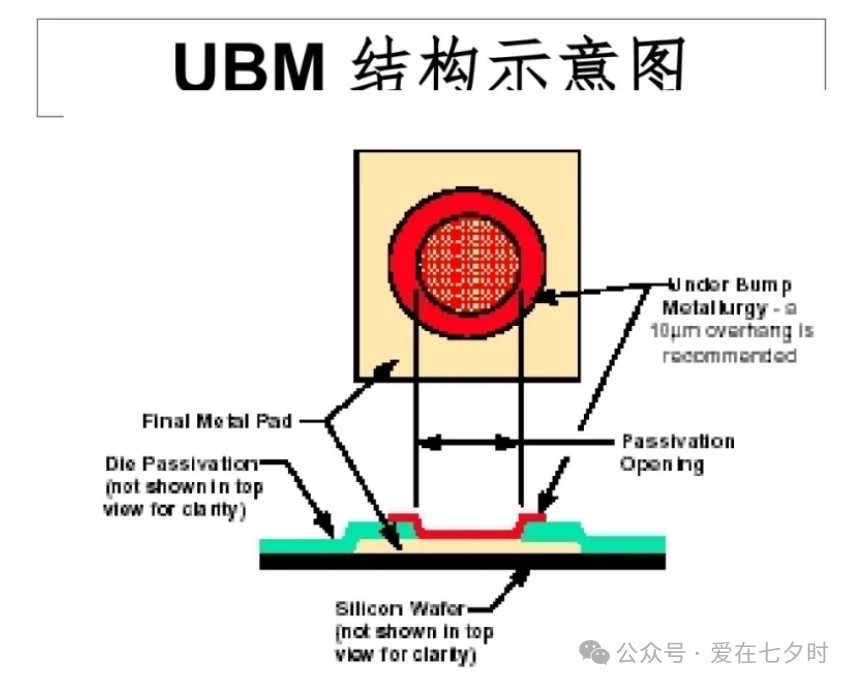               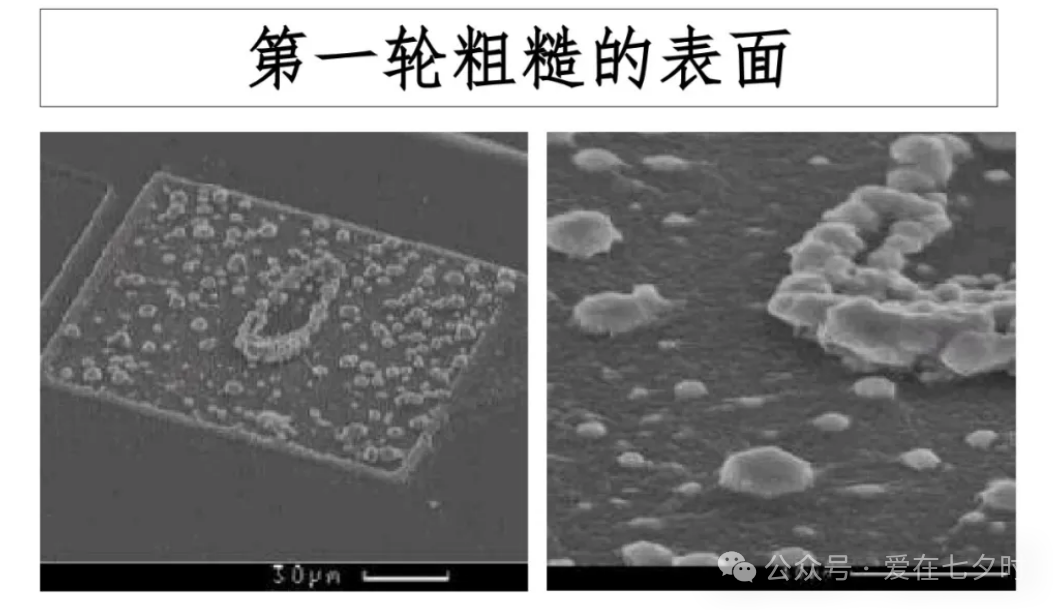 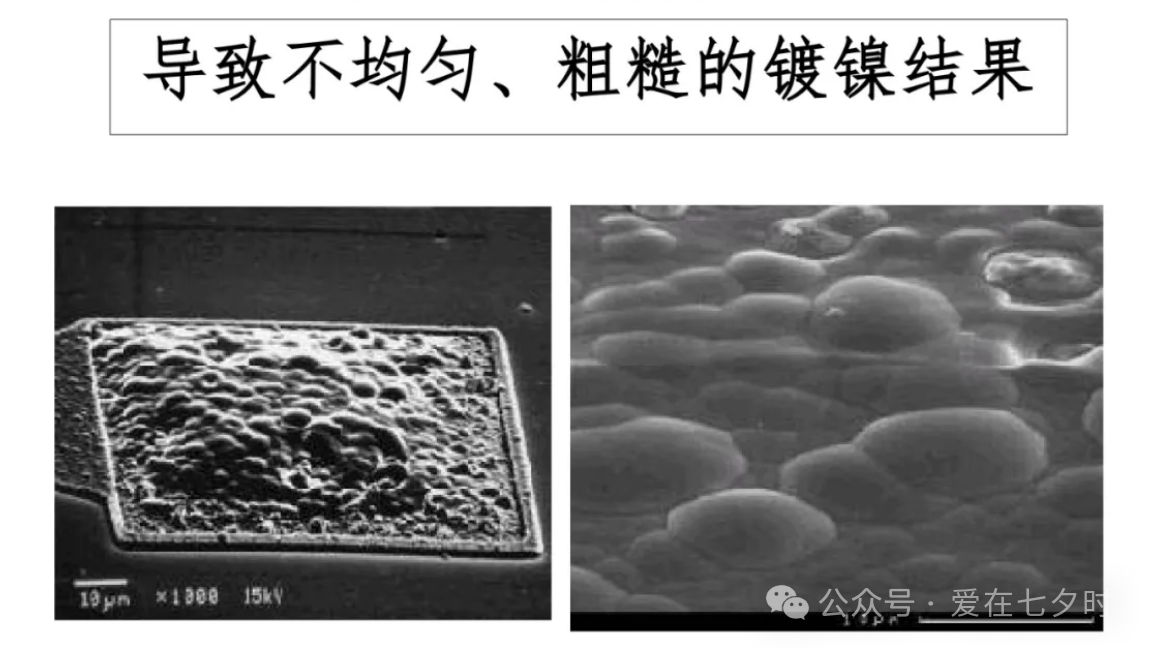         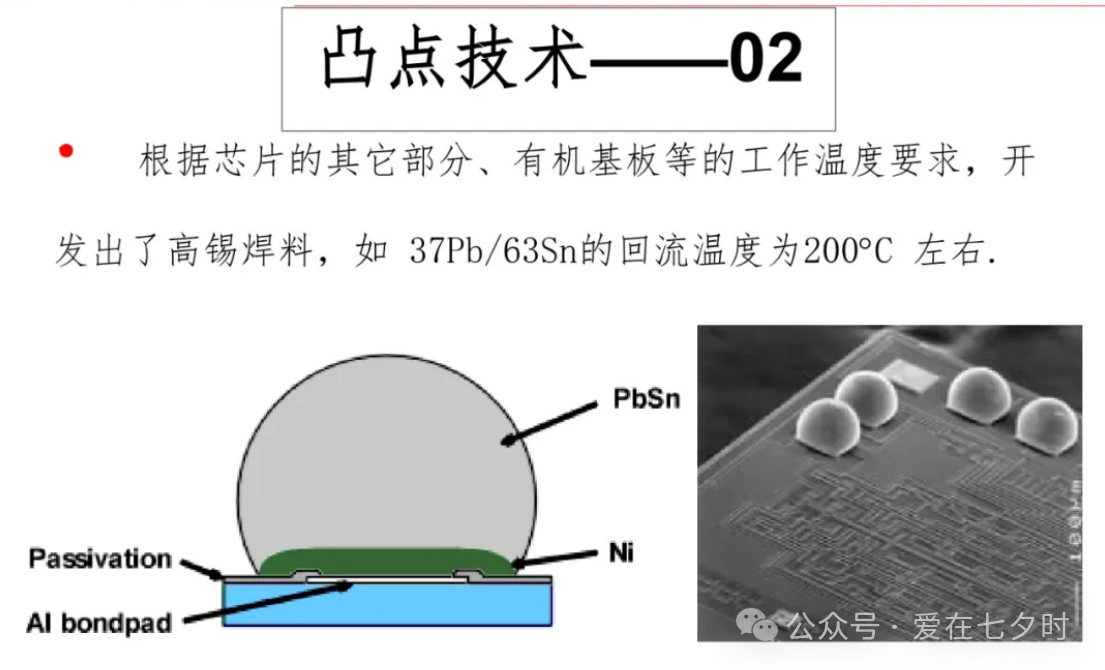  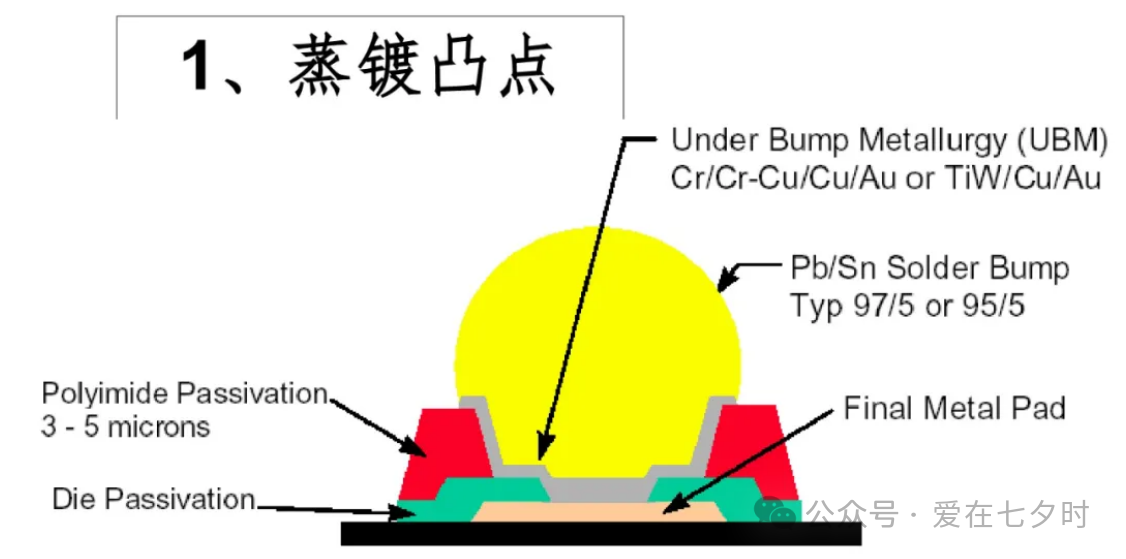 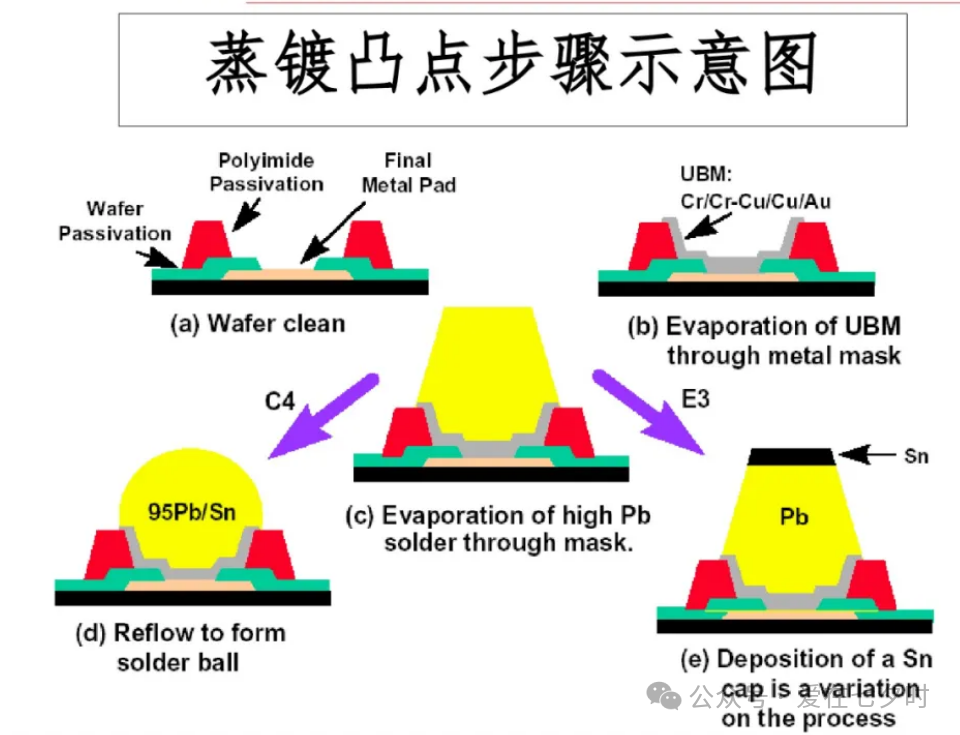     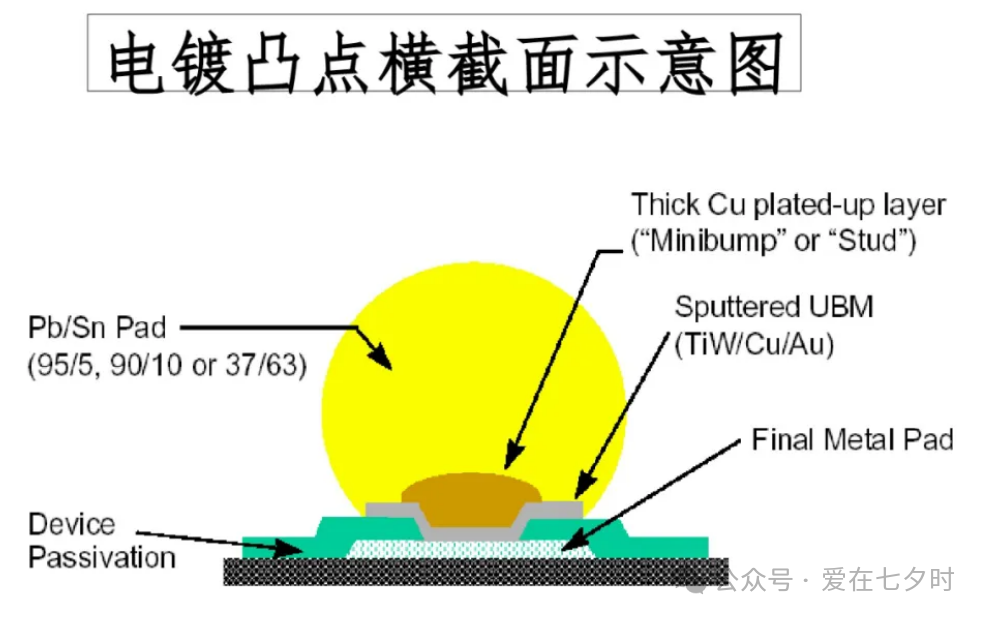 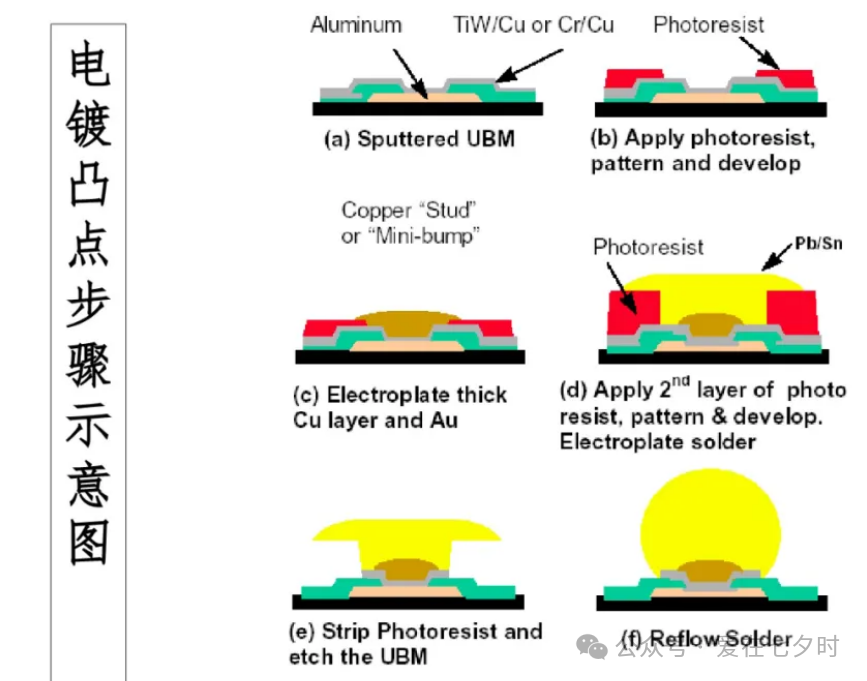   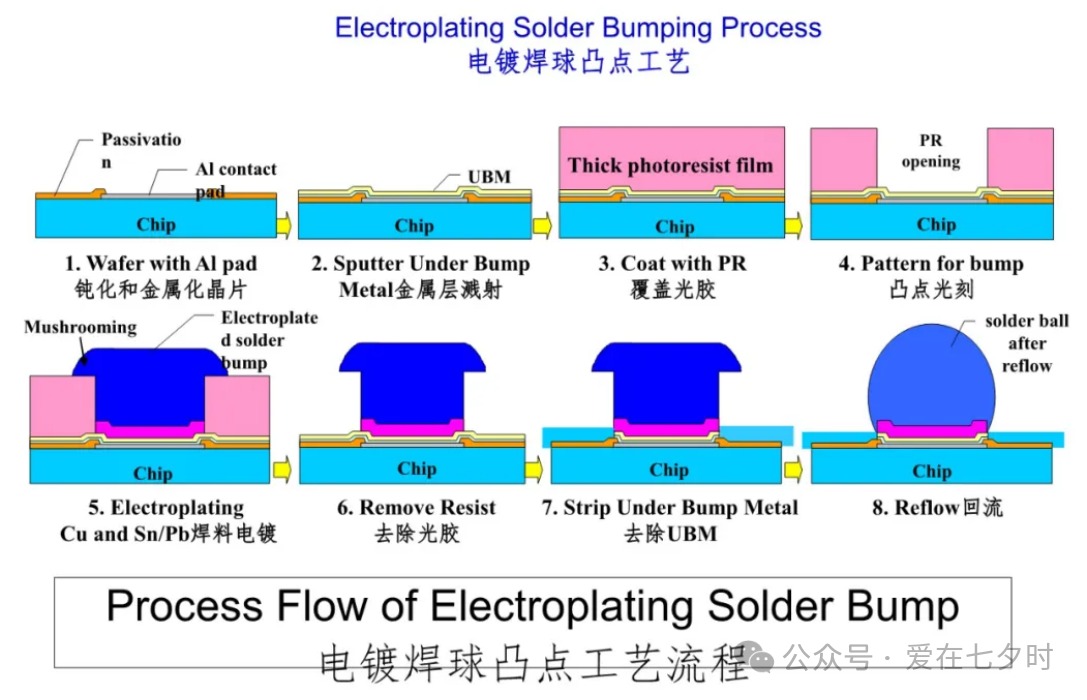 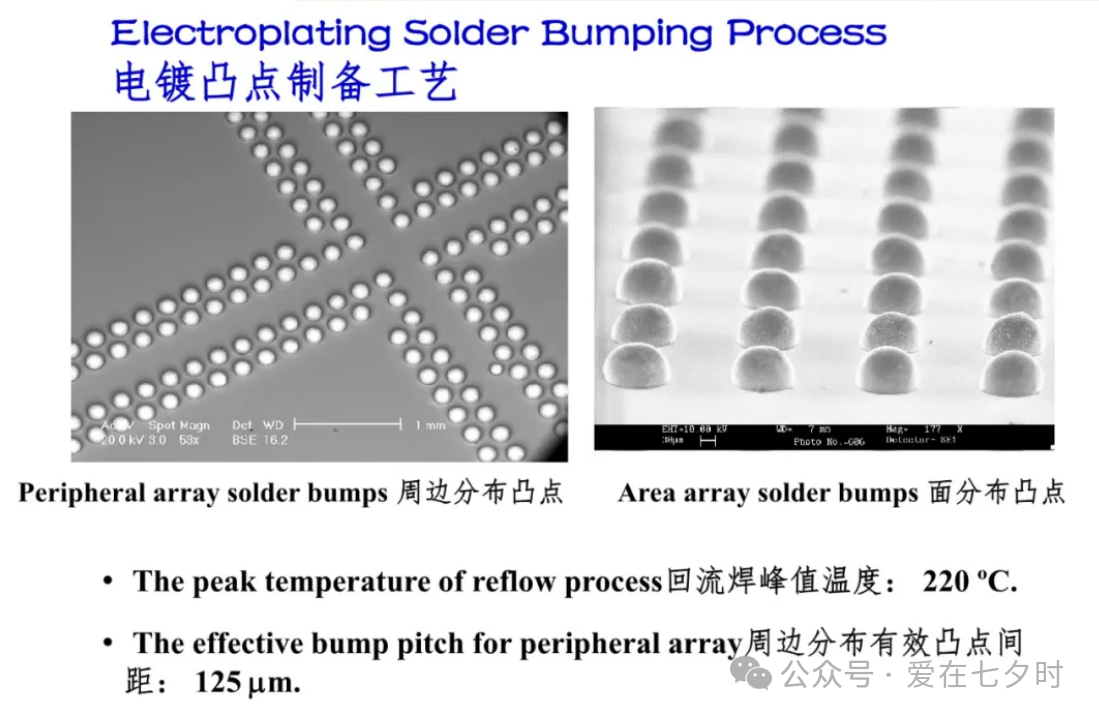  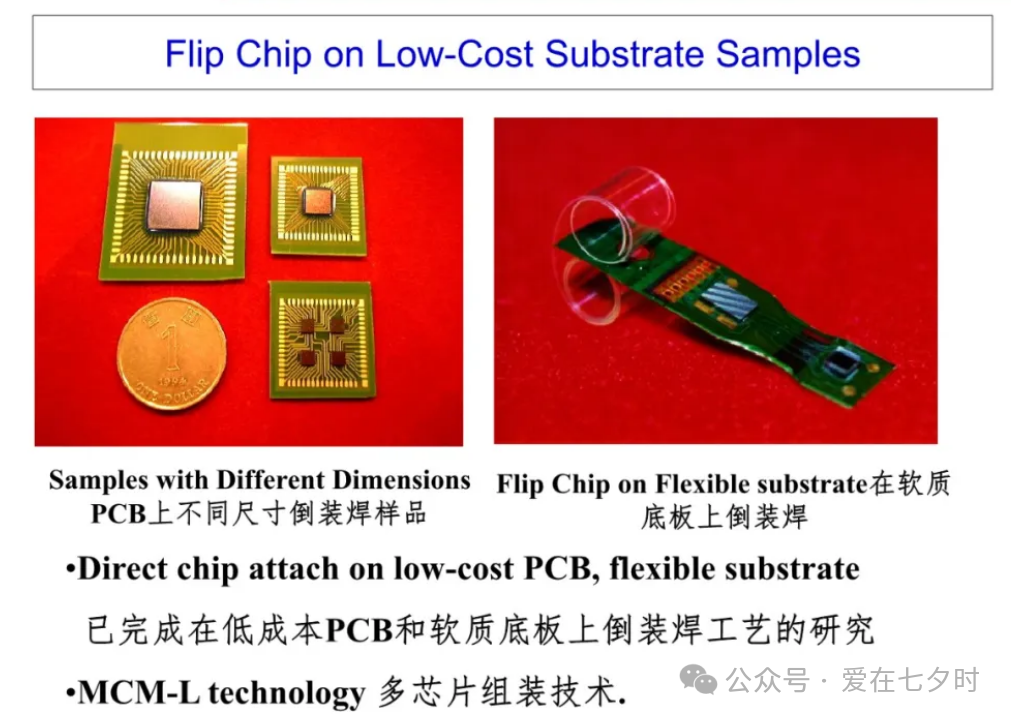  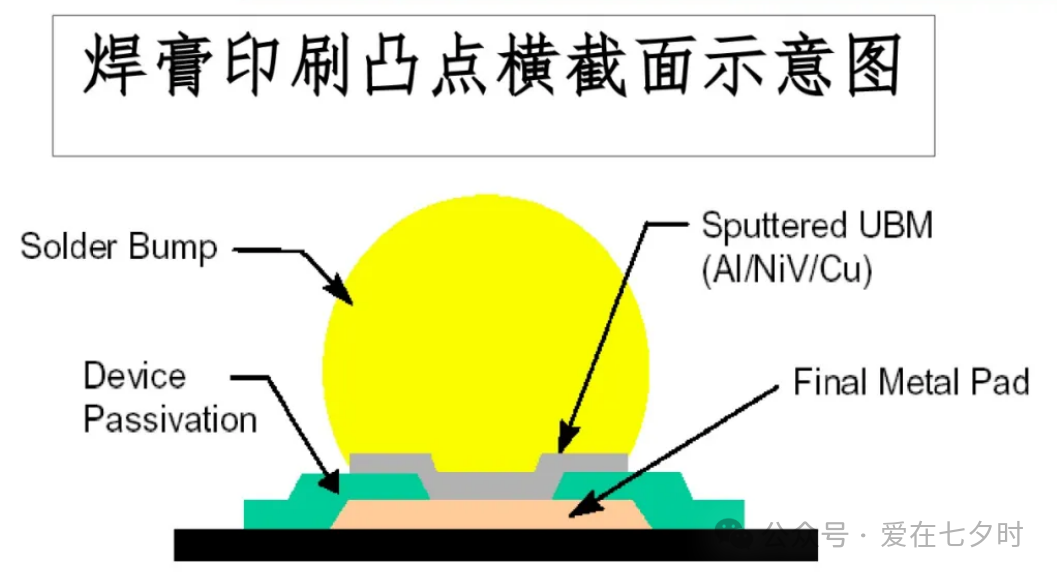 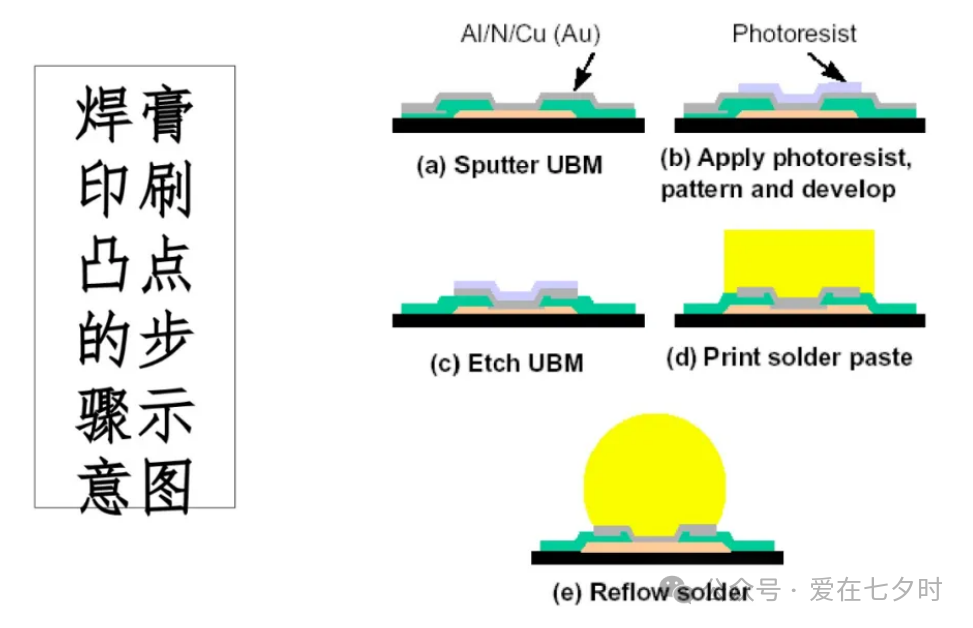  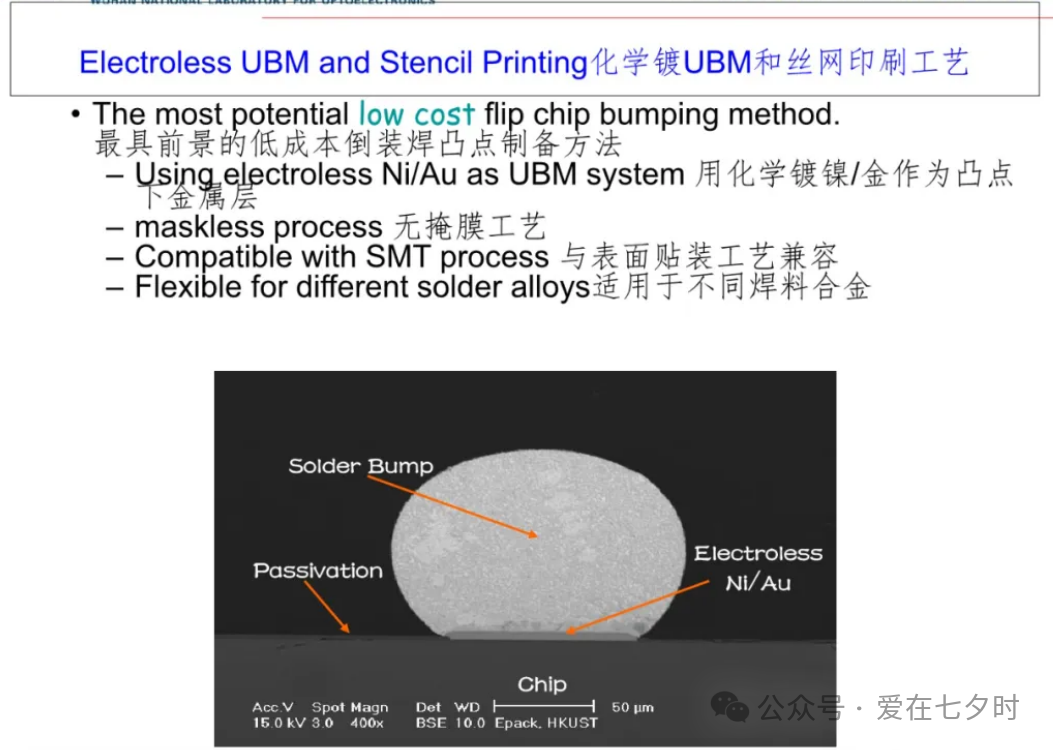 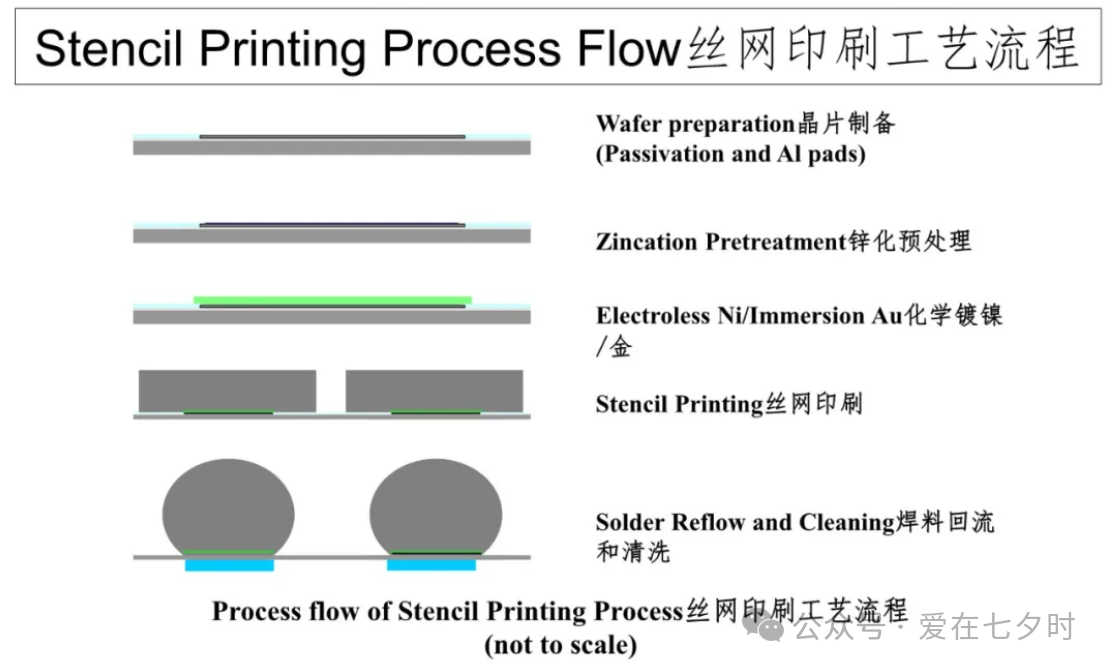 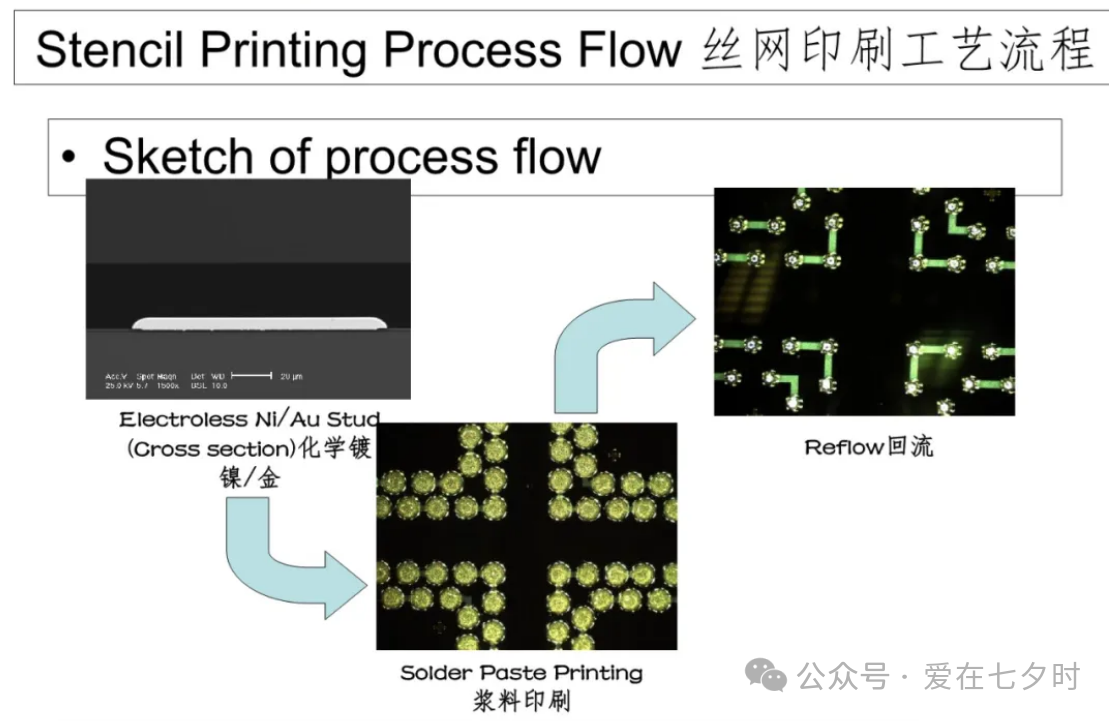    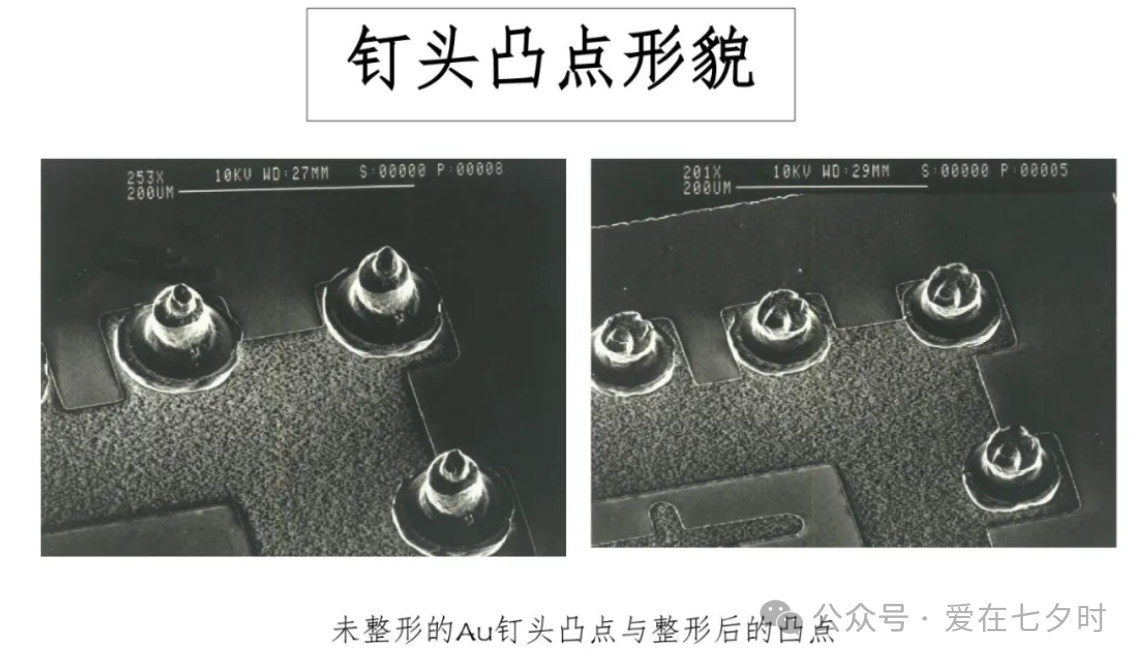 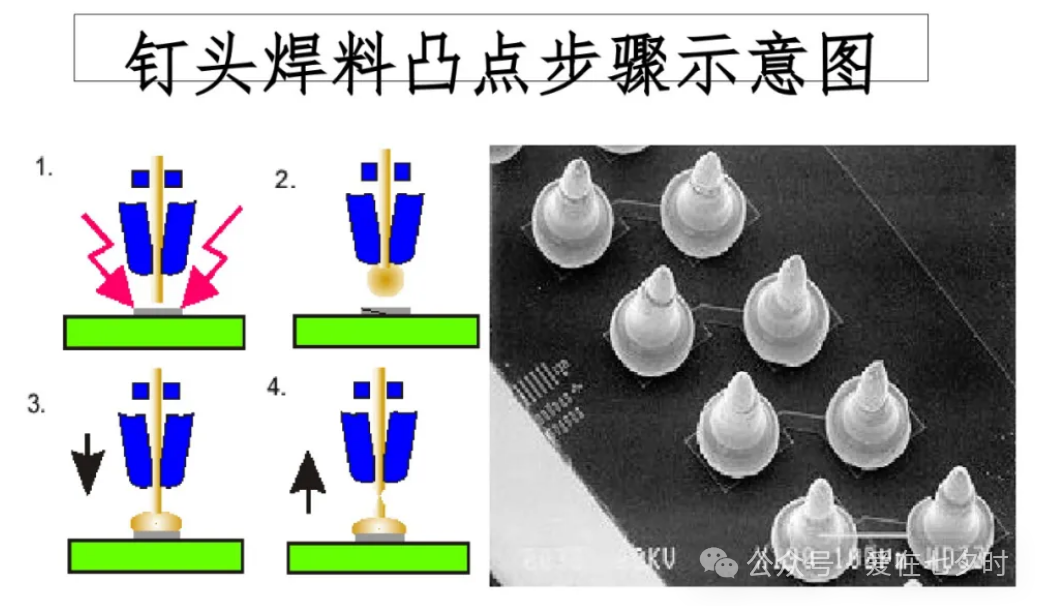 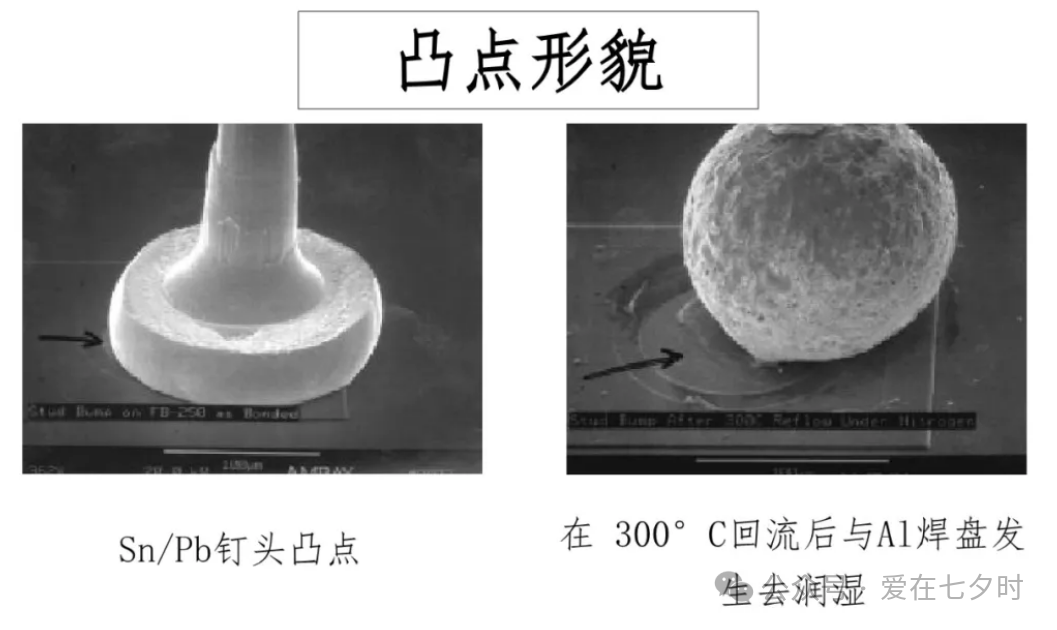 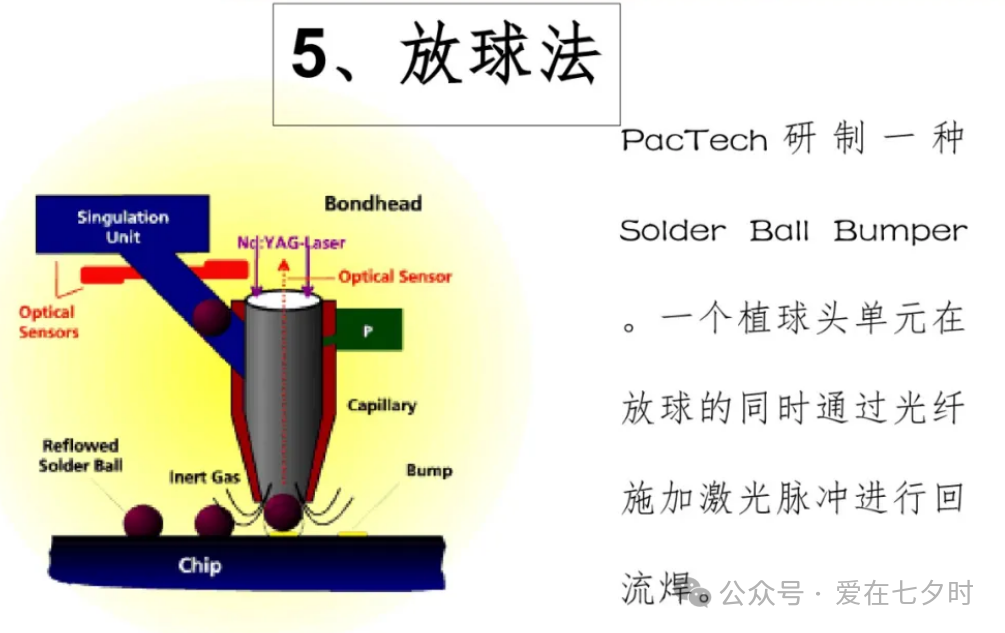                    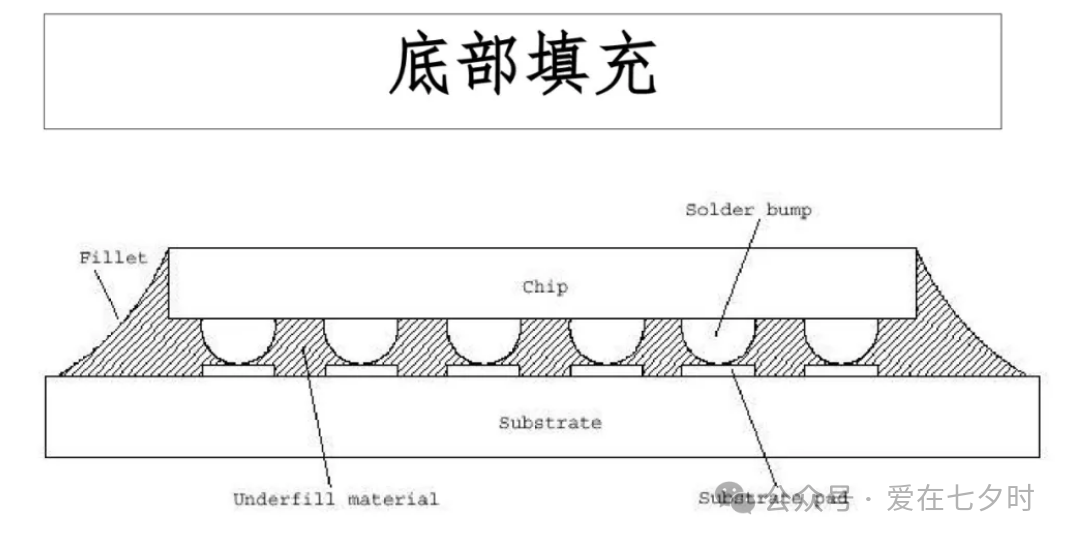      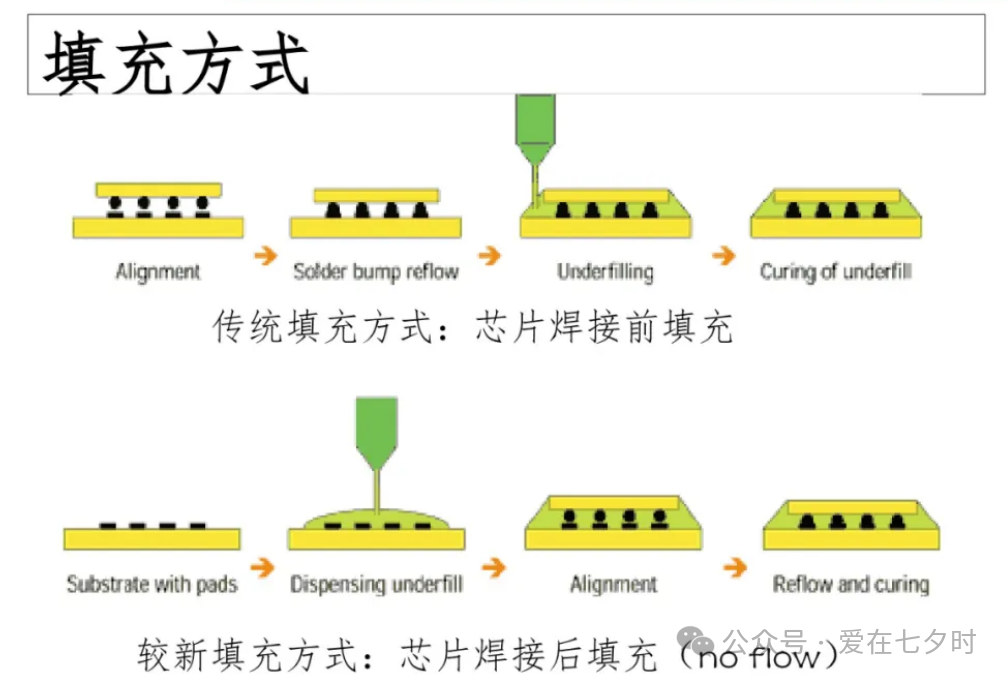  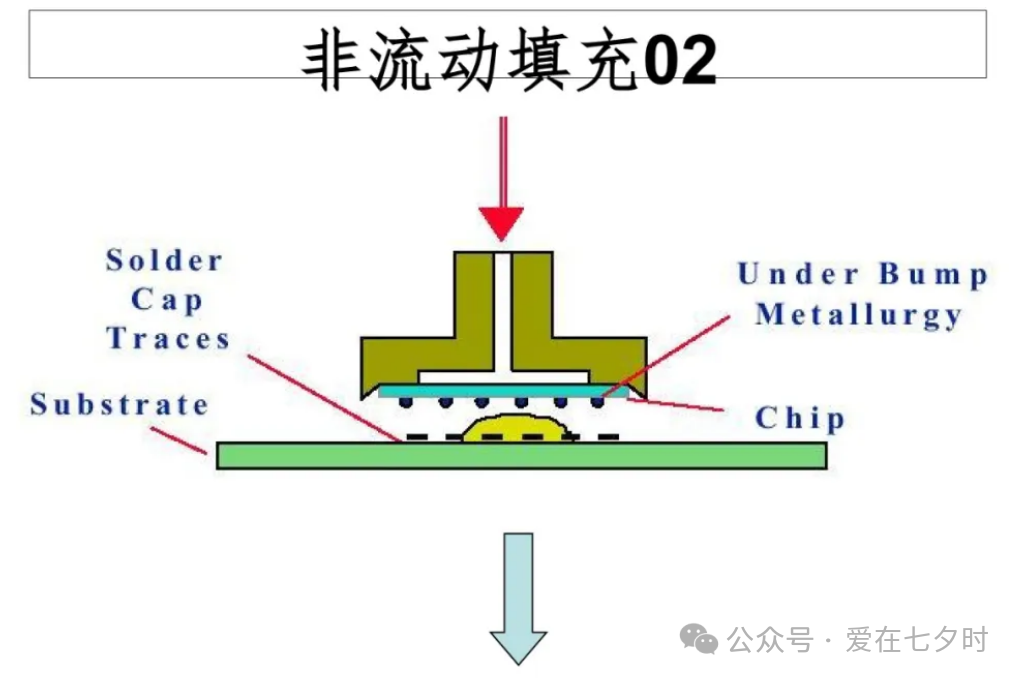 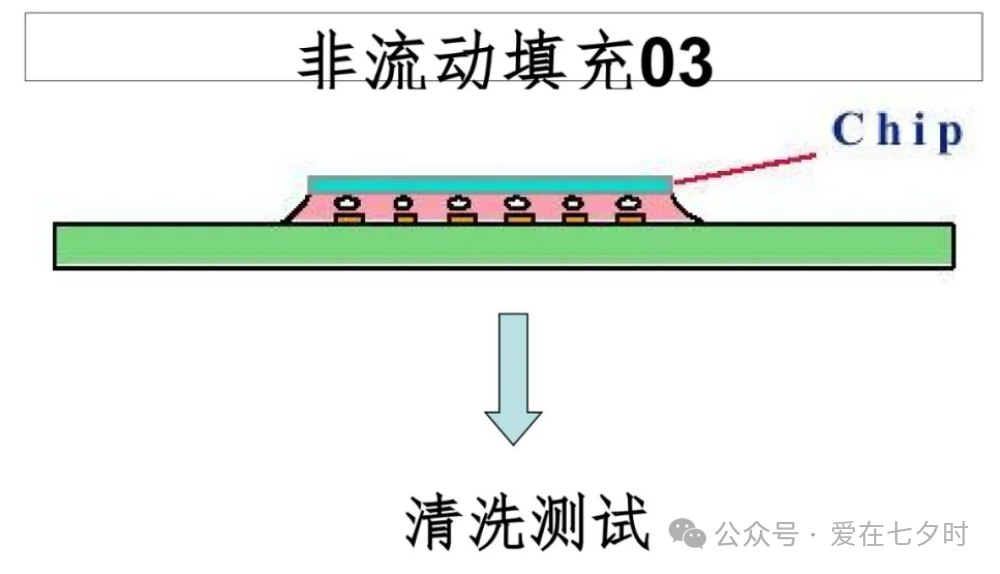          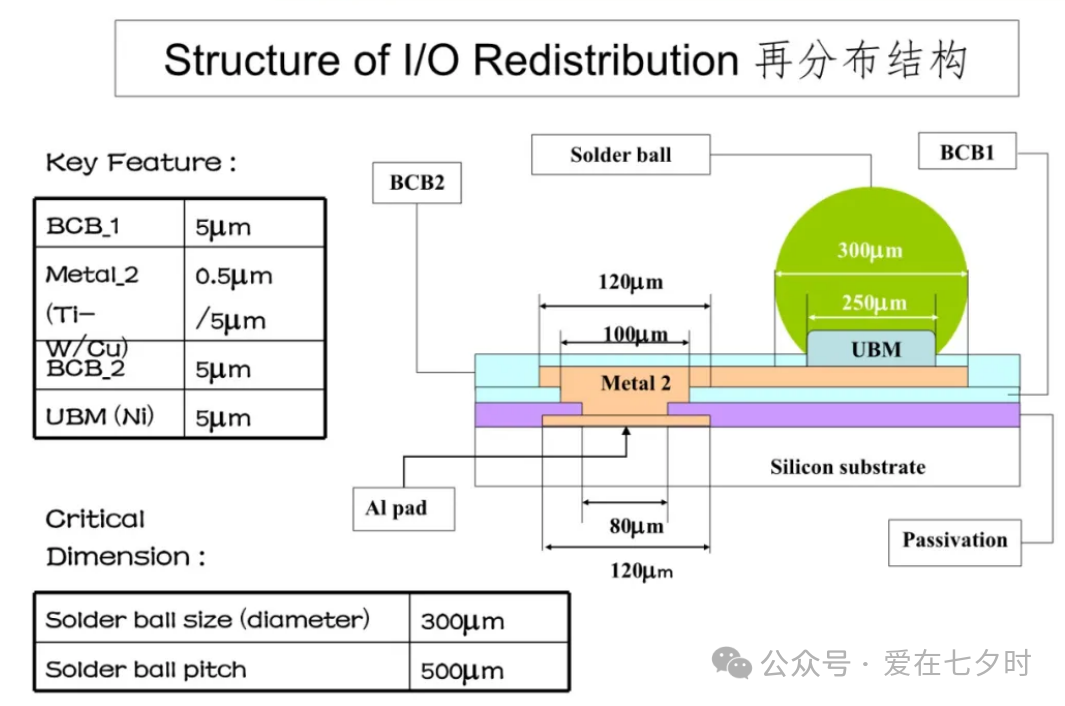   |





