
HBM 对半导体产业链的影响
1. HBM 的核心工艺在于硅通孔技术(TSV)和堆叠键合技术硅通孔:TSV(Through-Silicon Via) 是一种能让 3D 封装遵循摩尔定律演进的互连技术,芯片与芯片之间(Chip to Chip)、芯片与晶圆之间(Chip to Wafer)、晶圆与晶圆之间(Wafer to Wafer)实现完全穿孔的垂直电气连接,可像三明治一样堆叠晶片。
这些垂直连接可用于互连多个芯片、存储器、传感器和其他模块,硅通孔互连赋予了各种 2.5D/3D封装应用和架构芯片纵向维度的集成能力,以最低的能耗/性能指标提供极高的性能和功能,以打造更小更快更节能的设备。
通过更薄的硅芯片缩短互连长度和短垂直连接,有助于减少芯片的整体面积和功耗、将信号传播延迟减少几个数量级。
同时可以实现异构集成,将来自不同技术和制造商的多个芯片组合到一个封装中,从而使它们能够提供更好的功能和性能。这使其非常适合用于不同的高速应用,如数据中心、服务器、图形处理单元 (GPU)、基于人工智能 (AI) 的处理器和多种无线通信设备。
HBM 通过 SIP 和 TSV 技术将数个 DRAM 裸片像楼层一样垂直堆叠,在 DRAM 芯片打上数千个 细微的孔,并通过垂直贯通的电极连接上下芯片的技术,可显著提升数据传输速度,适用于高存储器带宽需求,成为当前 AI GPU 存储单元的理想方案和关键部件。
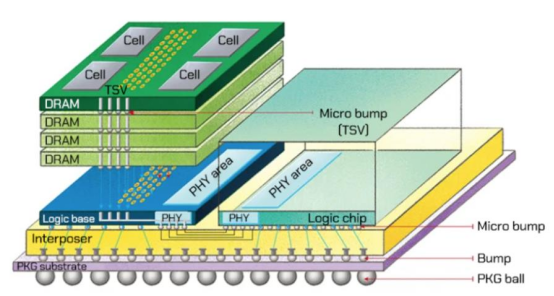
HBM 通过 TSV 技术内部连接情况

英伟达 A100 SEM 扫描图
堆叠键合技术:在 HBM 产品开发之初,HBM 主要采用“TSV+Bumping”+TCB 键合方式堆叠(TSV 一般由晶圆厂完成,封测厂可在堆叠环节进行配套)。其中,热压键合主要用于创建原子级金属键合,它利用力和热量来促进原子在晶格之间迁移,从而形成清洁、高导电性和坚固的键合。
通常,TCB 被用于垂直集成器件的 CMOS 工艺、金引线和表面之间固态键合的顺应键合(compliant bonding)、用于将芯片凸块键合到基板的倒装芯片应用以及用于连接微型组件的热压键合。随着层数变高,晶片会出现翘曲和发热等因素,但又要满足 HBM 芯片的标准厚度——720 微米(μm),这就对封装工艺提出较高要求。
三星采用TC-NCF焊接法,在DRAM之间夹上一层不导电的粘合剂薄膜 (NCF),然后进行热压,但随着堆叠层数的增加散热效率很差,TCB 不再满足需求,但 TCB 技术仍有着一定的优势,如其解决了标准倒装芯片的基板翘曲问题。同时,这种键合方式确保均匀粘合,没有间隙变化或倾斜;而且这种粘合几乎没有空隙,也没有污染。
海力士从 HBM2e 开始放弃了 TC-NCF 工艺,改用批量回流模制底部填充(MR-MUF)工艺,即芯片之间用液态环氧模塑料作为填充材料,导热率比TC-NCF中的导热率高出2倍左右,实现了更低的键合应力和更优的散热性能,这无论对于工艺速度,还是良率等都有很大影响。预计海力士 HBM3e 将采用改进的 MR-MUF 工艺,进一步降低键合应力,提升散热性能, 增加堆叠层数。
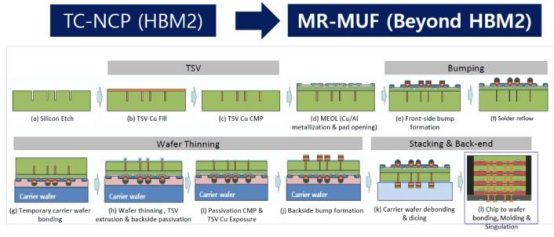
SK 海力士 MR-MUF 技术
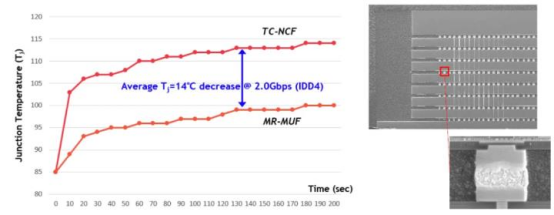
MR-MUF 比 NCF 导热率高出 2 倍左右
然而,无论是 TCB 技术还是 MR-MUF 工艺均存在着一定的局限性,难以实现更小的间距,行业内在尝试用混合键合技术。混合键合互连方案,是指在一个键合步骤中同时键合电介质(dielectric)和金属键合焊盘(metal bond pads),可以显著降低整体封装厚度,在多芯片堆叠封装中甚至可能高达数百微米。但混合键合对环境要求非常高,要达到 class1clean room(非常的清洁),这对厂商带来较大的挑战。
随着 HBM 历次迭代,HBM 中的DRAM 数量也同步提升,堆叠于 HBM2 中的 DRAM 数量为 4-8 个,HBM3/3E 则增加到8-12 个,HBM4 中堆叠的 DRAM 数量将增加到 16 个。
如 2024 年 4 月 7 日,三星电子先进封装团队高管 Dae Woo Kim 在 2024 年度韩国微电子与封装学会年会上表示,三星电子成功制造了基于混合键合技术的 16 层堆叠 HBM3 内存, 该内存样品工作正常,未来 16 层堆叠混合键合技术将用于 HBM4 内存量产。
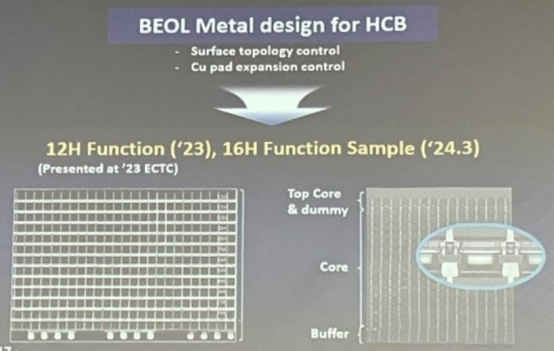
三星 HBM4 预计采用混合键合技术
2 HBM 对散热材料 EMC 提出分散性和散热性要求HBM 对 EMC 提出分散性和散热性要求,EMC和填料价值量大幅提升。环氧塑封料(EMC,Epoxy Molding Compound),是一种常见的半导体封装外壳材料,也是半导体封装中主要的包封材料,EMC 中主要组分来自填料,其中调料主要用于降低膨胀系数和内应力、提高散热性能。
HBM 独特的叠构形态使得外围用于塑封的 EMC 及内部填料也需要相应的升级,具体逻辑在于:
1) HBM 采用芯片垂直叠构的框架,使得塑封的高度显著高于传统单芯片的塑封高度,较高的高度要求外围塑封料要有充分的分散性,则 EMC 就要从传统注塑饼状变为撒粉颗粒状的颗粒状环氧塑封料(GMC,Granular Molding Compound)和液态塑封料(LMC,Liquid Molding Compound),对于 EMC 厂商,这样的升级需要在配方中同时兼顾分散性和绝缘性,配方难度较大。
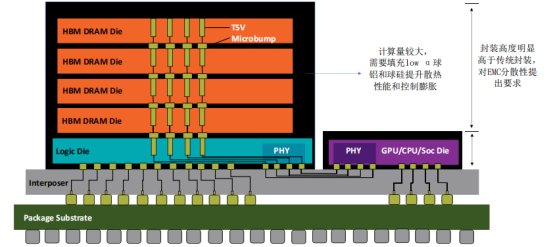
HBM 对 EMC 性能提出新要求,所用填料也需要改变
2) 由于 1 颗 HBM 中将搭载 4-8 层甚至更多层的存储芯片,单颗 HBM 中所涉及到的数据存 储和数据运输量较大,将带来发热量大的问题,散热方案的优劣将决定整颗 HBM 性能, 因此HBM的EMC中将开始大量使用low α球铝和球硅来保证快速散热和控制热膨胀问题。
当前运用 TSV 技术的场景主要在 2.5D 硅中阶层和 3D 垂直叠构,其中 3D TSV 的特点 在于通过垂直叠构的方式缩短了芯片间通信距离,相较于传统水平排布的方式,外围用于塑封的 EMC 及内部填料料也需要相应的升级。
一方面垂直叠构导致塑封的高度显著高于传统单芯片的塑封高度,较高的高度要求外围塑封料要有充分的分散性,则EMC就要从传统注塑饼状变为撒粉颗粒状的颗粒状环氧塑封料(GMC,GranularMolding Compound)和液态塑封料(LMC,Liquid Molding Compound),对于 EMC 厂商,这样的升级需要在配方中同时兼顾分散性和绝缘性,配方难度较大。

HBM 封装需要用到 GMC 和 LMC 两类偏高端的 EMC
另一方面采用 TSV 方式连接的芯片需要一起塑封,则单个塑封体中的运算量急剧上升,从而带来较大的发热问题,需要大量使用low α球铝和球硅来保证快速散热和控制热膨胀问题。
以 HBM 为例,1 颗 HBM 中将搭载4-8 颗甚至更多芯片,封装高度高且存储带宽大,需要用添加 low α球硅/球铝的GMC/LMC 来做塑封外壳。
|