在过去的40年发展历程中,集成电路的封装结构从传统的平面结构历经变化已发展到2.5D/3D甚至异构集成(Heterogeneous Integration Packaging)模式,如图1(b)。在高端电子制造领域,以硅通孔 (through silicon via,TSV)互连为基础的2.5D封装和3D封装模式是提高电子器件性能的关键技术。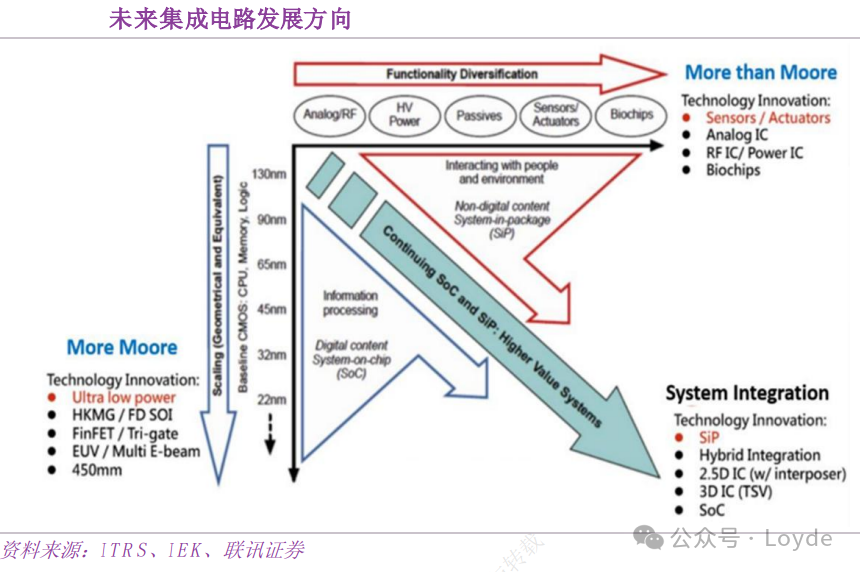 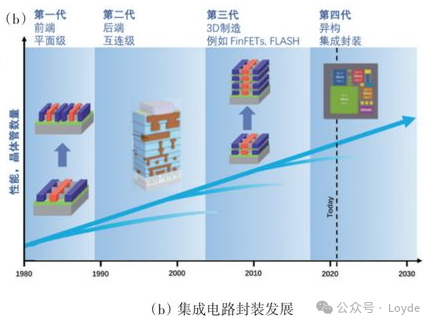 玻璃通孔(Through-Glass Via, TGV)互连技术最早 可追溯至2008年, 衍生于2.5D/3D集成TSV转接板技 术, 主要用来解决TSV转接板由于硅衬底损耗带来高 频或高速信号传输特性退化、材料成本高与工艺复杂等问题. TGV的优势主要体现在: 1)优良的高频电学特性。玻璃材料是一种绝缘体材料,介电常数只有硅材料的1/3左右,损耗因子比硅材料低2-3个数量级,使得衬底损耗和寄生效应大大减小,保证了传输信号的完整性; 2)大尺寸超薄玻璃衬底易于获取。Corning、Asahi以及SCHOTT等玻璃厂商可以提供超大尺寸(>2m × 2m)和超薄(<50µm)的面板玻璃以及超薄柔性玻璃材料。 3)低成本。受益于大尺寸超薄面板玻璃易于获取,以及不需要沉积绝缘层,玻璃转接板的制作成本大约只有硅基转接板的1/8;4)工艺流程简单。不需要在衬底表面及TGV内壁沉积绝缘层,且超薄转接板中不需要减薄; 5)机械稳定性强。即便当转接板厚度小于100µm时,翘曲依然较小; 6)应用领域广泛。除了在高频领域有良好应用前景,作为一种透明材料,还可应用于光电系统集成领域,气密性和耐腐蚀性优势使得玻璃衬底在MEMS封装领域有巨大的潜力。 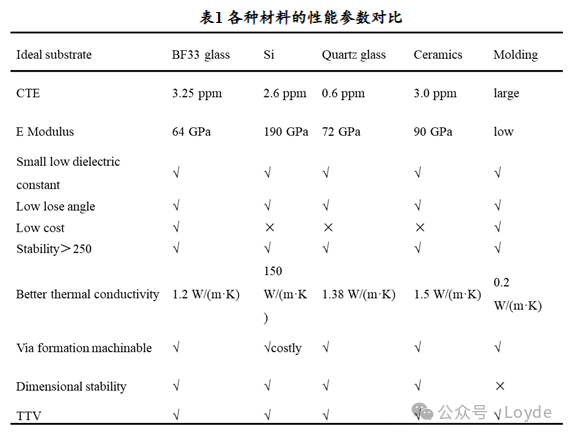 TGV 以高品质硼硅玻璃、石英玻璃为基材,通过种子层溅射、电镀填充、化学机械平坦化、RDL再布线,bump工艺引出实现3D互联。TGV是直径通常为10μm-100μm的微通孔。对于先进封装领域的各种应用,每片晶圆上通常需要应用数万个TGV通孔并对其进行金属化,以获得所需要的导电性。  因玻璃材料与硅、二氧化硅材料属性的差异, 玻璃上刻孔、TGV孔金属化方法是玻璃TGV互连技术研究关键点. 玻璃表面光滑, 对金属铜的粘附力 较低, 容易产生金属层脱落、卷曲等现象。 TGV玻璃通孔填充技术:①电镀铜金属化;②金属浆料填充法 ①类似TSV硅通孔电镀金属化方案:TSV的填充材料包括铜、钨、镍等金属或掺杂多晶硅等非金属,铜作为具有良好的导电能力、低电迁移性及低成本的金属,是目前大多数商用TSV选择的填孔材料。在芯片制造中,沉积金属的手段主要有以下几种:物理气相沉积 (physical vapor deposition,PVD)、化学还原法、置换还原法和电镀。电镀与其他工艺相比,不需要复杂的设备,可以在常温常压下进行,成本较低,在TSV金属填充中效率相对较高 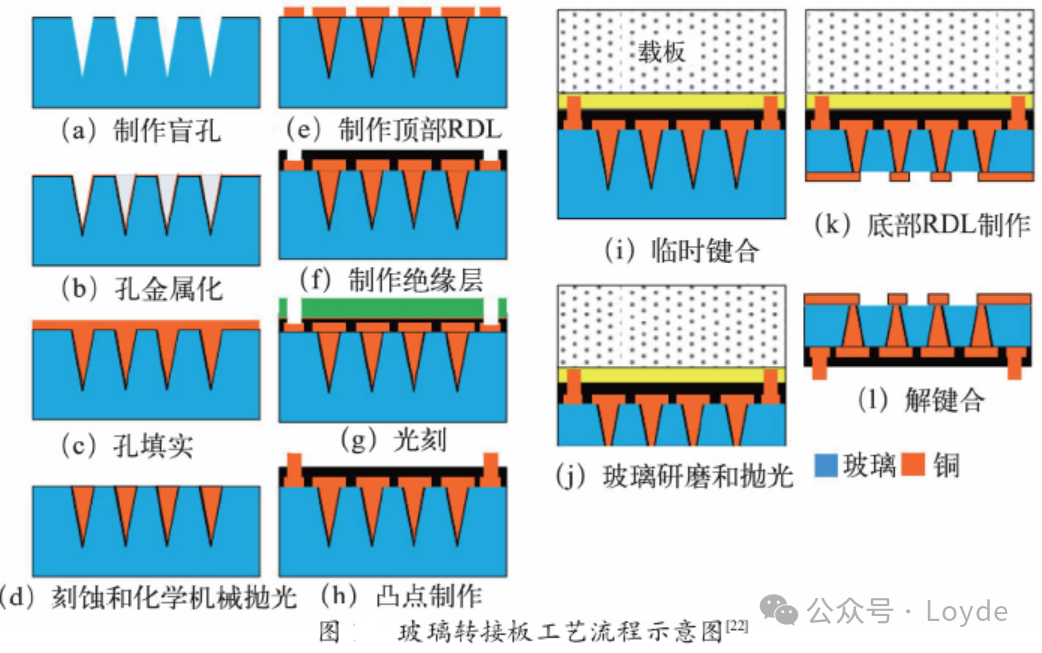 TGV通孔电镀铜部分实心填充主要有3种方法: 一种是借助TGV孔几何形貌, 如2020年, 康宁公司公开了通过电镀铜工艺 在深宽比为6:1的X型TGV通孔内侧壁上实现了铜层 保形生长,在TGV通孔1/2厚度处束腰处实现实心填充. 一种是开发新型电镀添加剂并配合电镀电流密度 调整, 如2015年和2019年, 纽约州立大学和台湾工业研究院公开的新型电镀添加剂通过调控电流改变电镀 铜过程中通孔内侧壁上的电位分布, 使得TGV通 孔1/2厚度处在电镀过程中加速生长实现铜连接, 将 TGV通孔电镀填充转变为2个盲孔电镀填充, 分别实现了6:1和12:1的高深宽比通孔金属化填充. 第三种是 先双面保形电镀加厚侧壁铜层, 之后更换镀液填实一 端孔口, 如2021年日本DNP公司公开的“桥型”TGV通孔部分实心填充工艺方案, 单个“桥型”铜TGV直流电 阻约为35 mΩ, 1000次温度循环内电阻基本保持不变. 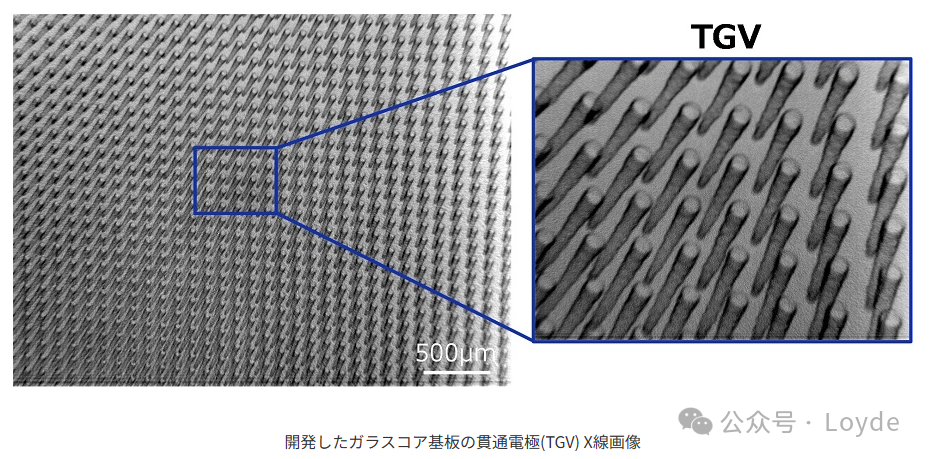 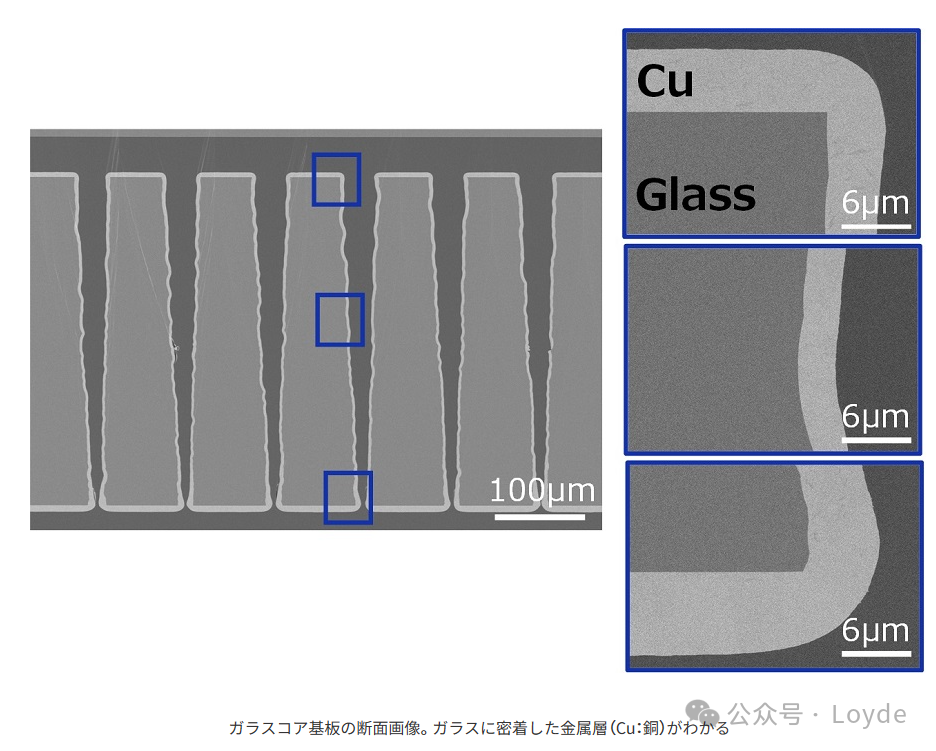 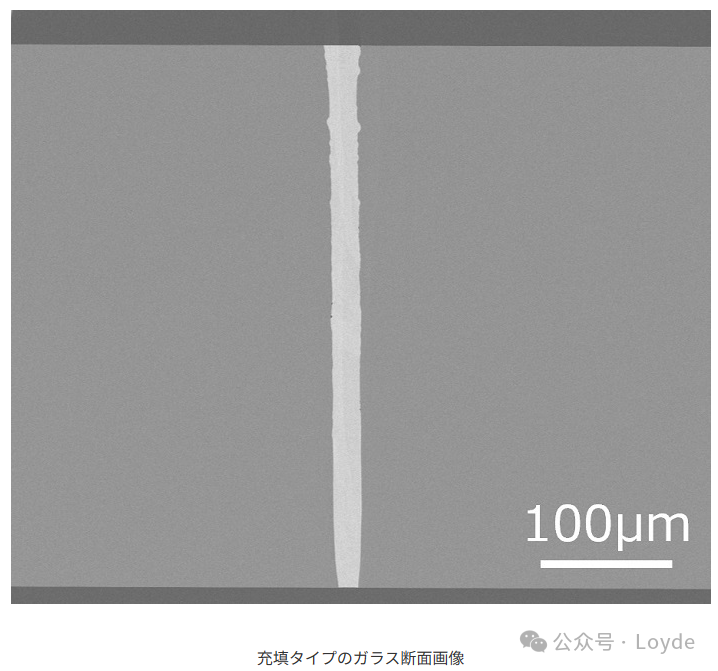 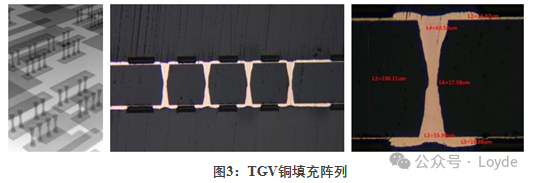  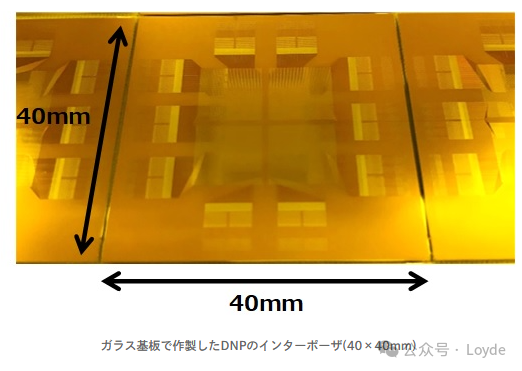 该工艺方案的关键在于“桥型”的厚度控制, 这对于其气密性有很大影响。 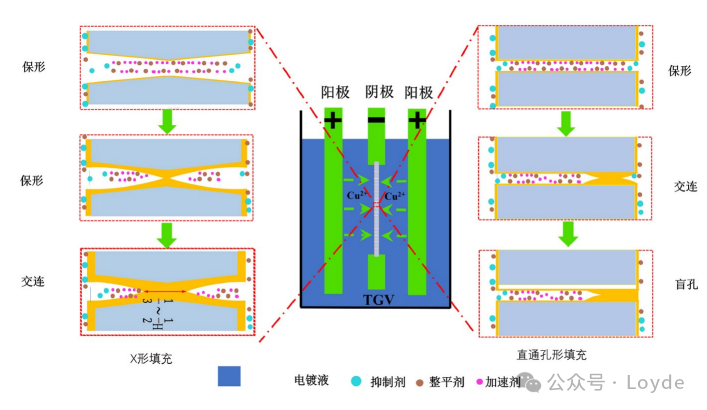 相较上述3种方法, 在TGV通 孔一端实心填充一定深度, 而在另一端保形填充, 具有 TGV通孔尺寸与互连密度高、热力学可靠性等设计 空间大, RDL层平坦化等优点, 有望是“芯粒”2.5D/3D 集成、光电共封装(Co-Packaged-Optics, CPO)等大面 积大厚度范围TGV转接板优选金属化路线.  ②高导电率/低收缩率导电金属浆料填充方案:利用金属导电浆料的优点,固化后导电通孔的热膨胀系数可调节,使其接近玻璃基材,避免因CTE不匹配造成的失效,请参考《TGV玻璃基板填孔用银浆(无溶剂型,250°C低温固化,高导电率8×10^-6 Ω.cm》的详细介绍。  电镀液体系: 电镀铜工艺历史悠久,在电镀铜填充TSV工艺中,应用最多的是硫酸铜体系与甲基磺酸铜体系。甲基磺酸铜体系可以溶解更多Cu2+,因此,当填充具有更大深宽比的TSV时,选择甲基磺酸铜体系更利于填孔。基础镀液的组成除了铜盐之外还有相应的酸,其作用主要是为了提高电镀液的导电能力以及防止铜盐水解,填孔一般采用高铜低酸体系。硫酸与甲基磺酸均属于强酸,长期使用会腐蚀设备,因此一些研究人员也在尝试使用醋酸等弱酸代替强酸加入到电镀液中。氯离子在镀液中有着不可或缺的作用,从宏观角度上看,在电镀过程中,氯离子的存在可以提高阳极活性并防止阳极产生铜粉,减少电镀过程中产生的铜颗粒;从微观角度,氯离子作为电子桥可以与其他添加剂产生协同作用,辅助TSV电镀填孔。一般镀液中,氯离子的含量约20~100mg/L。 一般在电镀时以可溶性铜板或不可溶金属板作为阳极,TSV基板作为阴极,通过施加外界电场,在阴极TSV种子层上还原电镀液中的Cu2+使Cu填满整个TSV深孔的过程即为TSV电镀金属化。在此过程中,以硫酸铜电镀液为例,Cu2+发生的还原反应:  Cu2+与镀液中的分子形成络合物吸附在阴极TSV的种子层上,在外加电场的作用下被电极表面的e-还原为铜原子沉积在孔内,随着电镀时间的延长逐渐将TSV孔内填满铜。若电镀液中没有任何添加剂存在,由于TSV整个孔底部和侧壁都有种子层的存在,以TSV孔的结构特点,尖端电学效应将导致孔口处电流密度大于孔底,并且Cu2+在孔口与孔底的扩散程度也不同,这将导致电镀过程中孔口电沉积速度远大于孔底,造成大量铜沉积堵塞孔口,TSV孔内存在缺陷或空洞的现象,这些缺陷与空洞的存在会导致电子器件的可靠性大幅降低,从而影响器件寿命,这是行业不能接受的,也是目前TSV技术的关键难点之一。 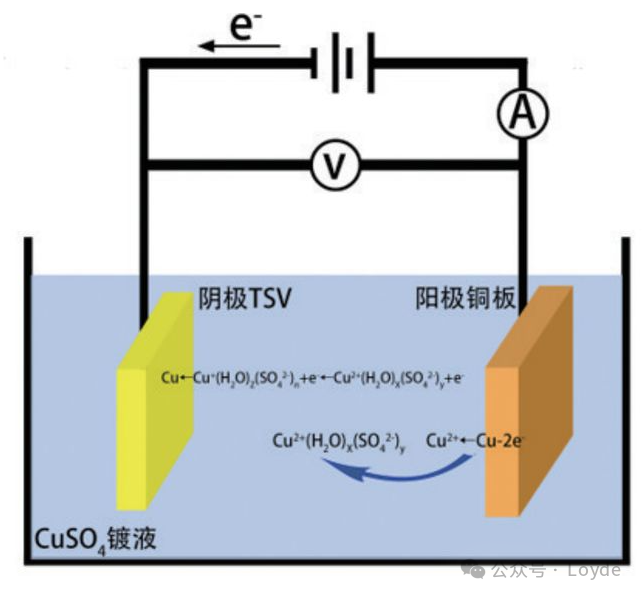 电镀液添加剂: 电镀液中添加剂的选择与配比作为TSV的核心技术是目前研究的重点问题。大部分电镀液体系中除了基础镀液外,主要的添加剂是加速剂、抑制剂以及整平剂。添加剂的存在可以改变铜的填孔方式,使TSV的无缺陷填充成为可能。目前TSV电镀添加剂供应商有乐思、陶氏杜邦、安美特等国外企业;上海新阳、深圳创智成功等国内企业也正在积极研发验证当中,目前尚未有批量应用。  加速剂(accelerator)也可以称为光亮剂或晶粒细化剂,是比较成熟的添加剂,填孔中最常见的是聚二硫二丙烷磺酸钠(bis-(3-sulfopropyl)disulfide,SPS),也有一些镀液采用3-巯基-1-丙磺酸钠(Sodium 3-mercaptopropanesulphonate,MPS)或N,N-二甲基-二硫代羰基丙烷磺酸钠(Sodium 3-[[(dimethylamino)thioxomethyl]thio]propanesulphonate,DPS) 。加速剂一般含有S原子且分子量较小,在镀液中扩散相对较快,加速铜还原决速步:Cu2+→Cu+的反应速率,能够在电镀初期吸附在孔底,降低还原电位,有去极化的作用。在酸铜电镀液中,SPS与MPS之间可以相互转化,反应如下:  抑制剂(suppressor)是控制铜沉积的关键,一般为分子量较大(>1000)的长链有机聚合物,常见的有聚乙二醇(polyethylene glycol,PEG)、聚丙烯二醇(polypropylene glycol,PPG)以及PEG-PPG共聚物等。抑制剂对填孔的影响与其分子量密切相关,其特征结构中的π键作为配体可以与Cu2+空的价电子轨道络合,一些研究认为PEG能够与铜离子和氯离子同时形成一个PEG-Cu+-Cl-络合体系,通过氯离子吸附在阴极表面形成一层阻挡层阻碍铜沉积. 整平剂(leveler)可以被看作是一类特殊的抑制剂,一般是含氮分子,在酸性镀液中带正电,吸附在阴极电流密度较高的凸起区抑制铜沉积达到整平的效果,可以被分为染料类和其他有机胺类。常见的染料类整平剂有健那绿B(Janus green,JGB)、二嗪黑(diazine black,DB)、阿尔新蓝(Alcian Blue,ABPV)、甲基橙(methyl orange,MO)、四硝基四氮唑蓝(Tetranitroblue tetrazolium chloride,TNBT)等,染料类整平剂在扩宽电流密度范围以及提高镀层光亮程度等方面的效果十分显著。 影响TGV/TSV填充效果的因素有很多,例如种子层、电镀前预处理,孔刻蚀品质及外加电场等.  常见电镀铜故障原因与排除: ①碱性镀铜   ②酸性镀铜    通孔电镀有三个主要的特征参数,第一为通孔内镀层的厚度分布,第二为镀铜的冶金结构,第三为镀铜速度。目前研究主要集中在镀层的均匀性与镀铜速度,但两者往往是相互矛盾。新型添加剂尤其是对整平剂的开发还有待提升。 针对镀层的均匀性与镀铜速度等性能要求,合作厂商开发出下记新型铜电镀液&添加剂供选择; 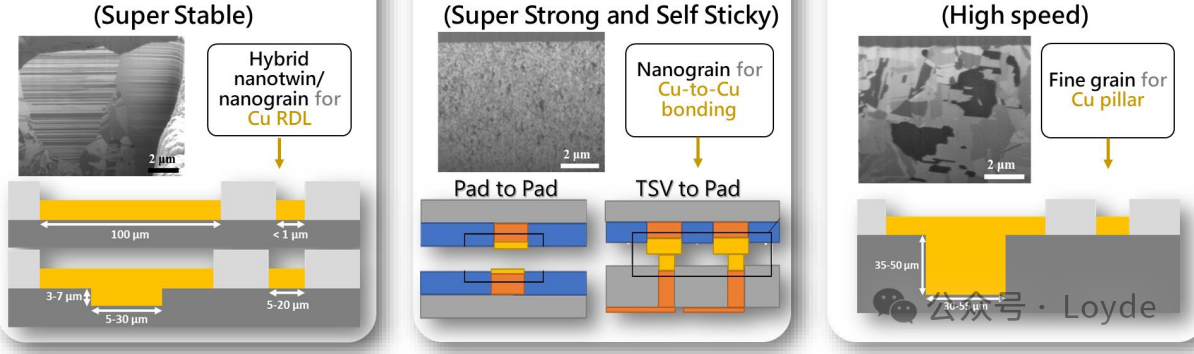 |





