封装半导体器件的热特性与三温测试随着行业趋势向更小、更快和更高功率的设备发展,热管理变得越来越重要。毕竟,如果不对热问题进行仔细权衡,则更高的器件性能可能会付出代价——温度升高和可靠性降低。随着行业趋势向更小、更快和更高功率的设备发展,热管理变得越来越重要。毕竟,如果不对热问题进行仔细权衡,则更高的器件性能可能会付出代价——温度升高和可靠性降低。 一.热阻的概念 1.描述封装器件热性能的常用方法是使用“热阻”,用希腊字母“theta”或θ表示。对于半导体器件,热阻表示在每个瓦特功率(热量)散失到芯片表面时,芯片结点温度上升的稳定状态。其单位为摄氏度/瓦(℃/W)。 2.最常见的例子是 Theta-JA(结点至环境温度)、Theta-JC(结点至外壳温度)和 Theta-JB(结点至电路板温度)。知道了参考温度(即环境温度、外壳温度或电路板温度)、功率和相关的 Theta 温值,就可以计算出结点温度。Theta-JA 通常用于使用安装在环氧树脂玻璃印刷电路板上的元件的自然对流和强制对流空气冷却系统。Theta-JC 适用于直接安装在 PCB 或散热片上的高导电率封装。θ-JB适用于已知封装邻近电路板温度的情况。 3.ψ-JB和ψ-JT实际上是热特性参数,而不是严格的热阻,因为它们描述的是器件内部结点与特定参考点(例如电路板或封装顶部)之间的温升关系,并不直接代表一个明确的两点间热流路径。这种区别对于正确理解和应用这些参数来评估电子设备的热性能非常重要。 二.常用术语 ● TJ (Die Junction Temp, °C):半导体芯片内部结温点(即实际产生热量的地方)的温度。 ● TC (Package Case Temp, °C):封装外壳的温度,通常是在靠近芯片一侧测量的。 ● TB (Board Temp Adjacent to Package, °C):紧邻封装底部的电路板表面的温度。 ● TT (Top of Package Temp at Center, °C):封装顶部中心位置的温度。 ● TA (Ambient Air Temp, °C):环境空气温度,即设备周围空气的温度。 ● θJA (Theta-JA, °C/W):从结点到环境空气的热阻,表示结点温度与环境空气温度之间的温差相对于耗散功率的比例。 ● θJC (Theta-JC, °C/W):从结点到封装外壳的热阻,表示结点温度与封装外壳温度之间的温差相对于耗散功率的比例。 ● θJB (Theta-JB, °C/W):从结点到电路板的热阻,表示结点温度与电路板温度之间的温差相对于耗散功率的比例。 ● ΨJB (Psi-JB, °C/W):结点到基板热特性参数,不同于θJB,它提供了基于特定条件下的实验数据来估算结温的方法。 ● ΨJT (Psi-JT, °C/W):结点至顶(封装顶部)热特性参数,类似于ΨJB,但它是关于封装顶部中心处温度的。 ●P(Power dissipated bydevice,Watts):设备耗散的功率,单位为瓦特(W),指的是器件工作时产生的热量。 三.热阻和热特性参数的使用方法 1.热阻θJA的使用方法 热阻θJA是从器件PN结到周围环境温度的热阻。θJA的符号还 有RthJA、RθJA、Theta-JA 。θJA如图1所示。另外,如式(1)所示,结温度和周围环境温度的温差除以功率损耗(热流量)。 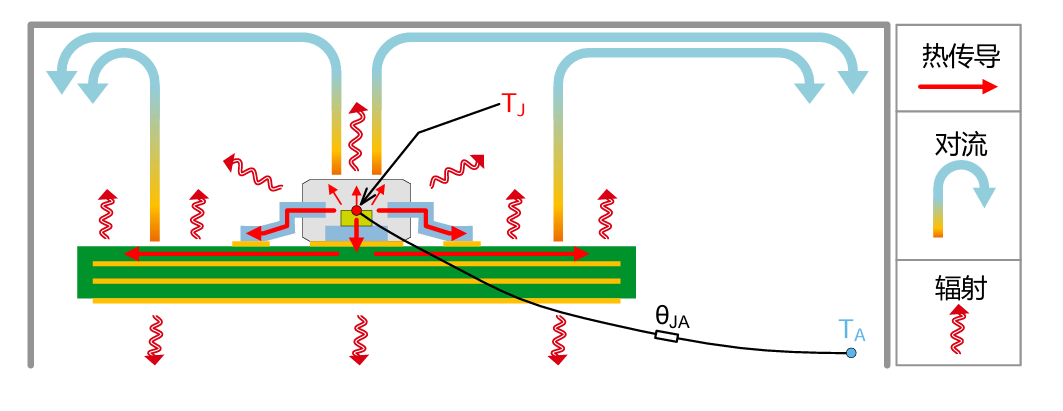 图 1 : θJA的定义 数据表中记载θJA是在 JEDEC 标准 JESD51-2A 中定义的环境中测量的值。用于比较在相同环境下测量的其他产品的散热性能。 在特定的应用下、环境与 JEDEC 不同, θJA的值也不一样。因此,在特定应用下不能使用数据表中记载的θJA、将式(1)变形为 TJ 的式子来推定结温度。  No.1.θJA的使用案例 案例A 在不同的产品之间比较θJA,选择散热性能好(θJA低)的产品来使用。 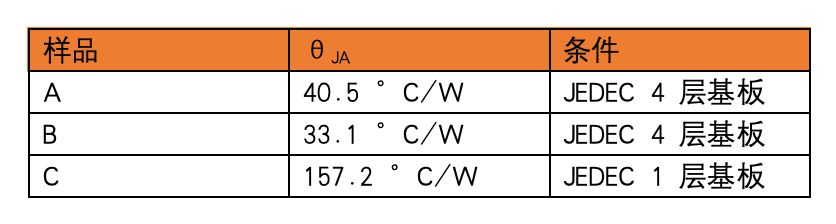 在这个例子中,产品A和B的基板条件相同,所以可以进行 比较,但是产品C的条件不同,所以不能进行比较。需要得 到相同条件的数据。 案例B 预先通过现有 应用已判断结温度时,在不同的产品间比较θJA,确定结温度相对变化多少度。即使JEDEC下的θJA和现有应 用下的θJA不同,是相对比较,也作为依据处理, 如式(2)所示。  在使用产品A的当前应用中,结温度为155℃。推测变更为产品B的结温度会达到多少。功率损耗计算为2W。 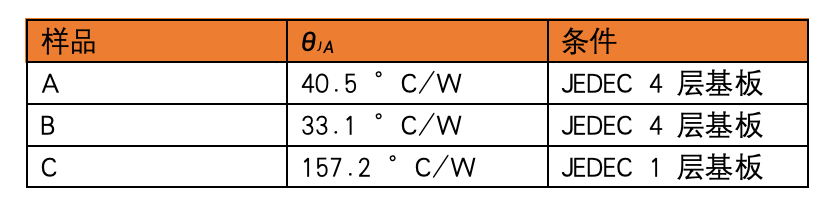  案例C TO 封装等通孔部件由于对PCB散热的影响小,所以IC单体 θJA 记载在数据表中。如果应用中不使用散热器,可以使用公式(3)估计结温度。应用下的环境温度,需要考虑包含由于自 身发热和其他零件发热导致环境温度上升部分的状态。  IC单体的θJA为70°C/W、功率损耗为1W、壳体内周围环境 温度的最大值为65°C时,可按以下公式进行推测:  案例D θJA的使用方法项中,虽然写了不能使用数据表中记载 的θJA、将式(1)变形为TJ 的式子来推定结温度。在电路设计 阶段估计结温时,理解根据PCB的不同θJA变化的基础上可以使用。SMD(Surface Mount Device)使用此方法进行粗略估计。 TJ的推定使用式(3), θJA 使用哪个值变得重要了。θJA使用数据表中记载的值,如果比起将来完成的PCB 的θJA,数据表的θJA低的情况下余量为负了,结温度超过绝对最大额定值的可能性变大。 为了防止这种情况,使用热阻比设计的PCB还高的条件下的 θJA。例如,如果设计的PCB为4层,则使用数据表中记载 的1层PCB的θJA的方法。  图2 : HTSOP-J8 封装的θJA 因为1层和4层PCB的铜箔面积有很大的不同θJA也有很大的差别(图3)。如果余量取得过大,结温明显超过时,则可取得铜箔面积可变时的θJA,选择合适余量的θJA(图4)。 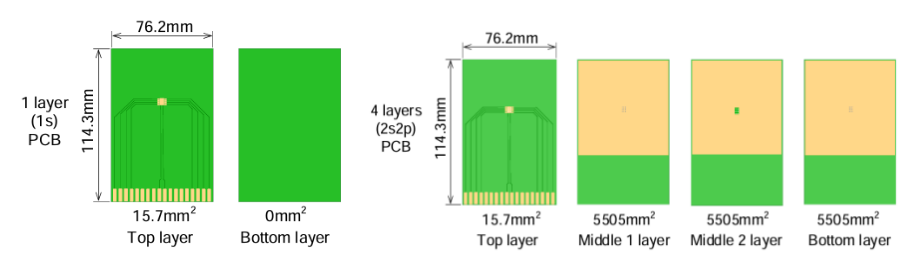 图3 : 1 层和 4 层PCB的铜箔面积差异 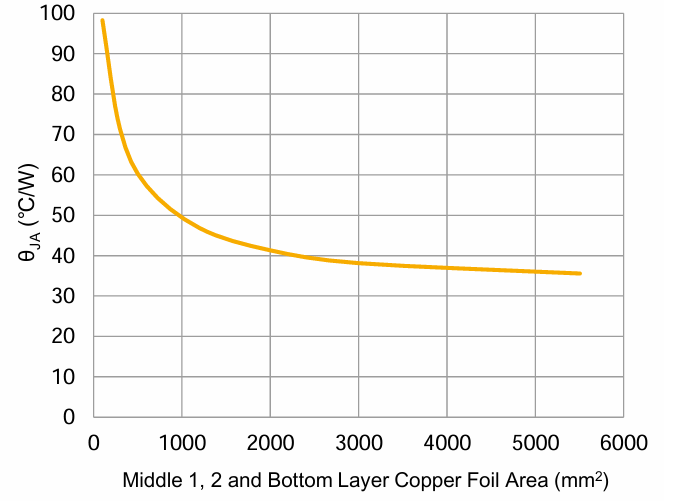 图4 : 改变铜箔面积时θJA的变化 2.热阻θJC的使用方法 热阻θJC 是从器件PN 结到壳体表面的热阻。θJC的符号还有 RthJC、RθJC、Theta-JC 。数据表中记载θJC测量采用JEDEC标 准JESD51-14 中定义的Transient Dual Interface(TDI)测试方法。θJC用图表示如图5,θJC的测量环境是将封装表面与散热器接触,并对其他表面进行绝热测量,因此设想在非常好的冷却环境下使用,结产生的热量全部移动。因此,可 以用于使用散热器的功率半导体应用的热设计。壳体的表面温度TC是封装和TIM(Thermal Interface Material)界面的温度,不存在物理测量点。因此,不能用热电偶测定TC,使用式 (4)推定结温度。  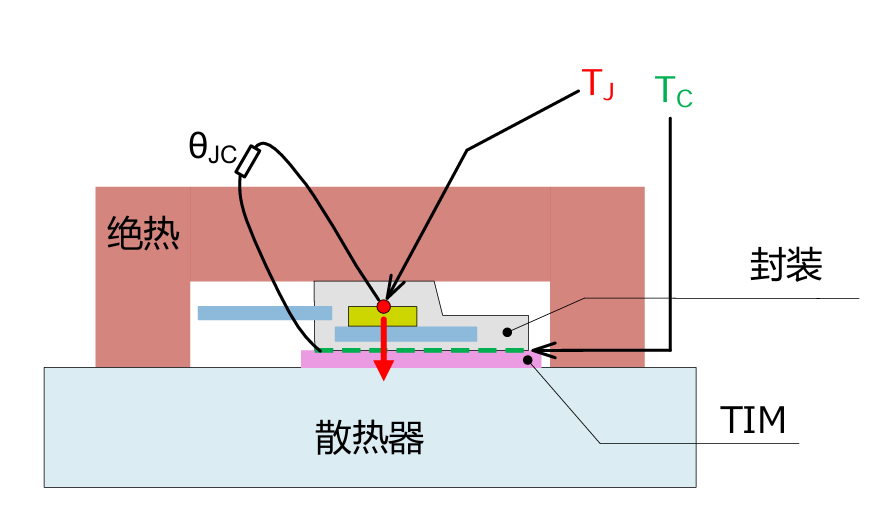 图5 : θJC的定义TC是封装和TIM界面的温度 No.1.θJc的使用案例 案例A 预先通过现有应用已判断结温度时,在不同的产品间比较θJC,确定结温度相对变化多少度。即使JEDEC下的θJC和特定的应用(实机)下θJC不同,是相对比较,也作为依据处理。  在使用产品A的当前应用中,结温度为150℃。推测变更为 产品B的话结温度会达到多少。功率损耗计算为5W。   案例B 使用散热器进行热设计时。结温如式(6)所示,从结到环境 温度的热阻乘以设备的功率损耗,再加上环境温度求出。对于从结到周围环境温度的热阻,如图6所示,从结到壳 体的热阻θJC、包含TIM的壳体到散热器的接触热阻θCH、从散 热器到环境温度的热阻θHA。应用下的环境温度,需要考虑包 含由于自身发热和其他零件发热导致环境温度上升的部分的状态。  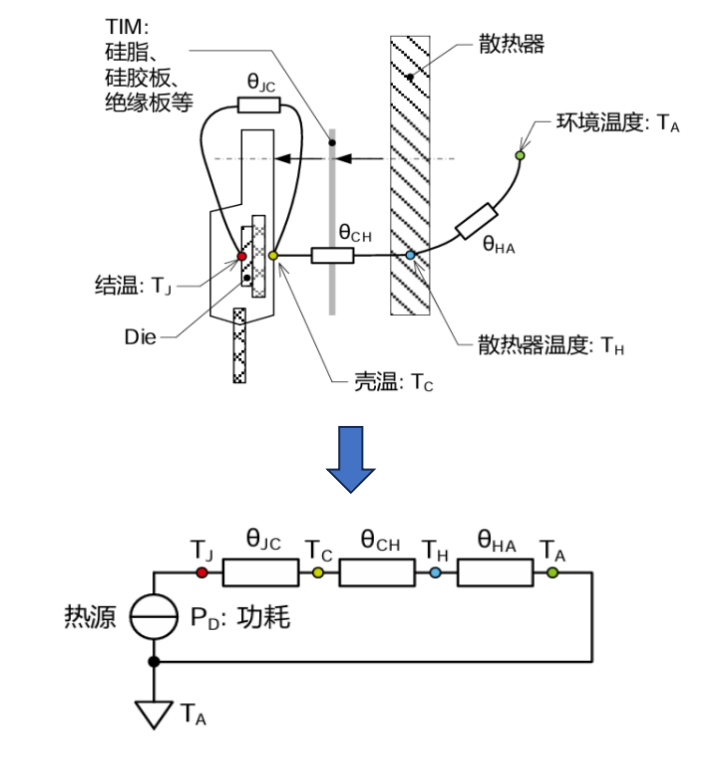 图6 : 从热源到周围环境散热等效电路 作为一个例子,计算TO-220FM封装的TJ 。θJC为2.6°C/W、 θCH从TIM的数据表读取热导率,用式(7)换算为热阻。θHA假定使用10.9℃/W的散热器。PD为3.5W,框体内环境温度最 大值为60℃时计算。 首先用公式(7)将TIM的热导率换算成热阻。 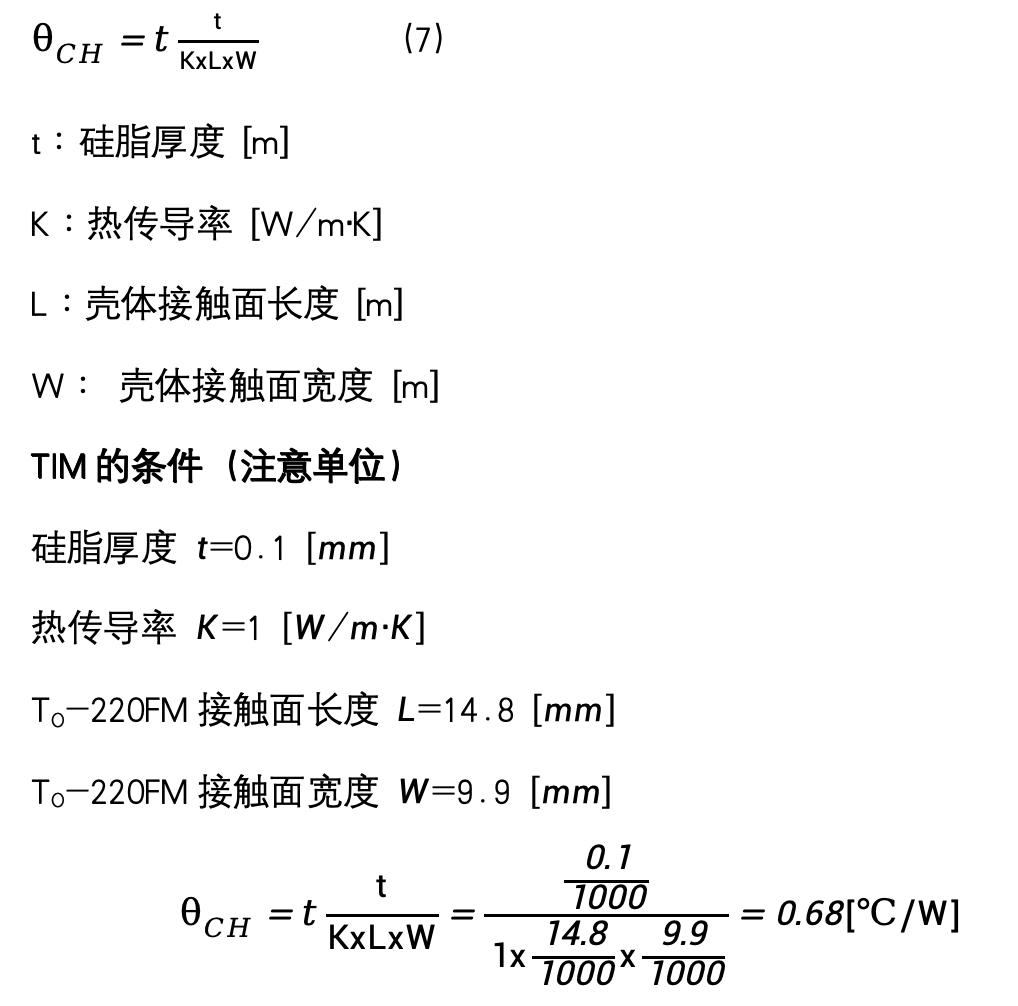 然后将各参数代入式(6)中计算TJ  3.热特性参数ΨJT的使用方法 热特性参数ΨJT表示从器件的 PN 结到封装外表面的上部中央 的温度差除以施加给零件的功率而得到的值。ΨJT的符号还使用了Psi-JT。ΨJT如图所示为图7。另外,用式表示,如 (8)所示,结度 TJ和封装上面中心温度TT的温度差除以功率损耗。 数据表中记载ΨJT是在JEDEC 标准JESD51-2A 中定义的环境 中测量的值。通过在特定的应用下测量设备的封装温度,如果 在同样的条件下测量温度特性参数,则可以估计结温。图7表示散热路径,但SMD会向PCB释放大部分热量, 因此通过结和封装顶部之间的热量流动非常小。因此,TJ 和TT 间温度差变得非常小,ΨJT的值也变小。ΨJT值越小,即使JEDEC 环境与特定应用环境之间存在差异,估计结温的误差也越小。电路设计时使用θJA或θJC理论计算出结温后,在试制完成PCB 时建议使用ΨJT实施确认。 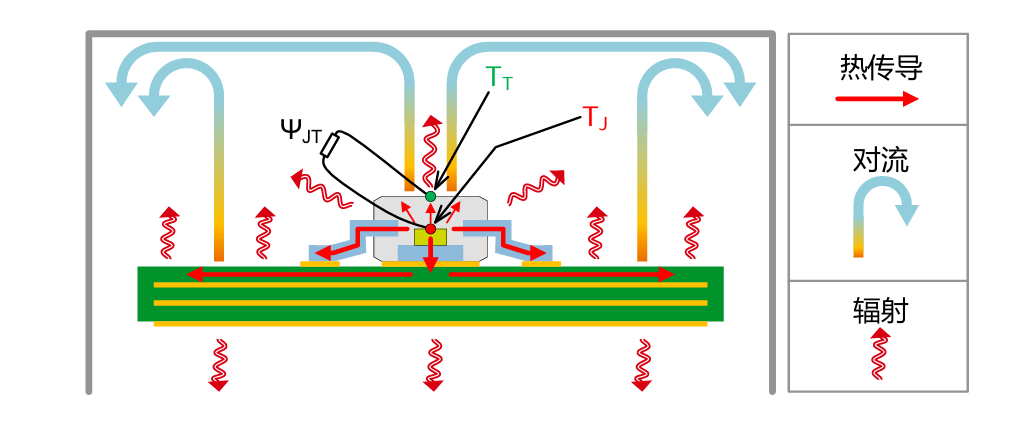 图7 : ΨJT的定义  No.1.ΨJT的使用案例 测定封装上面温度,使用记载在数据表中ΨJT估计结温。结温用下式求得。  准备计算所需的各个参数 1. ΨJT 记载在数据表或热阻应用笔记上,从中选择最接近实际 设备的PCB 条件值。在需要更准确地求出结温度时,请在实机PCB中测量ΨJT。 2. PD是该设备运行时的功率损耗。通过实测或计算求得。 3. TT 是将热电偶用导热性环氧粘合剂固定在封装的上面中央进 行测定。 JEDEC标准的JESD51中进行了定义。下表中汇总了每种概念的定义、用途及计算公式。  四.三温测试 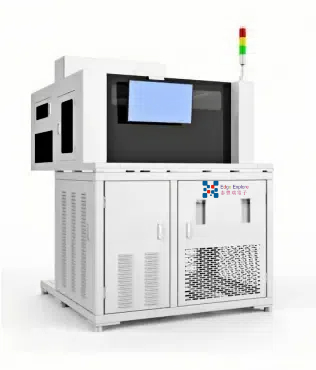  三温分选机是一种用于在不同温度条件下对电子元件进行性能测试和筛选的设备。这种设备能够在常温、高温以及低温条件下对芯片或其他电子组件进行测试,以确保它们在各种工作环境下的稳定性和可靠性。如结温(TJ, Die Junction Temp)是半导体器件内部实际产生热量的地方的温度,对于评估器件的工作状态至关重要。 在三温分选机中进行结温测试时,通常涉及以下几个方面: 温度控制 三温分选机具备精确的温度控制能力,可以模拟从极低到极高的温度范围,如-70°C至+175°C。这使得能够对芯片在极端环境下的表现进行测试。 测试过程 在测试过程中,待测芯片会被放置在测试区,并通过探针与测试电路连接。机器会根据设定的温度曲线自动调整温度,同时监控芯片的电性能参数,包括但不限于功耗、电流、电压等。 结温计算 结温可以通过已知的功率耗散(P)和热阻(θJA, θJC, θJB, ΨJB, ΨJT等)来估算。例如,使用公式 TJ = TC + (θJC * P) 或 TJ = TB + (θJB * P) 来计算结温,这里TC或TB代表的是测量得到的封装外壳温度或电路板温度,P是功率耗散。 自动化与智能化 现代三温分选机通常配备有先进的自动化和智能控制系统,可以实现测试过程的自动化,减少人工干预,提高测试效率和准确性。 总之,三温分选机在电子制造业中扮演着重要角色,尤其是在车规级芯片和其他需要在极端环境下保持高性能和可靠性的应用领域。通过这些设备进行的结温测试有助于确保产品质量,提升整体生产效率。 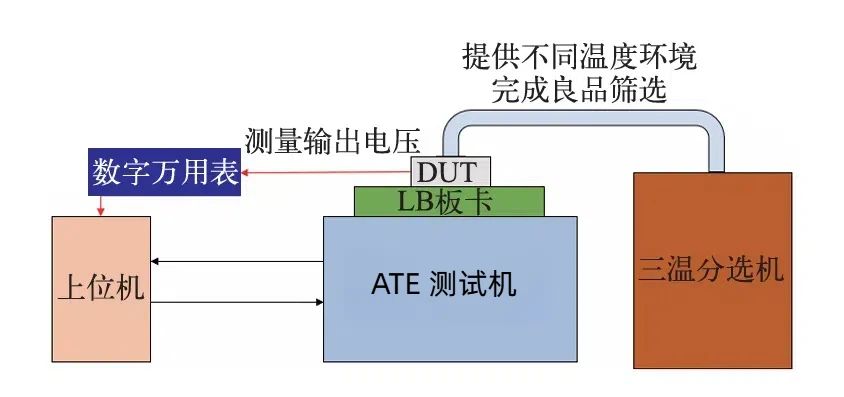 图8 测试分选示意图 五.三温分选机UPH统计 1 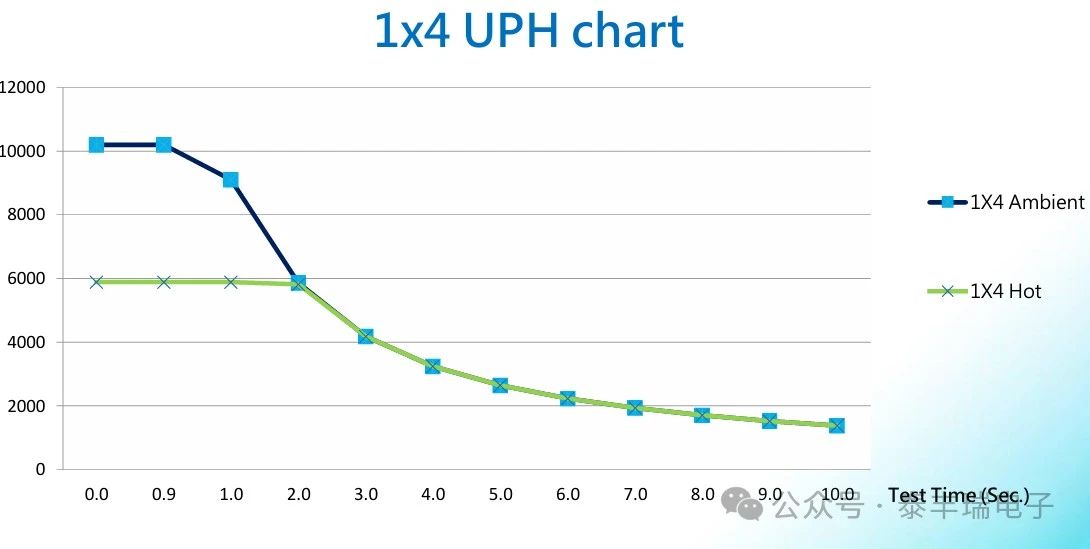  2 3  |





