|
开路故障(Open) 开路缺陷是制造工艺不当造成的,物理缺陷中大约40%属于开路缺陷。典型的开路缺陷包括线条断开、线条变细、阻性开路和渐变开路等。如下面图(8)所示:  图(8) 图(8)图中(a)和(b)是电路存在开路的情形,(c)则是造成同时开路和短路缺陷的情形。 开路缺陷的形式取决于缺陷的位置及大小。例如,对于栅极开路(一般称为浮栅,floating gate)这种缺陷,在缺陷面积小的情况下,隧道电流仍可流动,但信号的上升和下降时间增加;在缺陷面积大的情况下,输入信号就在栅极形成耦合,形成的浮栅就获得偏压,此电压可能导致晶体管导通,因此开路故障是否可检测,取决于缺陷的面积和位置。 开路缺陷不一定都可以用Stuck At的模式检测到,如下面图(9)所示: 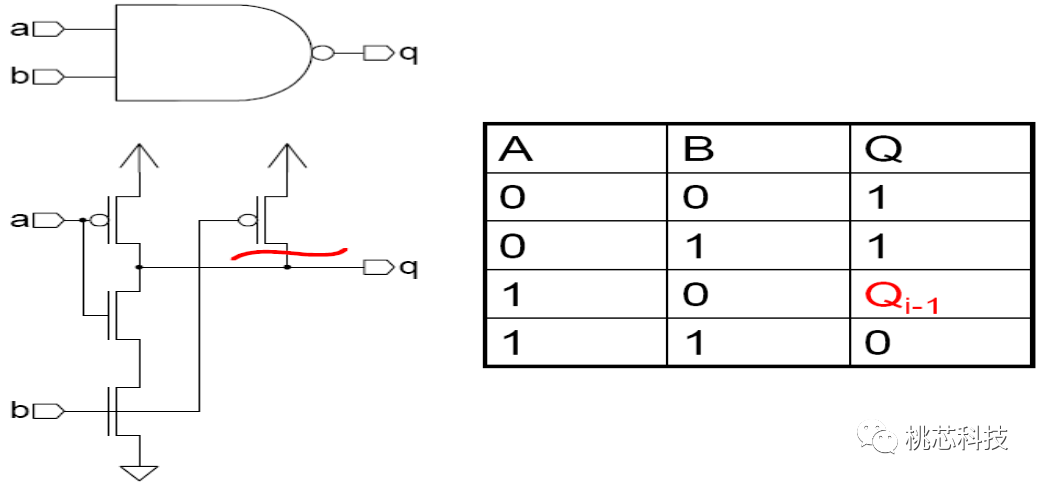 图(9) 图(9)上图中,红线部分表示那个mos管的drain与输出开路了,当顺序输入ab为00、01、10、11,从01变换为10的时候,输出Q保持了上面一个状态1,看起来还是正常的,这种情况下,就没有检测出来这个fault。但是如果调整一下输入的向量的顺序为00、01、11、10,就可以发现这个fault。 通过IDD的测试方法,也可以测试出一些open缺陷,如下面的图(10)所示  图(10) 图(10)上面红色表示open的缺陷,当输入ABCD为1111时,输出O为0,当输出转为0001时候,在x、y和o之间出现了充放电,会有大电流出现。 延迟缺陷(delay faults) 在一些高速芯片应用中,延迟缺陷特别重要,这种缺陷有很多原因,比如小面积的open导致某段线路的阻值偏大。如下面图(11)所示: 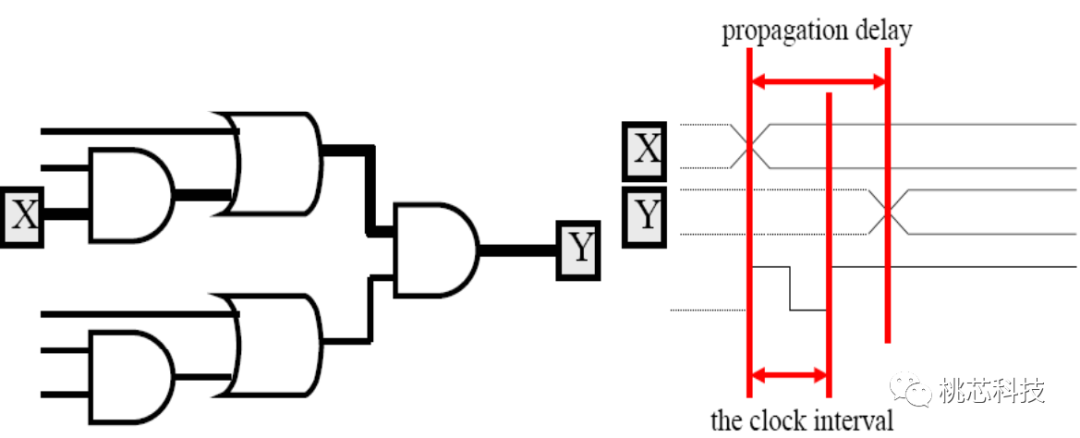 图(11) 图(11)这个path的delay已经超过了一个clock的间隙,通过stuck At的测试方式,可以检测到这个缺陷。但是有的时候,延迟没有超过clock的间隙,就会造成潜在的失效,在某些情况下,比如硬件变化、外界温度变化等,延迟超过clock的间隙,导致缺陷。这种延迟缺陷,可以通过AC测试的方法进行补充,比如测试上升沿的时间、下降沿的时间等等。 2、 Pattern向量测试及IDDQ测试方法 上面给大家介绍了一下各种失效模式及测试原理。通过Pattern向量测试,加以电流测试为补充,可以有效地测试各种faults。 Pattern向量测试的方法 设计人员对某种fault模型进行仿真,给出波形向量,通常是VCD格式或者WGL格式,测试人员需要结合时序、电平和逻辑,进行编程,来对芯片输入向量,以检测输出。如下面图(12)表示的就是测试机force给芯片的一段波形。  图(12) 图(12)而芯片在接受到这段输入的波形后,运行特定的逻辑,输出波形如下面图(13),测试机需要在指定的strobe window进行比较输出的与预期的逻辑值的情况,以此来判断DUT是否逻辑功能正常。  图(13) 图(13)下面图(14)是一个AND gate的逻辑测试的例子,实际的输出会有波动,如图中的紫色的波形,在Edge Strobing地方(pattern的timing设定的)采样到此时的输出为High的状态,表明此AND Gate的逻辑功能是正常。 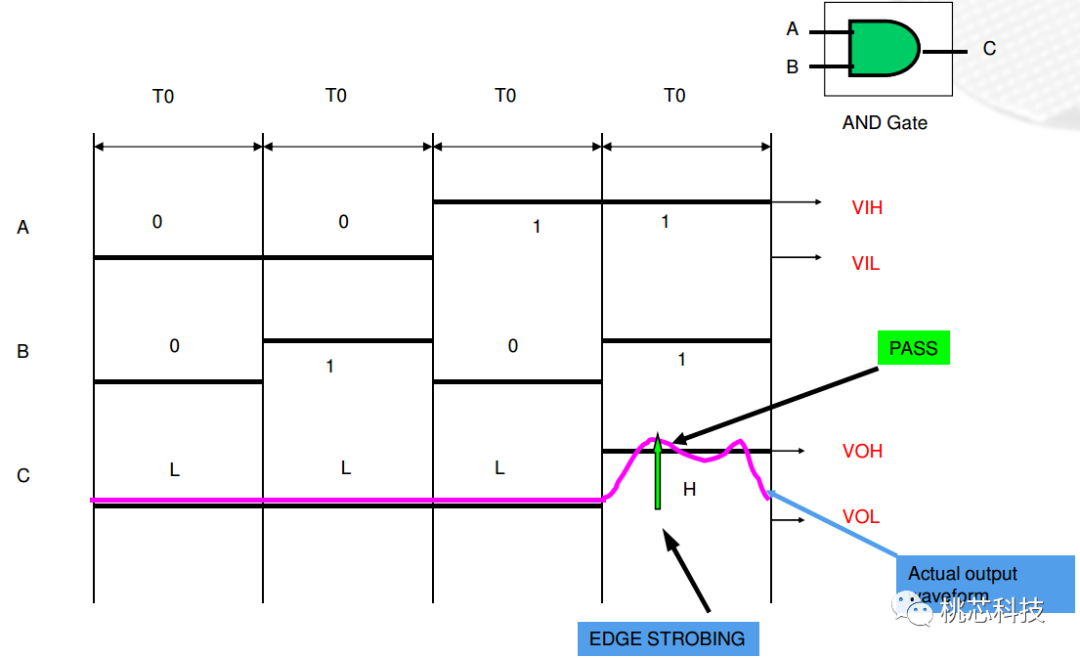 图(14) 图(14)IDDQ测试的方法: CMOS电路具有低功耗的优点,静态条件下由泄露电流引起的功耗可以忽略,仅仅在转换期间电路从电源消耗较大的电流。Q代表静态(quiescent),则IDDQ表示MOS电流静态时从电源获取的电流。 IDDQ测试是源于物理缺陷的测试,也是可靠性测试的一部分,其有着测试成本低和能从根本上找出电路的问题(缺陷)所在的特点。即若在电压测试生成中加入少量的IDDQ测试图形,就可以大幅度提高电压测试的覆盖率。即使电路功能正常,IDDQ测试仍可以检测出桥接、短路、栅氧短路等物理缺陷。 测试方法如下面图(15)所示 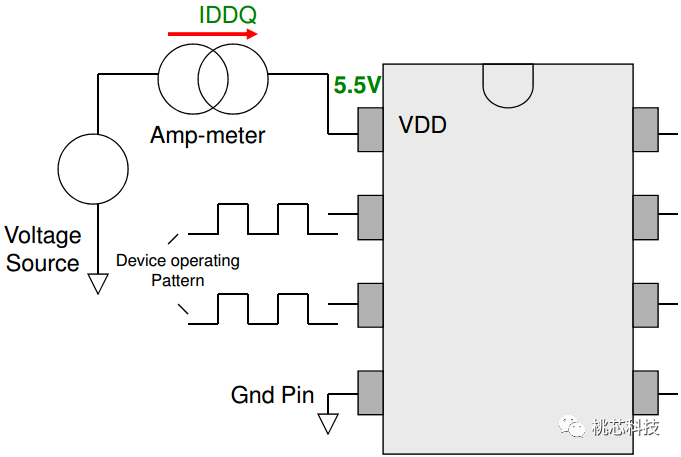 图(15) 图(15)Step1: 给VDD上最高电压,并且tester的电压源设定一个钳制电流,防止电流过大损测试机。Step2: run一个特定condition的pattern,去toggle尽量多的晶体管on。等待 5~10ms。Step3: 量测流过VDD上的电流。Step4: run另外一个特定condition的pattern,去toggle尽量多的晶体管off。等待5~10ms。Step5: 量测流过VDD上的电流。Step6: 重复上述的step2到step5的步骤大概5~10次,取读出的平均值。跟datasheet中的规范进行比较。 各种测试的测试覆盖率的大概情况如下面图(16)所示:  图(16) 图(16)如上图所示,hardware直接量测是最直接的方法,但是这种方法可以测试的电路有限,很多内部电路无法通过这种方法完成。 而Stuck At测试和IDDQ测试的组合,可以有效的在时间和成本经济的情况下提高测试覆盖率。 |





