1.芯片故障分析流程:01.接收故障件并收集相关失效信息。 02.Level-1: 非破坏性实验,如目检,X-ray等。 03.Level-2:电气故障分析,尝试复现失效模式。如Open/Short,Decap,EMMI/InGaAs,OBIRCH,NanoProbing等。如果故障无法复现,则需要reliability test,如高温高湿,burn-in等。 04.Level-3:物理故障分析,如Delayer,SEM,FIB,Cross-Section等。 05.Level-4:材料分析,SIMS,TEM等。 06.出具分析报告  2.失效分析之非破坏性分析——荧光显微 荧光渗透实验主要是针对小型的样品,例如芯片级封装,从红墨水实验衍伸出来的分析方法,因为红墨水实验只能针对较大的组件,观察组件焊接的状况,但是当样品较小时,红墨水的渗透在显微镜下会越来越难分辨,而荧光剂即使是很少量的渗透,在 UV 灯的照射之下也会发出不同于背景的明显光源,因此可将红墨水替换成荧光剂,藉此观察样品焊接接合的缝隙。 机台种类:  分析应用: 荧光检测是利用荧光剂在真空状态下对样品进行渗透, 运用紫外光观察样品的荧光反应。 1. 封装异常 封装Paddle似异常,用UV-OM观察荧光渗漏处。
2. LED 荧光粉观察 LED 荧光分布观察,观察不同荧光粒子的组成及多寡。 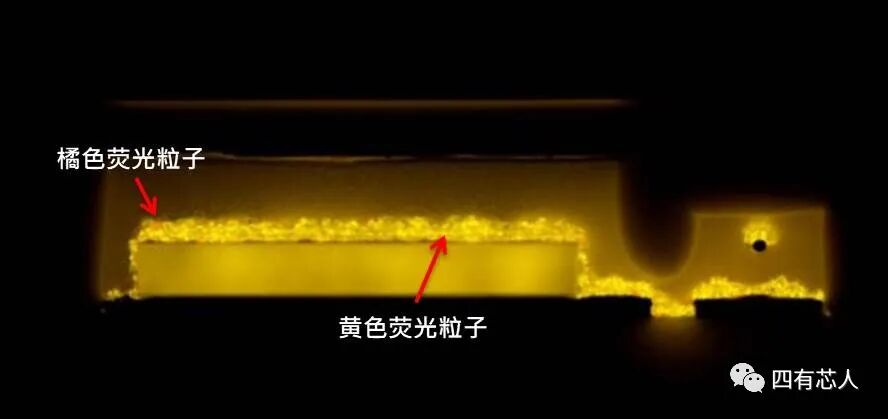 3.失效分析之非破坏性分析——3D OM 3D OM (3D Optical Microscope)原理是藉由一般可见光对物体表面之反射特性,透过光学的透镜放大、缩小及CCD来撷取影像,可进行表面形貌的观察与尺寸的分析量测。 3D OM (3D Optical microscope)具有高景深、大景深、倾斜角度检测优势和先进的量测功能,可针对各种不同高度的待测物体,进行多角度的全面对焦,并获得清晰的影像进行观察。适合进行元器件焊接检验与失效分析。 机台种类:  分析应用: · 自动撷取3D影像(X,Y,Z) · 即时3D轮廓和尺寸测量 · 多角度即时影像 · 50~5000倍HDR(High Dynamic Range)半导体用高解析度影像 · 可应用于所有种类材料分析(Microelectronics/PCBA/Semiconductor等) · IC Die Size、封装外观及各种尺寸量 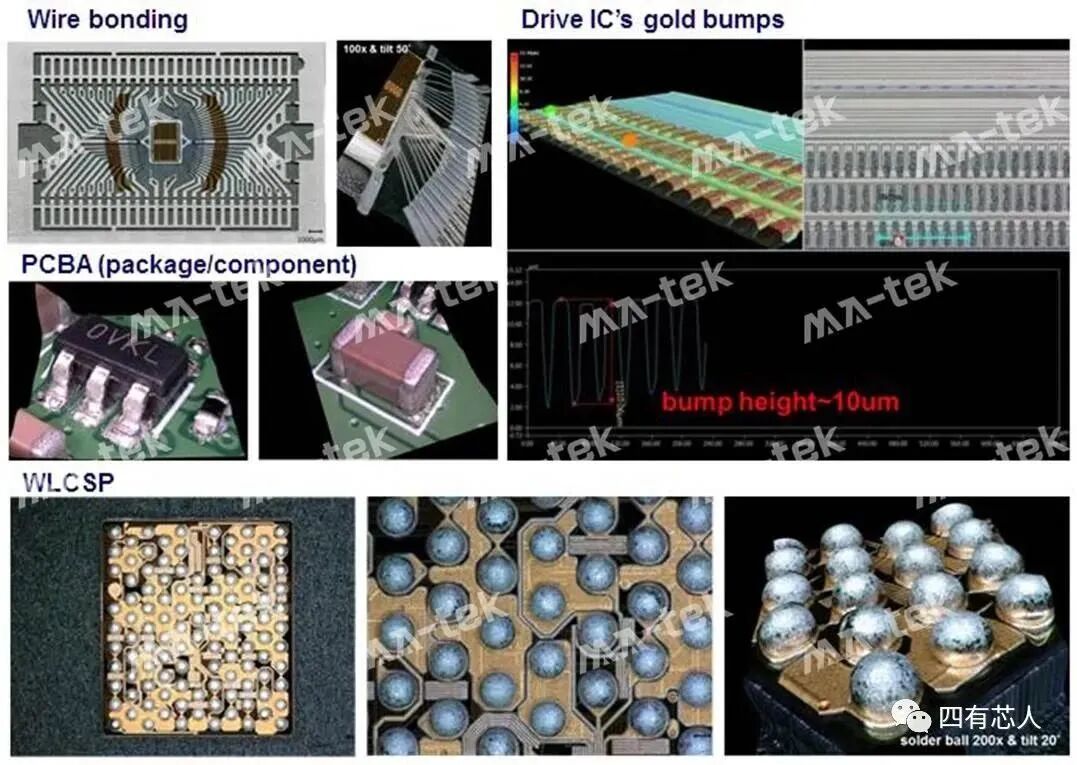 |