预处理(Precondition Test: Pre-con)测试目的:芯片吸收一定水分,并进入Reflow,然后查看芯片是否有脱层、爆米花效应等;此实验用于模拟芯片在生产、运输、上板使用等过程。 参考规范:J-STD-020、JESD22-A113 湿度敏感等级:Moisture sensitivity level  预处理流程 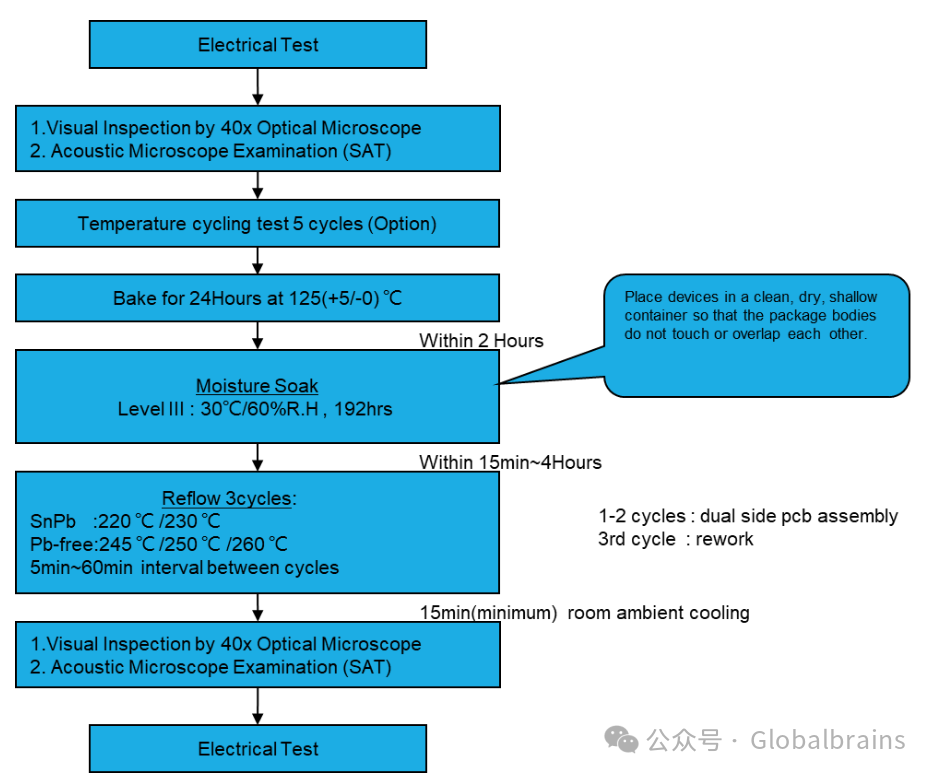 温度循环实验(Temperature cycling test:TCT) 测试目的:评估芯片封装对于极端高低温快速转换之耐受度。进行该测试时,将芯片按照预定的循环次数反复暴露于此条件下。 测试条件:条件B -55~125℃,700cycles 条件G -40~125℃,850cycles 条件C -65~125℃,500cycles 条件K 0~125℃,1500cycles 条件J 0~100℃,2300cycles 样品数 : 25ea/lot , 3lots 参考规范:MIL-STD-883 Method 1010.7、JESD22-A104  温湿度偏压高加速应力实验(High accelerated temperature and humidity stress test: HAST) 测试目的:芯片处于密闭空间内高温、高湿、高压的加速因子下,施加电压,以实验封装的抗腐蚀能力,确定其可靠性。 测试条件:130℃/110 ℃,85% RH,蒸气压:33.3/17.7 psia,电压Vcc=Vccmax,测试时间:96/264hrs 样品数:25ea/lot , 3lots(这个只是参考,具体取样要求根据可靠度&置信度计算,以及客户要求) 参考规范:JESD22-A110 温湿度无偏压高加速应力实验(Un-bias High accelerated temperature and humidity stress test: uHAST) 测试目的:芯片处于密闭空间内高温、高湿、高压的加速因子下,以实验封装的抗腐蚀能力,确定其可靠性。 测试条件:130℃/110 ℃ ,85% RH,蒸气压:33.3/17.7 psia,测试时间:96/264hrs 样品数:25ea/lot , 3lots(这个只是参考,具体取样要求根据可靠度&置信度计算,以及客户要求) 参考规范:JESD22-A118 温湿度偏压实验(Temperature and humidity bias test: THB) 测试目的:芯片处于高温、高湿的加速因子下,施加电压,以实验封装的抗腐蚀能力,确定其可靠性。 测试条件:温湿度:85℃/85% RH,电压Vcc=Vccmax ,测试时间:1000hrs 样品数:25ea/lot , 3lots 测试读点:168 、500 、1000hrs 参考规范:JESD22-A110 高温储存(High temperature storage life test:HTSL) 测试目的:模拟芯片被使用前,长时间储存的情况。 测试条件:150 ℃,测试时间:1000hrs 样品数:25ea/lot , 3lots 测试读点:168 、500 、1000hrs 依据规范:JESD22-A103 高温工作寿命实验(High temperature operating life test :HTOL) 测试目的:芯片处于高温条件下,加入动态信号,并长时间工作,以评估其使用寿命,并确定其可靠性。 测试条件:结温(Tj)≧125℃,电压Vcc≧Vccmax,测试时间:1000hrs 样品数:77ea/lot , 3lots 测试读点:168 、500 、1000hrs 参考规范:MIL-STD-883 Method 1005.8、JESD22-A108  低温工作寿命实验(Low temperature operating life test :LTOL) 测试目的:芯片处于低温条件下,加入动态信号,并长时间工作,以评估“热载子衰退效应”(Hot carrier degradation)。 测试条件:结温(Tj)≦50℃,电压Vcc≧Vccmax ,测试时间:1000hrs 样品数:32ea/lot , 1lot 测试读点:168 、500 、1000hrs 参考规范:JESD22-A108 早夭失效率实验(Early life failure rate test:ELFR/EFR) 测试目的:芯片处于与HTOL类似的条件下,通过一定数量的实验样本,找到早夭产品,进而评估出早夭率 测试条件:结温(Tj)≧125℃,电压Vcc≧Vccmax,测试时间:48~168hrs 样品数:依 ELFR table 参考规范:JESD22-A108、JESD74 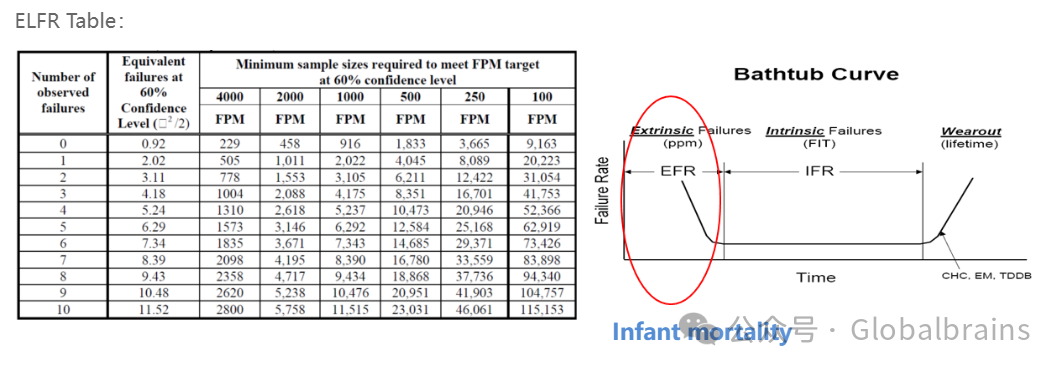 |





