上次以一个初学者的角度,写了一篇何为ATE测试机的文章。超出我预期的阅读量与留言,让我有动力继续写下去。话说我去年才接触这个行业时,听人前辈交流,全是些专业术语,听得我云里雾里,到现在也有很多术语都没搞清楚是什么意思。今天,我们就分享一下基础的整机术语以及CP/FT测试,进一步解释一下何为测试机!1、ATE:Auto Test Equipment自动化测试设备 下图就是V93000的ATE,俗称93K的测试机。 前面机械臂支持的方形模块称为测试头tester,里面包含了许多测试板卡,比如电源板卡,数字板卡,模拟板卡,通信板卡,这些统称为资源板卡。 后方立柜称为电气柜,里面包含服务器,整机电源,水冷系统等电气设备。  图1-ATE测试机 2、DUT:device under test 被测器件的统称。 DUT可以是封装好的芯片,如果测试这种器件,称为FT测试;DUT也可以是没有封装的晶圆,如果测试这种器件,称为CP测试。 3、FT测试:Final Test成品测试  图2-FT测试 4、CP测试:Chip Probing 晶圆测试  图3-CP测试 假如你手上现在有一台ATE测试机,也有被测器件DUT,那么是否就可以组装一条生产线进行芯片测试了呢?答案是否定的,下面分别以CP测试和FT测试为例来介绍。 如果要搭建一个晶圆的自动化测试流水线,除了ATE机台,还需要一些辅助设备。 5、Probe Card :探针卡 作用:ATE测试机与晶圆芯片之间的“桥梁”,用探针接触芯片引脚。  图4-探针卡 分类: · 悬臂式探针卡:像“缝衣针”,适合低密度引脚; · 垂直式探针卡:像“钉床”,用于高密度BGA芯片; · MEMS探针卡:用半导体工艺制造的“精密触手”,测试5G/AI芯片 6、Prober:探针台 作用:固定晶圆并确定位置到每个芯片(Die);  图5-探针台 关键功能: · 用真空吸附晶圆,防止移动(类似贴膜时的静电吸附) · 通过高精度机械臂移动晶圆,误差<1微米(头发丝的1/60) · 提供测试时的温度控制(高温/低温环境模拟) 小结:CP测试——ATE+Porber card(探针卡)+Porber(探针台)  图5-CP测试系统示意图 如果要搭建一个FT的自动化测试流水线,除了ATE机台,还需要loadbord和socket,再加上handler。 7、Loadboard:负载板 作用:类似CP测试中的探针卡,是ATE测试机与FT芯片之间的“桥梁”。 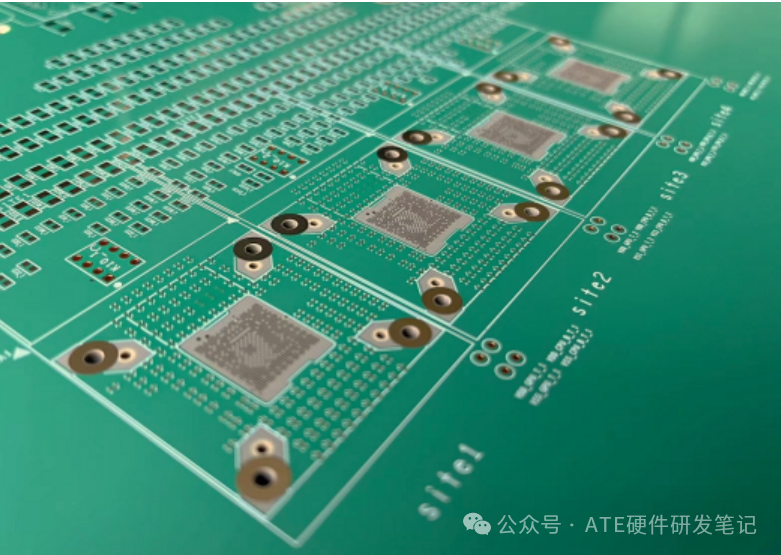 图6-负载板 8、socket:芯片测试座 作用:它只是为了满足芯片测试需求的内联器(interposer)。它是一个IC和PCB之间的静态连接器,它会让芯片的更换测试更为方便,不用一直焊接和取下芯片,这样的话,就不会损伤芯片和PCB,从而达到快速高效的测试。 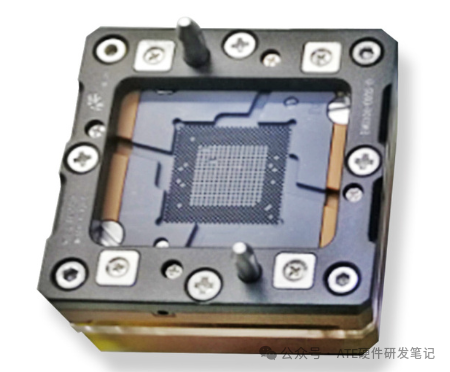 图7-Socket 9、handler:分选机 作用:将封装好的芯片按照特定的标准进行分类,用于将测试过的IC芯片按照性能等级分类,或者将不良品剔除。  图8-分选机 小结:FT测试——ATE+Loadboard(负载板)+socket(插座)+handler(分选机) 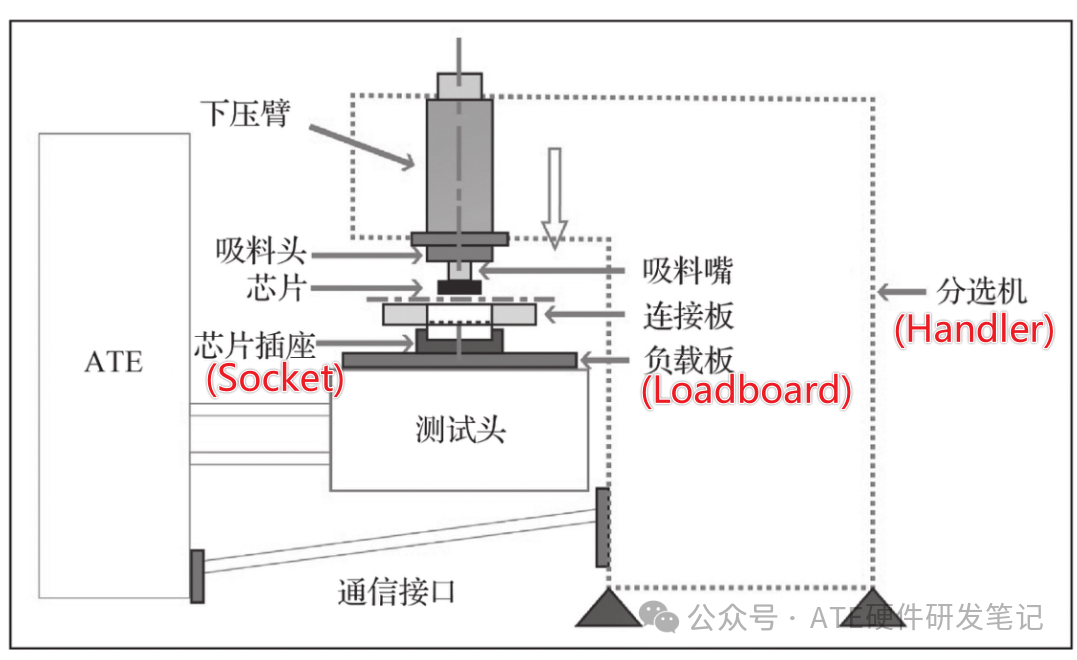 图10-FT测试系统示意图 通过以上介绍,我们了解了CP测试和FT测试,并知道了半导体测试三大核心设备:ATE(测试机),Prober(探针台),handler(分选机)。 下面,我们将CP测试和FT测试进行一个对比。 CP测试 vs FT测试的本质区别
到这里,基本把CP和FT介绍清楚了,但我还是有许多疑问? 为什么FT测试必须用分选机? 1. FT测试与CP测试的物理形态不同: · FT测试对象是封装后的芯片是独立个体(如QFN、BGA),需逐个抓取测试。 · 需要分选机像“快递分拣机器人”: 振动盘 → 排列芯片(类似硬币分拣) 机械臂 → 抓取芯片到测试座 分类槽 → 按测试结果分Bin(如Bin1=合格,Bin2=次品) 2. FT性能分级需求: · 高端芯片需按性能参数分档(如CPU分i3/i5/i7) · 分选机可支持多级分类(通常4-8个Bin)· 为什么CP测试不需要分选机? 1. CP测试对象是整片晶圆: · 所有Die在晶圆上已固定位置,无需物理搬运; · 探针台通过**XY平台移动晶圆**,自动定位到每个Die; 2. CP测试分选方式不同: · CP测试通过墨水点标记(Inking) 或 电子Map图记录坏点; · 后续切割时,由晶圆锯(Wafer Saw) 自动跳过坏Die(根据Ma图) 虽然CP测试不需要独立的分选机,但探针台实际上承担了“晶圆级分选”的功能。 探针台处理的是二维平面上的晶圆,分选机处理的是三维离散的封装芯片。 探针台的“分选”是逻辑标记,分选机是物理分选。 最后总结一下CP和FT测试流程: CP测试流程: 晶圆 → 探针台定位 → 测试 → 生成Wafer Map → 切割时自动剔除坏Die FT测试流程: 封装芯片 → 分选机抓取 → 测试 → 按Bin分拣到不同料盒 小结一下CP测试FT测试的异同: 相同之处: 1. 都是“芯片体检”: · 不管是CP还是FT,它们都像是给芯片做“体检”,确保芯片健康、功能正常。就像你去医院,医生会用不同的检查项目来确认你的身体状况一样,CP和FT也用不同的方式检查芯片的“健康状况”。 2. 都用“自动化工具”: · 两者都依赖ATE(自动测试设备)这种“高科技工具”,就像医生用X光机、心电图仪一样,精准又高效。 3. 目标一致:抓出“坏蛋”: · 它们的终极目标都是抓出“坏蛋芯片”,不让有问题的芯片流入市场,就像警察抓坏人一样,维护芯片世界的“治安”。 差异之处: 1. 测试阶段:一个是“婴儿期”,一个是“成年期”: · CP测试:芯片还在晶圆上,像一群“小婴儿”,排排坐等着检查。测试的是裸芯片,还没穿上“封装”的外套,类似儿保体检。 · FT测试:芯片已经封装好了,像“成年人”穿上了正式的衣服,准备进入职场,类似入职体检。测试的是成品芯片,更接近最终形态。 2. 测试方式:一个是“戳戳乐”,一个是“插插座”: · CP测试:用探针卡(Probe Card)去“戳”晶圆上的裸芯片,像用针轻轻戳一下小婴儿,看看反应。 · FT测试:用测试插座(Socket)把封装好的芯片“插”进去测试,像给成年人做体检,直接抽血量血压、测心跳。 3. 测试重点:一个是“查先天”,一个是“查后天”: · CP测试:主要检查芯片的“先天问题”,比如制造过程中有没有缺陷,像检查小婴儿有没有先天疾病,有点像孕检筛查。 · FT测试**:主要检查芯片的“后天问题”,比如封装过程中有没有受伤,或者功能是否正常,像检查职场人有没有遭受社会的毒打。· 4. 成本与效率:一个是“快速初筛”,一个是“全面体检”: · CP测试:成本低,效率高,像用快速试纸测一下有没有大问题。 · FT测试:成本高,但更全面,像做全套体检,确保万无一失。· 总结: 两者就像生命中的两次重要体检,一次在出生时,一次在进入职场前,共同确保职场人的功能性和耐操性!经过这两次体检,老板就觉得这个应聘者,是可以接受后续“996”工作制考验的合格职场人了! |





