CP测试定义晶圆CP(Chip Probing)测试,全称是晶圆级芯片测试,也称为探针卡测试 或 中测。它是在晶圆制造完成之后、切割和封装之前,通过探针卡与芯片的焊盘接触,对晶圆上的每一颗芯片进行电性功能和性能参数的初步测试。和WAT测试相比,两者处于不同工艺位置,具体流程如下图: 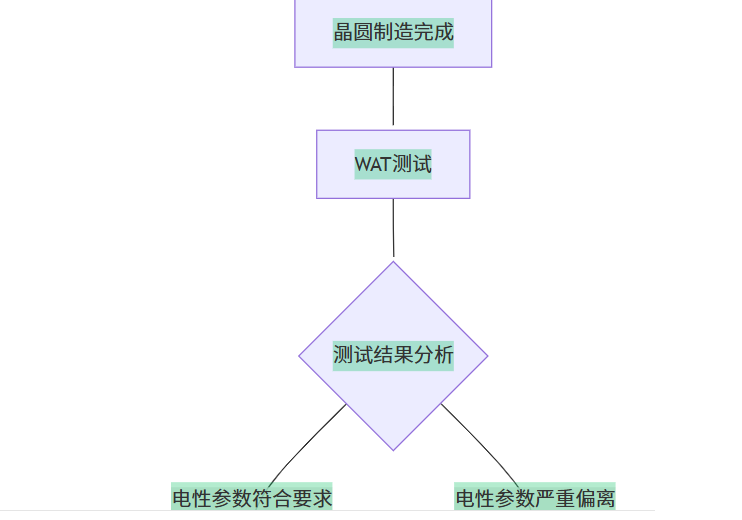
1. 筛选良品,剔除坏品:晶圆在制造过程中,难免会因为尘埃、工艺波动、设备误差等原因产生缺陷。CP测试可以快速找出这些功能失效或性能不达标的芯片。 |
| 厂商 | 国家 | 主要优势领域 | 市场定位 |
| 爱德万测试 | 日本 | SoC,存储器,射频 | 全球领导者,高端全能 |
| 泰瑞达 | 美国 | SoC,模拟/混合信号,射频 | 全球领导者,高端全能 |
| 科休半导体 | 美国 | 探针卡,接触器 | 探针卡绝对龙头,测试系统有特色 |
| 华峰测控 | 中国 | 功率器件,模拟/混合信号 | 中国龙头,全球功率测试重要玩家 |
| 长川科技 | 中国 | 模拟/混合信号,数字 | 中国主要供应商,快速发展 |
| 美国国家仪器 | 美国 | 射频,无线通信,定制化 | 基于PXI的灵活解决方案 |
| 东京精密/电子 | 日本 | 探针台 | 探针台设备领导者 |
CP测试流程
CP 测试流程主要包括DCtest, Functionaltest和Parametric test三部分:
1.连通性测试(DC test):Open/Short test, Power short test, l/O leakage test, IDDQ/lSB;
其中OS(Open short): 用来确认信号引脚是否与其他信号引脚、电源或地之间有短路/断路的问题,测试中通常放在第一项,既可以排除测试机是否有setup问题,也可以节约测试成本。
Power Short Test用来确认电源引脚是否与地之间有短路的问题。测试中通常会在Open/Short之后,防止电地短路产生的大电流损害测试机本身.
Dc Test: 常见的测试项有 VOH/OL、VIH/VIL、IIH/IIL等。VOHNOL:检测输出管脚处于逻辑高/低的电压值是否达标;VIH/VIL:检测输入管脚正确识别逻辑高/低的电压值是否达标;IIH/IIL: 检测输入管脚和地/电源之间的漏电流大小是否达标;先测输出,再测输入。
2.功能性测试(Functional test):Bscan/Chain/Stuck/Mbist; 这一部分主要运行测试向量(test vector),测试向量是设计公司DFT工程师使用ATPG(自动测试模式生成)工具生成的。
BoundryScan:用于检测芯片管脚功能是否正确。通过在IO管脚间插入边界寄存器,监测管脚的输入输出状态Chain:测试即是对扫描链进行自检;
Stuck:检查logic 部分电路是否健康;
Tansition: 电路中有很多工艺造成的soft fail,比如metal将断未断的时候,一般的scan测试是测不出来的,只有通过快速的翻转,才能抓出来,device速度也会导致该功能fail.
Mbist:内建自测试逻辑产生激励,对SRAM 进行读写,然后在内建自测试逻辑中去比较测试结果,所以不依赖机台也能完成测试。
3.参数性测试(parametrictest):HPM/T-sensor/DDR/IDDQ:
HPM: Hardware Perfommance Monitor; HPM的主要作用是在电路中对于速度和时序要求比较高的模块(例如CPU)周围放置一个HPM模块,表征chip整体速度来监控它的实时速度,HPM 输出码字越大,表征chip整度。芯片上会有很多HPM模块,一般采用RO作为载体测试频率;
IDDQ Test: Q 代表静态(quiescent),IDDQ 测试分DC IDDDQ和FC IDDQ测试。FC IDDQ在电压测试生成中加少量的测试图形,就可以大幅度提高测试覆盖率。及时电路功能正常,可以检测出桥接、短路、栅氧短路等物缺陷(hard fail),DC IDDQ可以表征部分芯片性能;
T-sensor - 温度传感器, 测试芯片内部集成的温度传感器的功能与精度。将晶圆或芯片置于一个可控的温度环境中(通过热 chuck)。,在不同的温度点(例如 -40°C, 25°C, 125°C),读取温度传感器输出的数字码或电压值。
DDR是对存储器接口进行严格的时序和电压参数测试,以确保与内存条的可靠通信。






