上一篇文章介绍了芯片开封(Decap),接着讲讲芯片去层。芯片去层是半导体失效分析(Failure Analysis)和逆向工程(Reverse Engineering)中的核心技术,目的是逐层移除芯片的封装和内部层叠结构,以便在显微镜下观察每一层的电路布局和结构。去层是一个从宏观到微观、从外部到内部的循序渐进过程。下图清晰地展示了这一逐步推进的完整流程: 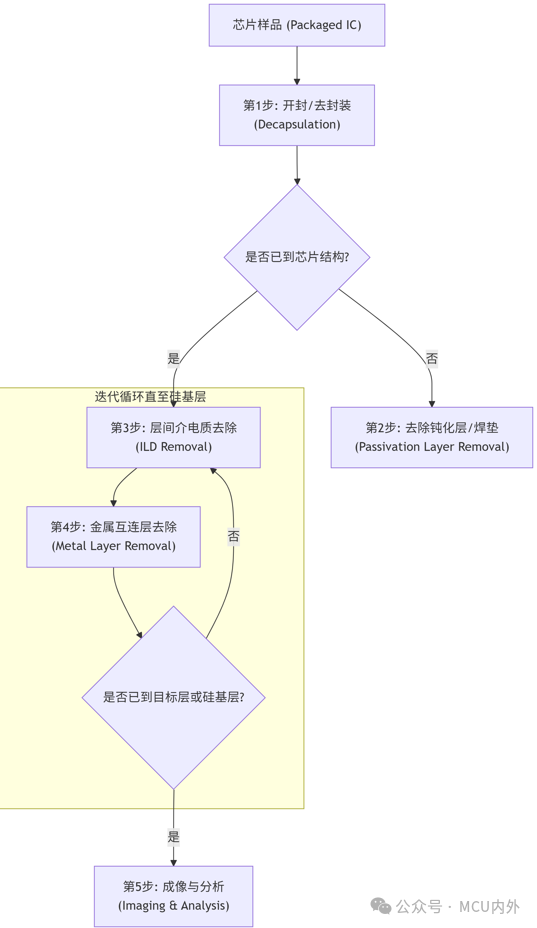 芯片最顶层是一层坚硬的钝化层(通常由氮化硅Si₃N₄或氧化硅SiO₂组成),用于保护电路免受划伤、湿气和污染。需要先移除它才能看到顶层的金属互连。 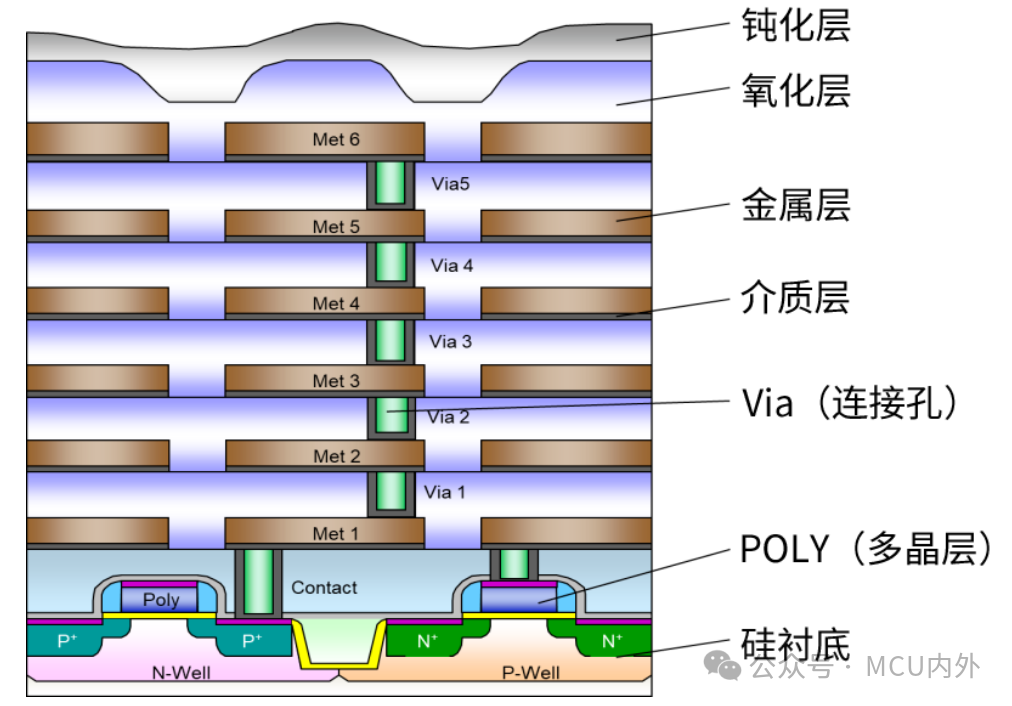 第1步:去除钝化层 (Passivation Layer Removal)方法:反应离子刻蚀 (RIE) 或 湿法化学腐蚀RIE (干法): o 原理:在真空腔体内,通入反应气体(如CF₄, CHF₃),形成等离子体。等离子体与钝化层发生化学反应并产生挥发性副产物,从而将其去除。 o 优点:各向异性好(垂直方向刻蚀快,横向刻蚀慢),能保持下层金属线条的形貌,控制精度高。 o 设备:RIE刻蚀机。 · 湿法腐蚀: o 试剂:热磷酸(H₃PO₄)用于去除氮化硅(Si₃N₄),氢氟酸(HF)缓冲液用于去除氧化硅(SiO₂)。 o 优点:速度快,成本低。 o 缺点:各向同性腐蚀,可能导致横向钻蚀(Undercut),损坏金属线边缘。 第2步:层间介电质去除 (Inter-Layer Dielectric - ILD Removal)钝化层之下是多层金属互连结构,它们之间由层间介电质(ILD,通常是SiO₂ based)隔离。去层的核心就是循环进行 “去除ILD -> 观察/成像 -> 去除金属” 的过程。· 方法:湿法化学腐蚀 或 干法刻蚀 · 首选方法:湿法化学腐蚀(基于HF) o 试剂:缓冲氢氟酸(BHF)或氢氟酸蒸汽(HF Vapor)。 o 原理:HF与SiO₂反应生成可溶于水的六氟硅酸。 o 优点(HF Vapor):各向同性,但腐蚀均匀且温和,对下层金属损伤小,容易控制终点。是目前最常用、最可靠的方法。 · 干法刻蚀:同样可以使用RIE,但需要优化工艺以避免对下层金属造成损伤。· 第3步:金属互连层去除 (Metal Layer Removal)当一层ILD被移除后,该层的金属互连(通常是铝或铜)就会暴露出来。为了看到下一层的结构,需要将这些金属完全去除。· 方法:湿法化学腐蚀 · 铝(Al)互连腐蚀: · o 试剂:磷酸(H₃PO₄)、硝酸(HNO₃)、醋酸(CH₃COOH)的混合液(常用商业名称如“Transene Al Etchant”)。 o 原理:混合酸能有效溶解铝,同时对氧化物介电质的腐蚀速率很慢。 · 铜(Cu)互连腐蚀: o 试剂:氨水(NH₄OH)与过氧化氢(H₂O₂)的混合液(通常称为APM溶液)。 o 挑战:铜的化学惰性更强,腐蚀后更容易产生残留物,需要更精细的配方和控制。 第4步:重复循环与终点检测重复步骤2和3,逐层向下推进,直到暴露出感兴趣的缺陷(如通孔、接触孔)或最底层的硅基晶体管(有源区、多晶硅栅极)。主要方法总结对比
成像与分析在整个去层过程中,每一步完成后都需要使用以下工具进行观察和记录:光学显微镜 (OM):快速定位和初步观察。 扫描电子显微镜 (SEM):提供高分辨率、大景深的图像,是观察电路细节的主要工具。 能量色散X射线光谱 (EDS/EDX):与SEM联用,进行元素成分分析,帮助识别材料。 总之,芯片去层是一项极其精细和专业的技艺,需要分析师根据芯片的工艺节点(纳米尺寸)、材料体系(Al vs. Cu, Low-k dielectrics)和具体目标,灵活选择和组合上述方法,并依靠丰富的经验来判断进程和解决问题。 |





