芯片为啥能用好几年?揭秘背后的“压力测试”在半导体产业链中,芯片从设计、制造到封装,每一步都至关重要。然而,即便芯片功能测试全部通过,也不能保证其在真实应用场景中长期稳定运行。因此,可靠性测试(Reliability Testing)成为芯片量产前不可或缺的一环。它不仅是质量的“试金石”,更是产品能否在市场立足的关键保障。 本文将系统梳理芯片可靠性测试的核心概念、常见项目及其意义,帮助读者快速掌握这一关键环节。  一、什么是芯片可靠性测试?可靠性,是指产品在规定条件下和规定时间内,持续完成规定功能的能力。对芯片而言,即在高温、高湿、温度变化、电压波动等复杂环境下,仍能保持性能稳定、不发生失效的能力。 可靠性测试的目的不是验证芯片“能不能用”,而是预测它“能用多久”。通过在实验室中模拟极端环境,加速芯片老化过程,提前暴露潜在缺陷,从而确保出厂芯片具备足够的寿命和稳定性。 简单来说: 功能测试是“今天能不能工作”, 可靠性测试是“未来几年还能不能持续稳定工作”。 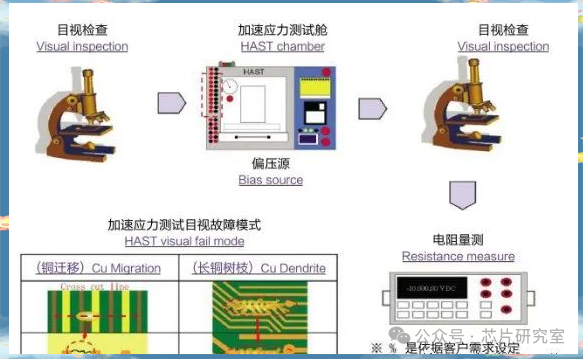
|