摘要高温可靠性测试如高温栅偏 ( High Temperature Gate Bias,HTGB) 、高温反偏 ( High Temperature Reverse Bias,HTRB) 、高温高湿反偏 ( High Humidity High Temperature Reverse Bias,H3TRB) 是器件出厂和寿 命评估必备的测试。然而,不同标准的测试条件不尽相同,其对应的内在机理也不明确。为讨论测试条件的 确定原则,首先从单个和耦合的温度、电场、湿度加速老化模型出发,论述了相关测试标准所用模型,分析 了其应用范围和使用原则。进一步地,总结了现有各类标准下的测试条件,计算了电动汽车模块正常运行 30 年所需 HTGB、HTRB、H3TRB 加速老化时间分别为 832 h、866 h、1 038 h,测试的样本数均为 70,并指 出测试时间、样本数需根据实际工况决定。最后,基于以上分析,提出了一种加速老化时间、样本数可调的 高温可靠性测试流程。0 引言 随着功率器件在各行业的广泛应用,其严苛 环境下长期可靠运行能力引起广泛关注,尤其是 高温环境下,电子或空穴迁移率的变化导致器件 电学特性变化以及封装材料参数变化,进而导致热失效。此外,器件封装材料的老化也可能导 致芯片性能的失效,如硅胶老化导致的绝缘性能 下降可能引起芯片耐压击穿等。对于如绝缘栅 双极 型 晶 体 管 ( Insulator Gate Bipolar Transistor, IGBT) 或金属氧化物半导体场效应管( Metal Oxide Semiconductor Field Effect Transistor,MOSFET) 等 功率器件,以国际电工委员会( International Electrotechnical Commission,IEC) 为代表的各类国际、 国内和行业标准主要包含高温反偏( High Temperature Reverse Bias,HTRB) 测试、高温栅偏( High Temperature Gate Bias,HTGB) 测试。此外,对 于电动汽车及海上风电等应用工况,高温和高 湿环境 同 时 存 在,高温高湿反偏或温湿度偏置 ( High Humidity High Temperature Reverse Bias, H3TRB 或 THB) 测 试、高温高湿高压反偏测 试 ( High-Voltage High Humidity High Temperature Reverse Bias Test,HV-H3TRB) 被广泛应用。 对于上述可靠性测试,一系列标准从测试电 路、测试条件、测试流程、数据测量等方面进行了论述。然而,各类标准虽然繁多,但加速老 化机理不明、测试条件不尽相同,测试条件选取的 原则和依据无从定论等问题,反而使得测试条件、 测试样本量的选取等出现困扰,严重限制了实际 可靠性测试的效率及其结果。更为重要的是,随 着芯片和封装技术的不断提升,常规的1 000 h高 温考核可能无法暴露器件存在的问题,而增加测 试时间又大大增加了研发成本和研发周期,因此, 必须深入了解器件的高温失效机理、加速老化机 制和测试条件确定原则才能满足未来的研究需求。 为深入探究高温可靠性测试( HTGB、HTRB、 H3TRB) 加速老化模型及相关测试条件的选取原 则和依据,进而解决测试条件选取原则及依据不 明的问题,本文首先论述了单个或耦合的温度、电 场、湿度加速老化模型。进一步地,总结现有各类 标准的测试条件,综合 JEP122 等标准、相关测 试模型参数,以电动汽车工况为算例,计算了器件 正常运行 30 年寿命对应 HTGB、HTRB、H3TRB 加 速老化测试需分别考核 832 h、866 h、1 038 h,测试 的样本数均为 70。最后,提出了测试样本、测试时 间可调的高温可靠性测试流程,解决了目前可靠 性测试测试条件选取不明的问题。 1 加速老化模型 MOSFET 器件的 HTGB、HTRB、H3TRB 老化 测试电路如下图 1 所示,这里以欧洲电力电子研 究中心标准 AQG324 为例进行简单阐述。对于 HTGB,主要考核栅氧化层完整性、栅氧化层/半导 体层边界状态及可动离子对半导体的污染。对于 HTRB /H3TRB,主要考核芯片钝化层、芯片终端处 易失效的弱点,尤其是 H3TRB 重点还考虑了水汽 入侵对终端可靠性的影响。  温度场和电场是 HTGB、HTRB、H3TRB 三个 老化测试所共有的加速因子。温度场的作用是为 了增大电子或空穴迁移率,增大碰撞电离或暴露 污染离子,进而加速栅氧化层或钝化层老化; 电场 的作用是为了增大电子迁移速率或积聚污染离 子,进而加速栅氧化层或钝化层老化。对 于 H3TRB,还存在湿度场作为加速老化因子,湿度场 的作用是为了增大金属离子电化学迁移现象的速 率,加快电树枝的形成,进而加速钝化层老化。一 般情况下是上述电场、温度场和湿度场的共同作 用,尤其是海上风电的应用工况。因此,为了简化 加速老化过程,需首先论述如单个物理场的加速 老化作用,再论述电场、温度场、湿度场的叠加作 用。现有的标准中,只有 JEDEC 标准中定义了各 测试的加速老化模型,本文所引用的模型大部分 也来源于此标准。 1. 1 温度加速老化模型 1. 1. 1 Arrhenius 加速老化模型 Arrhenius 模型是由 Svante Arrhenius 于 1889年通过实验现象总结提出的经验公式,被广泛应 用于描述化学反应中反应速率与温度之间的关 系,其优点在于适用于所有的基元反应,对部分 复杂反应也适用,缺点在于对温度范围较宽或较 复杂的反应拟合效果不好。Arrhenius 模型表达式 如下式所示:  式中: R 为反应速率; γ0 为材料相关的比例系数; Ea 为活化能; k 为玻尔兹曼常数; T 为开尔文单位 下的热力学温度。由式( 1) 可计算基于 Arrhenius 理论的加速老化因子:  式中: AF 为加速老化因子; TA 为加速老化测试温 度; TU 为正常使用工况温度; RAr( TA ) 为加速老化 下反应速率; RAr ( TU ) 为正常使用工况下反应速 率。Arrhenius 加速老化模型是目前应用最为广泛 的理论,包括功率器件功率循环测试的寿命模 型。 1. 1. 2 Eyring 加速老化模型 1. 1. 1 节所述 Arrhenius 模型是经验公式,且 在温度范围较宽或较复杂的反应拟合效果不好。Eyring 等人于 1941 年,以量子力学理论为基础,从 物理理论层面对 Arrhenius 模型进行了深入解释及 扩充,应用范围不仅涵盖温度单场,还适用于描述 多个场的共同老化作用。Eyring 模型表达式如 下式所示:  与式( 1) 相比,式( 3) 增加了温度 T 的倒数 项,系数 A 为产品相关的特征系数,与量子力学中 透射系数、普朗克常数有关,系数 B 为测试方法相 关的特征系数。其对应的加速老化因子如式( 4) 所示:  1. 2 温度、电场耦合加速老化模型 对于温度场、电场共同作用下的加速老化模 型,通常的做法是不考虑其间的耦合作用,整体的 加速因子由温度加速因子 AFT、电场加速因子 AFV 直接相乘得到,但对于广义的 Eyring 模型,温 度与电场之间的耦合关系得到考虑。 1. 2. 1 HTGB 加速老化模型 HTGB 加速老化测试下对应的器件栅氧化层 失效的物理模型为时间相关介质击穿或经时击穿 ( Time-Dependent Dielectric Breakdown, TDDB),TDDB 模型中,F-N 隧穿效应基础上的 1 / E 模型与电偶极子交互作用基础上的 E 模型以其 良好的物理机理及拟合结果被广泛应用。以 MOSFET 为例,1 /E 模型强调电子受高温及电场作 用,从半导体层隧穿到氧化层,碰撞形成电流; E 模型则强调高温及电场下,半导体层/氧化层界面 处 Si-O 共 价 键 的 断 裂,如 图 2 所 示。根 据 JEP122 标准,E 模型及 1 /E 模型适用于 4 nm 厚度 以上的 SiO2 层,对于薄栅或高 K 栅的加速老化模 型适用性仍不明确。 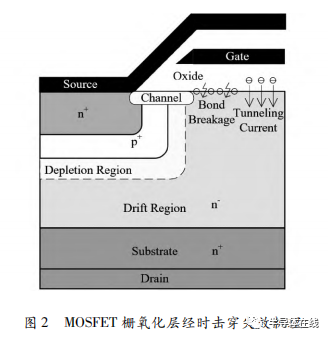 1) 1 /E 模型 1 /E 模型由 K. F. Schuegraf 等人于 1993 年提 出,其适用于描述高电场下失效时间 tBD与电场 E 之间的关系。1 /E 模型机理如下: 施加偏置电压 时,阴极端的电子经过 F-N 隧穿效应进入栅氧化 层的导带,受电场 Eox加速并与 SiO2 晶格发生碰撞 电离,产生陷阱。陷阱的存在导致局部缺陷处电 场及隧穿电流增加,形成正反馈加速了碰撞电离 及陷阱的产生,最终形成导电通道击穿栅氧化层。1 /E 模型下器件失效时间如下式所示:  式中: τ0 为材料相关的比例系数; G( T) 为与温度 相关的电场加速因子,为简化计算常取定值; Eox为 施加在栅氧化层上的电场强度,MV/cm。对等式左右同时取对数,可发现失效时间的对数与 Eox呈 反比,因此称为 1 /E 模型。由式( 5) 可计算得其加速因子:  (2) E 模型 E 模型由 J. W. McPherson 等人于 1985 年提 出,相对于 1 /E 模型,E 模型克服了低电场下寿 命估计的误差,适用范围更广,被业界及相关标准 广泛应用并成为主流加速老化模型。E 模型机 理如下: SiO2 中 Si 的电子被 O 吸附形成带正电的 Si 离子和负电的 O 离子即 Si-O 电偶极子。在高 温及电场( <10 MV/cm) 环境下,Si-O 电偶极子使 得局部电场增大与 Si /SiO2 界面处分子共价键断 裂所需的活化能降低,导致 Si /SiO2 界面处热键断 裂,且电场的增大指数级地增加了器件失效的速 率。E 模型下器件失效时间如式( 7) 所示:  式中: TF 为器件失效时间; A0 为材料相关的比例 系数; γ 为与温度相关的电场加速因子且有 γ( T) = a /kT、a 为分子的有效偶极矩,为简化计算常取 定值。由式( 7) 可推导得其加速因子:  1. 2. 2 HTRB 加速老化模型 HTRB 加速老化测试在高温下施加阻断电压 并对终端、钝化层进行考核,终端可动污染离子在 电场及高温作用下逐渐暴露并在高电场区积聚, 形成表面电荷,导致电场畸变及泄漏电流的增大, 最终形成短路通道。对应器件终端失效的物理 模型为含电压加速因子的扩充 Eyring 模型与逆幂 律模型,扩充 Eyring 模型由 Eyring 等人于 1941 年 提出,解决了不同应力共同加速作用的问题,其失 效时间如式( 9) 所示:  式中: A 为产品相关的特征系数; B 为测试方法相 关的特征系数; V 为器件所加阻断电压; C 为电压加速因子; D 为电压与温度间的耦合系数( 反映 HTRB 下阻断漏电流带来的温升效应、温度升高对 器件漏电流增大的作用等) ,相应加速因子如式 ( 10) 所示:  Deepak Veereddy 等人于 2017 年进行了氮化 镓器件的加速老化测试,在此基础上对比了扩充 Eyring 模型及逆幂律模型对寿命估计的差异 性,逆幂律模型如式( 11) 所示:  式中: B0 为材料相关的比例系数; n 为大于 0 的电 场加速因子; Ea 为活化能; k 为玻尔兹曼常数; T 为 开尔文单位下的热力学温度。 1. 3 温湿度、电场耦合加速老化模型 1. 3. 1 H3TRB 加速老化模型 根据 JESD22-A101 D 及 JEP122 等 JEDEC 标 准,传统 H3TRB 测试考核温湿度引起的腐蚀,施 加最大值 80 V 的偏压以促进水解作用,同时限制 漏电流引起的温升不超过 2 ℃,湿度相关的 4 个失效模型于 1972—1986 间提出,如式( 13) ~ ( 16) 所示。1986 年,Peck 对已公开发表的所 有加速老化模型及实验数据与新提出的模型在 30% ~100%RH,85~ 140 ℃ 测试条件下,按照器件 测试寿命与计算寿命的拟合度进行了对比,发现 不管高于 85 ℃ /85%RH 还是低于 85 ℃ /85%RH, 于 1986 年 提 出 的 Peck 模型都有更好的 拟合度。因此,湿度可靠性相关寿命研究,目前最广 泛受到应用的是式( 14) 中的 Peck 模型。 ( 1) 倒数模型  ( 2) 幂律模型( Peck 模型)  ( 3) 指数模型  ( 4) 平方模型( Lawson 模型)  上述 4 类模型中,A0、B0、C0、D0 均为材料相关 的比例系数; f( V) 为电压相关的函数,通常取 1 /V。 1. 3. 2 HV-H3TRB 加速老化模型 随着器件耐压等级的增加,尤其是高压大功 率器件的应用需求越来越多以及器件封装、钝化 层、终端( Junction Termination,JT) 等工艺的不断 优化,80 V 耐压己经不能真实反映器件在高湿度 环境的工作状态,如海上风电用器件; 此外,由于 器件耐压的优良性能,即使高压偏置下,漏电流引 起的温升也可以被限制在 2 ℃以内。2014 年 Zorn 等人对高压大功 率 器 件 IGBT 进行了高电压下 ( 65%Vmax、90%Vmax ) 的高温高湿反偏测试并对 传统 Peck 模型中的电压加速因子进行改进, 总结出考虑高电压作用的 IGBT 器件加速老化模型如下:  1. 4 小结 表 1 对上述 HTGB,HTRB,H3TRB 测试所用 模型及其适用范围进行了总结,列写如下所示。  2 测试条件确定原则 由前述公式可知,加速老化测试的温度越高 越好、栅极偏压或承受阻断电压越大越好,使得老 化测试时间得以缩短,从而降低研发成本和缩短 研发周期。但不能超过器件允许运行的最高结 温、最大栅压和阻断电压,否则可能会产生实际工 况下不存在的老化机理,失去了加速老化测试的意义。样本量与加速老化因子、测试时间相关,因 此需在时间成本、经济成本之间做折衷的选择。在保证加速老化测试反映实际工况的前提下,均 衡考虑测试时间成本、经济成本是高温可靠性测 试条件选取最基本的原则。 此外,值得注意的是: 开始加速老化测试时, 应先施加电场、再施加温度场,结束加速老化测试 时,应先撤温度场、再撤电场,并于老化期间及 老化结束后 96 h 内测量相关参数。这样做是因为 温度的作用在于暴露可动离子、电场的作用在于 束缚可动离子,整个测试过程中需保证可动离子 受电场束缚不会逃逸,才能有效地反映器件的老化。 2. 1 HTGB 测试 2. 1. 1 标准定义的测试条件 表 2 对 HTGB 相关标准以 MOSFET 或 IGBT 为测试对象进行了整理与总结,结论如 下: HTGB 测试温度优选最大结温 100%Tjmax,偏置 电压优选 100%VGS( E) max,测试时间 1 000 h,测量参 数包 括: 栅 极 漏 电 流 IGSS( GE S) 、阈 值 电 压 VTH。IGSS( GES) 需连续监测,VTH 在老化前后测量进行对 比。IGSS( GES) 超过器件 Datasheet 或初始值 5 倍( 含 室温下) 或 VTH超过上下限值即认为失效。  如引言所述,HTGB 相关测试标准随着测试手 段的不断完善而增多。但繁多的标准并没有指出 具体的老化机理及不同工况对应的测试条件,比 如: 电动汽车工况和换流阀工况,同样要求 30 年 运行寿命,加速老化测试时间不同,因为加速因子 不同。因此建立加速老化模型,为提供测试时间、 测试样本的选取依据是十分重要的。 2. 1. 2 算例分析 在 JEP122 标准提供模型系数的基础上,进 行算例分析有助于合理选取相应测试条件。对于 式( 6) 、式( 8) ,器件栅氧化层电场 Eox的数值难以 得到,需将其转化成常用的参数如 VGS( GE) ,再进行 相应公式计算。器件栅氧化层电场 Eox 可 由 式( 18) 计算得到:  式中: VGS( GE) 为栅源极或栅射极电压( MOSFET 及 IGBT 器件) ; Vfb为平带电压; tox为栅氧化层厚度。 HTGB 测试中器件所施加栅压为 20 V,是器 件平带电压的十余倍,为简化计算可忽略平带电 压。器件老化过程中栅氧化层厚度是不变的,则 由式( 18) 可得加速老化与正常工况下栅氧化层电场之比:  假定 1 200 V SiC MOSFET 器件在正常运行工况如电动 汽 车 工 况 下,器 件 的 结 温 为 TjU = 100 ℃,栅极 电 压 VGE = 15 V,tox = 50 nm,EoxU = 3 MV/cm; 加速老化测试下,器件结温选取 TjA = 125 ℃,栅极电压 VGE = 20 V,EoxA = 4 MV/cm; γ = 3,Ea = 0. 75 eV,k = 8. 62×10-5 eV/K,由于电场较低( < 10 MV/cm) ,选用 E 模型,计算得加速老化因子 等于 87,正常工况下的寿命为 30 年对应加速老化 3 020 h。在保证老化机理及正常工况下寿命不变 的前提下,可提高加速老化温度至 150 ℃,计算得 加速老化因子等于 316,对应老化测试时间可缩短 为 832 h。 进一步地,根据老化测试时间、加速老化因子 等可计算测试的样本量。样本量的选取方法有 二: 一是为测试所有器件的共同特性( 如分析失效 机理等) ,则选取的样本量无需很大; 二是测试器 件中的小部分缺陷产品( 如筛选器件等) ,则以一 定小比例从大量器件中选择的样品量仍然较大。第二类测试样本量的计算方法如下式所示。  式中: Chi 2 ( B,c) 为以 B 为置信度,以 c 为失效器 件数的卡方分布; FITs 为每 109 个器件小时的失 效数量; A 是加速老化因子; t 为加速老化测试时 间。以 B = 60%、c = 0( Chi 2 ( 60%,0) = 1. 83) ,FITs = 50 为例,计算器件稳定运行 30 年对应加速老化 因子为 87 与 316 时所需样本量都为 SS = 70,老化时间、置信因子及 FITs 不变的前提下,加速因子 越大,测试样本数越小。AEC-Q101 及 IEC 标准按 照批允许不良率( Lot Tolerance Percent Defective, LTPD) 进行设置,LTPD 对应置信度 90%,取 LTPD = 3、合格判定数 n = 0 时对应的样本数 SS = 76。类 似地,AQG-324 标准规定的样本量同样可通过式 ( 20) 计算得到。 2. 2 HTRB 测试 2. 2. 1 标准定义的测试条件 表 3 对 HTRB 相关标准以 MOSFET 或 IGBT 为测试对象进行了整理与总结, 结论如下: HTRB 测试温度优选最大结温 100% Tjmax,偏置电压优选 100%VDS( CE) max,测试时间 1000 h,测量参数包括: 栅极漏电流 IDSS( CES) 、击穿电压 VBRDSS( BRCES) 、阈 值 电 压 VTH,IDSS( CES) 需 连 续 监 测, VBRDSS( BRCES) 、VTH 在老化前后测量进行对比。IDSS( CES) 超过限值或初始值 5 倍 ( 含 室 温 下) 或 VBRDSS( BRCES) 超过限值或 VTH 超过上下限值即认为 失效。 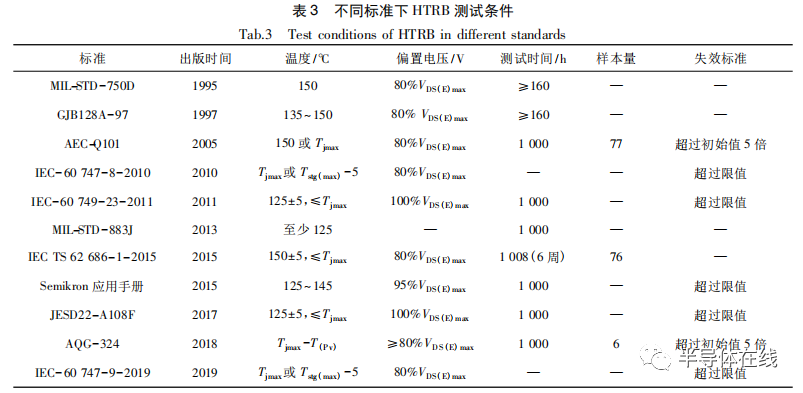 HTRB 相关测试标准繁多,但并没有指出具体 的老化机理及不同工况对应测试条件的选取方 法,因此建立加速老化模型对掌握其测试条件选 择原则十分重要,如前 2. 1. 1 及 2. 1. 2 节所述,此处不再赘述。 2. 2. 2 算例分析 基于标准 JESD74A及 JEP148 所给的含 电压加速因子的扩充 Eyring 模型。在相关标准提 供模型参数的基础上,进行一个简单的算例分析 有助于合理选取相应测试条件。 由 JESD74A 及 JEP148 所给参数: 式( 10) 中 B = 0. 65eV或 0. 7eV,C = 5. 5 或 1 。正常 运行工况下,器件结温 TjU = 50 ℃,承受阻断电压 VDS( CE) max; 加速老化测试下,器件结温 TjU = 125℃,承 受 阻 断 电 压 VDS( CE) max,计 算 JESD74A、 JEP148 参数下的加速老化因子分别等于 81. 4、 114,器件正常运行工况 30 年对应的加速老化测 试时间分别为 3 228 h、2 305 h。 考虑到标准提出至今已有十余年,器件的设 计、封装等得到了飞速的发展,前述模型参数对于 目前器件已不适用,选用逆幂律模型,根据近年的 器件及运行工况进行算例分析。假定器件结温 TjU = 100 ℃,承受阻断电压 90% VCEmax ; 加速老 化测试下,器件结温 TjA = 125 ℃,承受阻断电压 100% VCEmax,式 ( 12 ) 中 系 数 n = 22. 84,Ea = 0. 9eV。计算得加速老化因子等于 64. 4,器件 正常运行工况 30 年对应的加速老化测试时间为 4 080 h。 在保证老化机理及正常工况下寿命不变的前 提下,提高加速老化温度至 150 ℃,计算得已有模 型的加速老化因子等于 303. 4,对应老化测试时间 可缩短为 866 h。进一步地,根据式( 19) 统计器件 失效数 FITs 调整老化测试的样本量,以 B = 60%,c = 0( Chi 2 ( 60%,0) = 1. 83) ,FITs = 50 为例,按式 ( 19) 计算器件正常工况运行 30 年,加速老化因子 为 478 对应的测试样本量 N= 70。 2. 3 H3TRB 老化测试条件 2. 3. 1 标准定义的测试条件 表 4 对 H3TRB 相关标准以 MOSFET 或 IGBT 为测试对象进行了整理与总结,结论 如下: H3TRB 测试温度优选 85 ℃,湿度优选 85% RH,偏 置 电 压 优 选 100V 或 60% ~ 80% VDS( CE) max ( 针对 HV-H3TRB 测试) ,测试时间 1 000 h,测量 参数包括: 栅极漏电流 IDSS( CES) 、导通电阻 RDS( CE) on、 栅极漏电流 IGS( E) S、阈值电压 VTH。IDSS( CES) 需连续 监测,此外,IDSS( CES) 、IGS( E) S、RDS( CE) on、VTH在老化前 后室温下测量进行对比。IDSS( CES) 超过限值或初始 值 10 倍( 含室温下) 或 IGS( E) S超过老化前 10 倍或 限值或 RDS( CE) on及 VTH漂移超过老化前 10%即认为 失效。值得一提的是,表 3 中 ECPE Guideline PSRRA 01 标准适用于近年来提出的 HV-H3TRB 加速老化测试。  2. 3. 2 算例分析 在相关标准提供模型参数的基础上,进行一 个简单的算例分析有助于合理选取相应测试条件。 如 2. 1. 3 所述,假设器件结温 TjU = 100 ℃ 、 相对湿度 10%,承受阻断电压 90% VDS( CE) max ; 加 速老化测试下,环境温 度 85 ℃ 、相 对 湿 度 85% RH、承受阻断电压 VDS( CE) max。假设式( 16) 中系 数 Ea = 0. 79 eV,x 为 3,y = 1. 37。计算得加速 老化因子等于 253,器件正常工况运行 30 年对应 的加速老化测试时间为 1 038 h。进一步地,根据 式( 19) 统计器件失效数 FITs 调整老化测试的样 本量,以 B = 60%,c = 0 ( Chi 2 ( 60%,0) = 1. 83) , FITs = 50 为例,按式( 21) 计算可得器件正常工况 运行 30 年下 253 的加速老化因子对应的测试样 本量 N= 70。 3 未来发展趋势 如前文所述,本文旨在以加速老化机理为基 础,从根本上解决测试标准繁多、测试条件确定原 则及选取不明的问题,进而为实际高温可靠性测 试提供理论依据和参考。 未来高温可靠性测试的发展趋势是: 根据器 件相应的运行工况确定其工作温度 TU、工作湿度 RHU、工作电压 VU 等,结合加速老化测试工况 TA、 RHA、VA、加速老化模型及其系数计算出加速老化 因子,在不改变失效机理且满足预期寿命相等的 前提下,通过改变测试条件如温度、湿度、偏置电 压等,进而对测试时间以及测试的样本量进行调 整,使得测试脱离于某一具体标准,变得更加灵活 可调,同时针对不同运行工况、器件特性对测试条 件进行调整,增加可靠性测试的精准性、高效性、 合理性。  图 3 所示为器件一次高温可靠性测试的流程 图,经过一次测试后,该器件在该工况下的加速老 化模型及其参数得以确定,通过不断迭代对模型 进行修正并为后续测试时间 t、测试样本量 N 的选 取提供依据。进一步地,通过已有模型及参数,在 相同老化机理及预期寿命下,增大测试条件 TA、 RHA、VA 的数值,以减少测试时间 t、测试样本量 N。 图3 中,需首先确定测试类型及相应老化模 型,此后根据器件相应运行工况确定 TU、RHU、VU、 TA、RHA、VA 等参数。进一步地结合模型参数,对 于新器件,该参数可参考前述 2. 1. 2、2. 2. 2、2. 3. 2 节进行合理选取并由此计算加速老化因子 AF,估计正常工况下工作寿命并除以 AF 得到器件加速 测试时间 t,进而结合置信度( 通常选取 60%、 90%) 、FITs( 若无测试数据,初值设为 50) , 根据式( 20) 计算得到测试样本量 N 进行一次加速 老化测试。测试结束后,统计器件失效信息,更新 FITs 并拟合模型参数,对原有参数进行更新迭代, 基于此重新计算测试老化时间 t 及测试样本量 N。此外,在相同老化机理及预期寿命下,增大测试条 件 TA、RHA、VA 的数值也可对上述两个参数进行改 变,实现高温可靠性测试的灵活可调,进而解决了 测试条件确定原则及选取不明的问题。 4 结 论 本文从单个或耦合的温度、电场、湿度加速老 化模型出发,结合标准或相关文献所给系数,分析 了不同模型及系数对器件寿命预测的影响,结合 电动汽车工况算例,得到了以下结论: ( 1) HTGB 加速老化测试以 E 模型、1 /E 模型 为基础,HTRB 加速老化测试以扩充 Eyring 模型、 逆幂律模型为基础,H3TRB 加速老化测试以 Peck 模型、HV-H3TRB 模型为基础,不同模型对寿命预 测结果影响可至 1 ~ 2 个数量级,系数选取受失效 模式、栅极工艺、钝化层及封装材料等影响。高温 可靠性测试需按照先加、后撤电场,后加、先撤温 度场的次序进行。 ( 2) 针对电动汽车用 1 200 V 的 IGBT 模块寿 命进行了计算,工况选取: TjU = 100 ℃、RHU = 10%、 VGE = 15 V、VCE = 90%VCEmax ; 加速老化测试下: TjA = 150 ℃ 或 85 ℃ ( HV-H3TRB) 、RHA = 85%、VGE = 20V、VCE = 100%VCEmax。计算得到器件正常工作寿 命 30 年对应 HTGB、HTRB、HV-H3TRB 测试需进 行 832 h、866 h、1 038 h,测试的样本数均为 70。 ( 3) 预测未来高温可靠性测试灵活可调的发 展方向,即在具体应用工况、具体器件特性下建立 相应加速老化模型,统计器件失效信息并对模型 参数进行迭代修正,使得测试环境、测试时间及测 试样本量都灵活可调,进而解决测试条件确定原 则及选取不明的问题。 |





