 之前我们介绍了HTOL、ESD和HAST等相关内容,今天汇总聊聊其他可靠性实验。 芯片设计公司常做的可靠性实验列表如下:  HTOL介绍参考: 老化寿命计算62 赞同 · 55 评论文章 老化机台及一些测试13 赞同 · 10 评论文章 ESD介绍参考: CDM测试(1)23 赞同 · 0 评论文章 CDM 测试(2)10 赞同 · 6 评论文章 Latch up的一些注意问题24 赞同 · 3 评论文章 BHAST介绍参考: 封装可靠性之BHAST25 赞同 · 9 评论文章 封装可靠性主要是用来激发一些封装过程中,及封装后芯片运输或者存储环境中遇到的可靠性问题,主要包括Precon、TCT、HTSL、UHAST、BHAST。每项可靠性包括不同的测试条件,不同的客户可以有针对性的选择特定的测试条件(测试条件的选择是对不同产品使用条件、成本方面的综合平衡,比如某些产品不需要超额,超额虽然质量和可靠性都提高了,但同时也提高了设计成本等。) Precon吸湿敏感、湿度敏感性试验 Precon旨在确认芯片样品是否因含有过多水份,在SMT回焊(Reflow)组装期间,造成芯片脱层(Delamination)、裂痕(Crack)、爆米花效应,导致寿命变短或损伤。 一般消费电子使用MSL3,最高等级是MSL1。有的时候为了加速验证的时间,我们可以使用快速precon,对应的条件如下:  Precon包括四个步骤: 1) Bake:用一定的温度和时间进行烘烤,模拟水汽被烘烤的过程。 2) Soak:对芯片进行浸润,模拟芯片的吸潮过程。 3) Reflow:模拟芯片上PCB板的过程,芯片一般到客户端,需要做SMT,封装可靠性问题很可能在SMT的过程中暴露出来,在温度变化的过程中,会产生膨胀、片脱层、爆米花效应等。 4) 最后FT测试和SAM同时判定样品是否失效。 TCT温度循环 影响筛选结果的主要参数为温度变化范围、温度变化速率及循环次数。常用实验有温度循环(Thermal Cycling)与温度冲击(Thermal Shock),温度冲击较温度循环温度变化速率更快。 无论是温度循环还是温度冲击,高低温变化对电子产品产生最直接的影响就是机械力作用,由于温度涨落,产品内部结构中产生循环应力应变,由此导致弯曲变形、裂纹或断裂热疲劳失效;由于不同结构材料膨胀系数的差异,在不同材料界面产生张应力和压应力,导致材料界面出现分层、裂纹、拉脱失效。主要影响电子产品的焊点、粘接界面、通孔、接插界面等部位的可靠性。  温湿度试验(Temperature with Humidity), 藉由高温、高湿、高压的加速因子,验证非密封性包装的电子零组件中,封装材质与内部线路对湿气腐蚀抵抗的能力,针对消费性元器件,JEDEC 定义测试条件包括,THB、 HAST、uHAST、PCT。  失效模式: 将待测产品放置于严苛之高温、高湿、高压测试环境,并同时施加电压,促使水气沿着胶体 (EMC)、导线架 (Lead Frame) 或基板 (Substrate) 的接口渗入产品内部,验证是否有以下失效情形: · 界面接合性 · 打线材料与芯片或铝垫间介金属化合物的变化 · 电解腐蚀 (Electrolytic Corrosion) 形成离子迁移 (Ion Migration),进而漏电短路 (Short-circuit Leak)  HTSL高温存储 高温存储实验模拟产品在整个生命周期中的热暴露,包括使用时和使用前(即存储),加速任何热激活的故障机制。 一个关键的例子是将这种压力用于 EEPROM 数据保持测试。 评估粘合区柯肯德尔空洞率的主要测试(柯肯特尔效应)在引线键合封装和凸块封装中加速封装中的扩散。柯肯达尔效应可参考之前的介绍: Kirkendall效应?20 赞同 · 3 评论文章 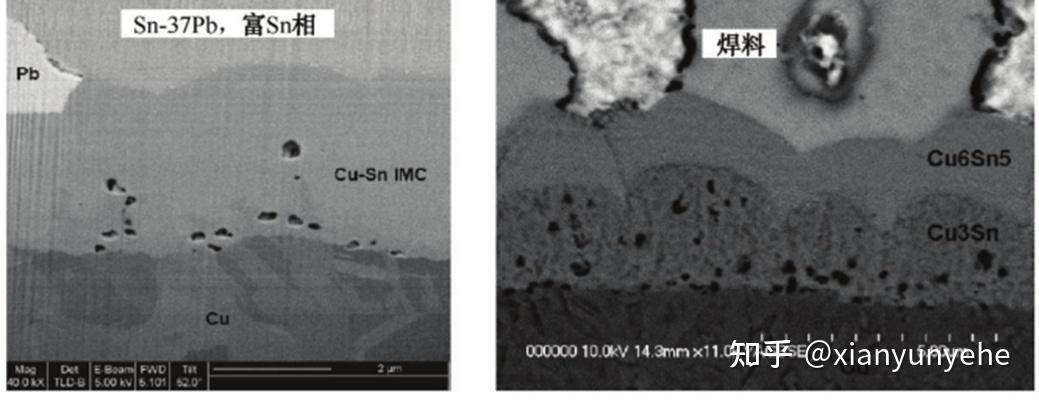 |





