芯片中的CP一般指的是CP测试,也就是晶圆测试(Chip Probing)。一、CP测试是什么CP测试在整个芯片制作流程中处于晶圆制造和封装之间,测试对象是针对整片晶圆(Wafer)中的每一个Die,目的是确保整片(Wafer)中的每一个Die都能基本满足器件的特征或者设计规格书,通常包括电压、电流、时序和功能的验证。 CP测试的具体操作是在晶圆制作完成之后,成千上万的裸DIE(未封装的芯片)规则的分布满整个Wafer。由于尚未进行划片封装,只需要将这些裸露在外的芯片管脚,通过探针(Probe)与测试机台(Tester)连接,进行芯片测试就是CP测试。  图 1 CP Test在芯片产业价值链上的位置 二、为什么要做CP测试 因为通常在芯片封装阶段时,有些管脚会被封装在芯片内部,导致有些功能无法在封装后进行测试,因此Wafer中进行CP测试最为合适。 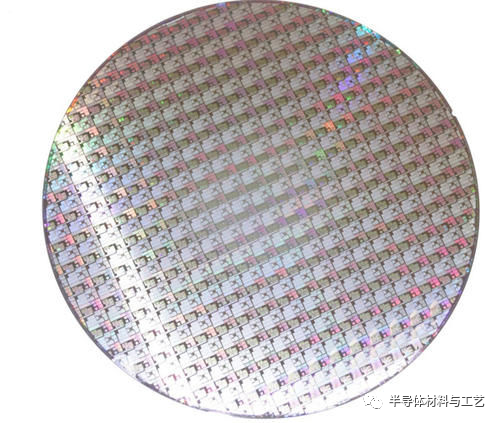 图 2 Wafer上规则的排列着DIE 而且Wafer制作完成之后,由于工艺偏差、设备故障等原因引起的制造缺陷,分布在Wafer上的裸DIE中会有一定量的残次品。CP测试的目的就是在封装前将这些残次品找出来(Wafer Sort),同时还可以避免被封装后无法测试芯片性能,优化生产流程,简化步骤,同时提高出厂的良品率,缩减后续封装测试的成本。 另外,有些公司会根据CP测试的结果,将芯片划分等级,将这些产品投入不同的市场,购买者需要注意这一点。 三、测试内容有哪些 1、SCANSCAN用于检测芯片逻辑功能是否正确。DFT设计时,先使用DesignCompiler插入ScanChain,再利用ATPG(Automatic Test Pattern Generation)自动生成SCAN测试向量。SCAN测试时,先进入Scan Shift模式,ATE将pattern加载到寄存器上,再通过Scan Capture模式,将结果捕捉。再进入下次Shift模式时,将结果输出到ATE进行比较。 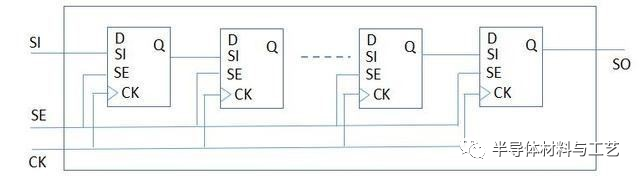 图 3 Scan Chain示意图 2、Boundary SCANBoundary SCAN用于检测芯片管脚功能是否正确。与SCAN类似,Boundary SCAN通过在IO管脚间插入边界寄存器(Boundary Register),使用JTAG接口来控制,监测管脚的输入输入出状态。 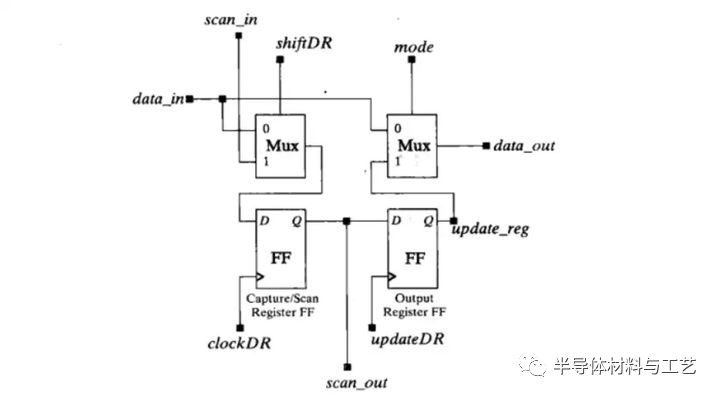 图 4 Boundary Scan原理图 四、测试方法有哪些 1、DC/AC TestDC测试包括芯片Signal PIN的Open/Short测试,电源PIN的PowerShort测试,以及检测芯片直流电流和电压参数是否符合设计规格。AC测试检测芯片交流信号质量和时序参数是否符合设计规格。2、RF Test对于无线通信芯片,RF的功能和性能至关重要。CP中对RF测试来检测RF模块逻辑功能是否正确。3、存储器存储器测试数量较大,因为芯片往往集成着各种类型的存储器(例如ROM/RAM/Flash),为了测试存储器读写和存储功能,通常在设计时提前加入BIST(Built-In SelfTest)逻辑,用于存储器自测。芯片通过特殊的管脚配置进入各类BIST功能,完成自测试后BIST模块将测试结果反馈给Tester。  (1)ROM(Read-Only Memory)通过读取数据进行CRC校验来检测存储内容是否正确。 (2)RAM(Random-Access Memory)通过除检测读写和存储功能外,有些测试还覆盖DeepSleep的Retention功能和Margin Write/Read等等。 (3)Embedded Flash除了正常读写和存储功能外,还要测试擦除功能。 (4)Wafer还需要经过Baking烘烤和Stress加压来检测Flash的Retention是否正常。 (5)还有Margin Write/Read、Punch Through测试等等。 4、其他Function Test芯片其他功能测试,用于检测芯片其他重要的功能和性能是否符合设计规格。随着芯片工艺越来越先进,晶体管密度越来越高,芯片测试的复杂度和难度也成倍地增长。 五、了解一下CP测试的流程。 1、设有自测程序的芯片首先有一部分比较特殊的芯片要单独区分出来,就是昨天我们说到的自设自测程序的存储类型芯片,这些芯片在设计之初就准备好了TestPlan,根据各自芯片的规格参数就已经规划好了测试内容和测试方法。 芯片通常会准备若干种TestMode功能,通过配置管脚使芯片进入指定的测试状态,从而完成各个类型的测试。如:ATPG可输出WGL或STIL格式文件供Tester使用。BIST(Built-In SelfTest)逻辑。这些自测逻辑完成对ROM/RAM/Flash等功能的测试。Function Test Mode。一些专门的功能测试需要增加硬件逻辑,例如ADC/DAC/时钟等。想了解的可以查看金誉半导体上一篇更新的文章,里面有详细说明。 2、挑选测试厂和测试机型首先我们需要选择有实力的测试厂和匹配的测试机型,测试厂和测试机的选择要考虑芯片类型、测试内容、测试规格和成本等因素。 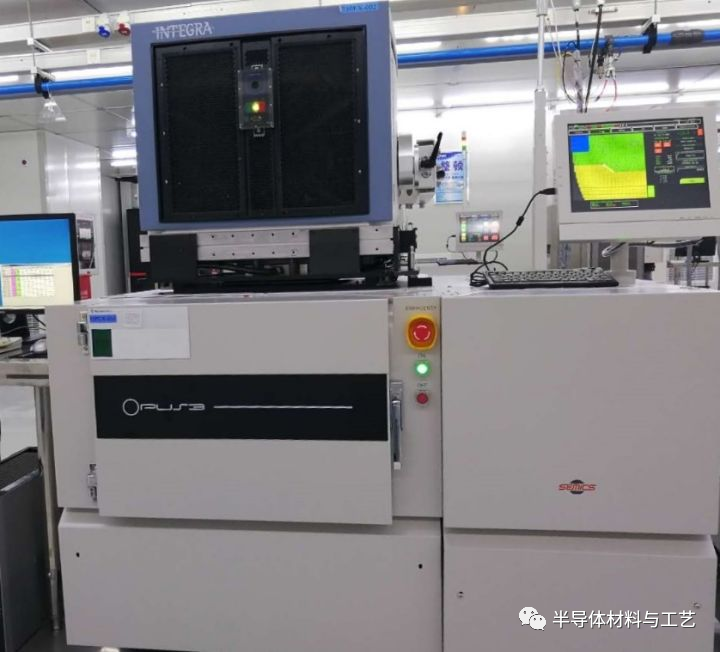 ATE机器 ATE机器选择机型方面,根据芯片的类型和测试内容不同,测试机台又分为很多系列:例如存储器芯片Advantest T55xx 系列等、数字混合信号或SoC芯片Teradyne J750 系列等,RF射频芯片Credence ASL-3000 系列等。 3、制作ProbeCard以及Test Program选择好测试机后,接下来就需要制作探针卡(ProbeCard)和测试程序(Test Program)。ProbeCard包括探针和芯片外围电路。在芯片设计的时候,每一个DIE和DIE上的每一个芯片管脚的坐标和艰巨信息,都在投产之前已经确定,根据这些参数就可以开始制作探针了。可让芯片一个个去测量大耗时,因此探针卡还可以选择同测数(Site),可同时测量多个芯片,减少测试机台数还能节约时间成本,但是受限于测试机台资源,同测数也有上限,例如32/16/8/4。探针的材质也有不同的选择,有钨铜、铍铜或钯等材料,这些探针在强度、导电性、寿命、成本等方面都有各有的特点,根据需求进行选择即可。 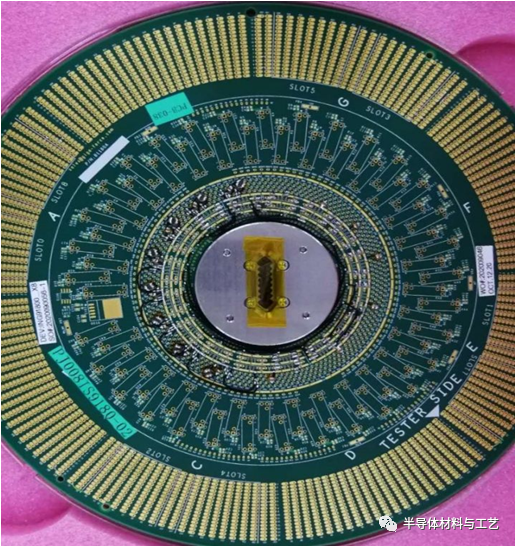 ProbeCard照片 Test Program是测试程序。测试程序控制整个机台的测试过程。不同的测试机有不同的测试软件系统,对应的测试程序也有不同的格式。通常工程师提供WGL/STIL/VCD等格式的文件,再转换成测试机需要的文件格式,并增加其他测试程序。 4、调试以及结果分析调试的时候根据TestPlan,Pattern(测试向量)被分作不同的BIN,从而定位测试错误的位置。调试时还可以在系统上直接看到一个Pattern中错误的Cycle位置,工程师根据这些错误信息进行调试,修改Pattern和测试程序,逐个清理,直到所有BIN都通过。再把同测的多Site全部调试通过,如此循环多轮后,便可以开始试运行。此时工程师还要调试探针力度、清理探针周期等参数,确保整片Wafer上每一次Touchdown都可以测试稳定。 最后整片Wafer的测试结果会生成一个晶圆图文件,数据生成一个日志文件,例如STD文件。晶圆图主要包含良率、测试时间、各BIN的错误数和DIE位置,日志文件则是具体的测试结果。工程师通过分析这些数据,决定是否进入量产。  WaferMap截图 5、再次调试,优化流程最后就是进入量产阶段,根据大量测试的统计数据,可以进行一些调整以进一步优化测试流程。这一阶段可以决定是否对出错的DIE进行复测,通常复测可以纠正一定比例的错误,但是要多用一部分测试时间,所以要综合考虑后再决定是否复测。通常处于Wafer边缘位置的DIE出错的概率较高,综合考虑,有时可以直接将边缘DIE剔除,不进行测试就标为坏品,以节省测试时间。另外,还需要关注良率是否稳定,当连续出现良率较低的情况时,需要停止测试,进行数据分析,检查设备或与代工厂沟通。 接下来才是进入真正的量产,这时只需要把CP测试的结果交给后续封装厂即可。通常是一个含有分BIN信息的Map文件,封装厂根据Map文件挑选好品封装,剔除坏品,还可以保留客户选择的特殊BIN别。 |





