|
2交流参数
1) 测试方法——在规定的测试频率和电压VCE、电流IC条件下,在fT测试仪上测出fT。 2)fT的大小决定于——
●输出电容——Cob (单位:pF ) 1) 测试方法——在规定的测试频率和电压VCB条件下,在Cob仪上测出Cob 。 2)Cob的大小决定于——
延迟时间——td,上升时间——tr,储存时间——ts, 下降时间——tf(其中,ts和tf是两个主要的时间参数)
2)tf 的大小主要决定于——
3极限参数 ●集电极最大电流——ICM(单位:A) 1)定义——hFE 下降到最大值的1/2时的集电极电流值,为ICM。 2)提高ICM的措施有——
●最高结温 Tjm 1) 定义——晶体管中P-N结所能承受的最高温度,叫Tjm。 2) Tjm的大小与半导体材料的性质、电阻率有关。 对硅晶体管来说,Tjm=150-200℃。 集电极最大耗散功率——Ptot(PCM) 1)Ptot与最高结温Tjm、热阻RT的关系式 Ptot = Tjm—Ta / RT Ptot = Tjm—Tc / RT 2) 要提高Ptot——降低RT——就要——
第二章晶体管制造工艺与原理
2-1 典型产品工艺流程 2-1-1 晶体管的基本工艺流程 一次氧化——一次光刻——基区扩散——二次光刻——发射区扩散——三次光刻(引线孔)——蒸发——四次光刻——合金——中测——减薄——背金——划片——后道组装——成测——打印——包装——出厂。 2-1-2 典型产品的芯片工艺流程 1 节能灯系列产品 三扩片(三扩、磨抛)——一次(水汽)氧化——一次光刻——基区CSD淀积——二次氧化——基区扩散——二次光刻——POCL3淀积——发射区氧化扩散——PGSCVD——HCL氧化——三次光刻——蒸发——四次光刻——N2合金——N2烘焙——PIA光刻——减薄(喷砂)——背蒸——中测——划片。 2 高反压大功率系列 三扩片(三扩、磨抛)——基区CSD淀积——(水汽)二次氧化——基区扩散——二次光刻——POCL3淀积——P+CSD淀积——发射区氧化扩散——PSGCVD——氧退火——三次光刻——斜槽切割——台面腐蚀——电泳玻璃——烧玻璃——CVD(UDO+SIN)——四次光刻——蒸发——五次光刻—— N2合金——H2处理——N2烘焙——喷砂——背蒸——(涂硅油)中测 ——(去油)划片。 3 超高频大功率系列 外延片——一次氧化——一次光刻——P+CVD——P+扩散——P+氧化——磷吸杂——湿氧氧化——一次光刻A——H/O合成——一次光刻B——基区注入——基区扩散——二次光刻——POCL3淀积——铝下CVD——发射区扩散——三次光刻——蒸发——四次光刻——H2合金——铝上CVD——五次光刻——N2烘焙——中测——减薄——背蒸——划片。
2-2 晶体管制造主要工艺的作用与原理 2-2-1 氧化工艺 1 氧化的作用: 1)P-N结表面保护(表面沾污——影响器件成品率和可靠性,SIO2能把P-N结表面覆盖起来,起到保护作用)。(图19a) 2)掩蔽杂质扩散(SIO2性能稳定,在高温下能掩蔽硼、磷等杂质的扩散,从而达到选择扩散的目的。)(图19b)
1)氧化法——水汽氧化、湿氧氧化、干氧氧化、氢氧合成 2) CVD法——生长UDO(不掺杂氧化层) 3)其它方法 3 氧化层厚度的测量——膜厚测试仪(根据光的干涉原理)。 4 氧化层的质量要求 ★氧化层颜色均匀一致,光亮清洁。 ★表面无斑点、裂纹、白雾、发花和针孔。 ★氧化层致密、均匀、并达到厚度要求。 |




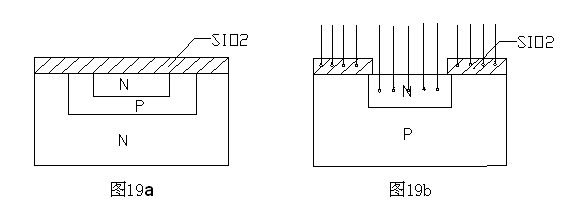 2 氧化层的生长方法
2 氧化层的生长方法
