晶圆级封装(WLP)工艺流程
时间:2024-07-01 20:11来源: Tom Tom聊芯片智造 作者:ictest8_edit 点击:
次
【本号可承接半导体行业广告,联系Tom:m637808】
知识星球(星球名:芯片制造与封测技术社区,星球号:63559049)里的学员问:晶圆级封装的工艺流程,可以详细说说吗?
什么是晶圆级封装?
晶圆级封装(Wafer-level packaging, WLP)是直接在晶圆上进行封装的技术。晶圆级封装相较于传统的封装技术,采用的是半导体制造的相关工艺。与传统封装不同的是,晶圆级封装是在切割晶圆成单个芯片之前,在整个晶圆上进行封装过程。
晶圆级封装的工艺流程?
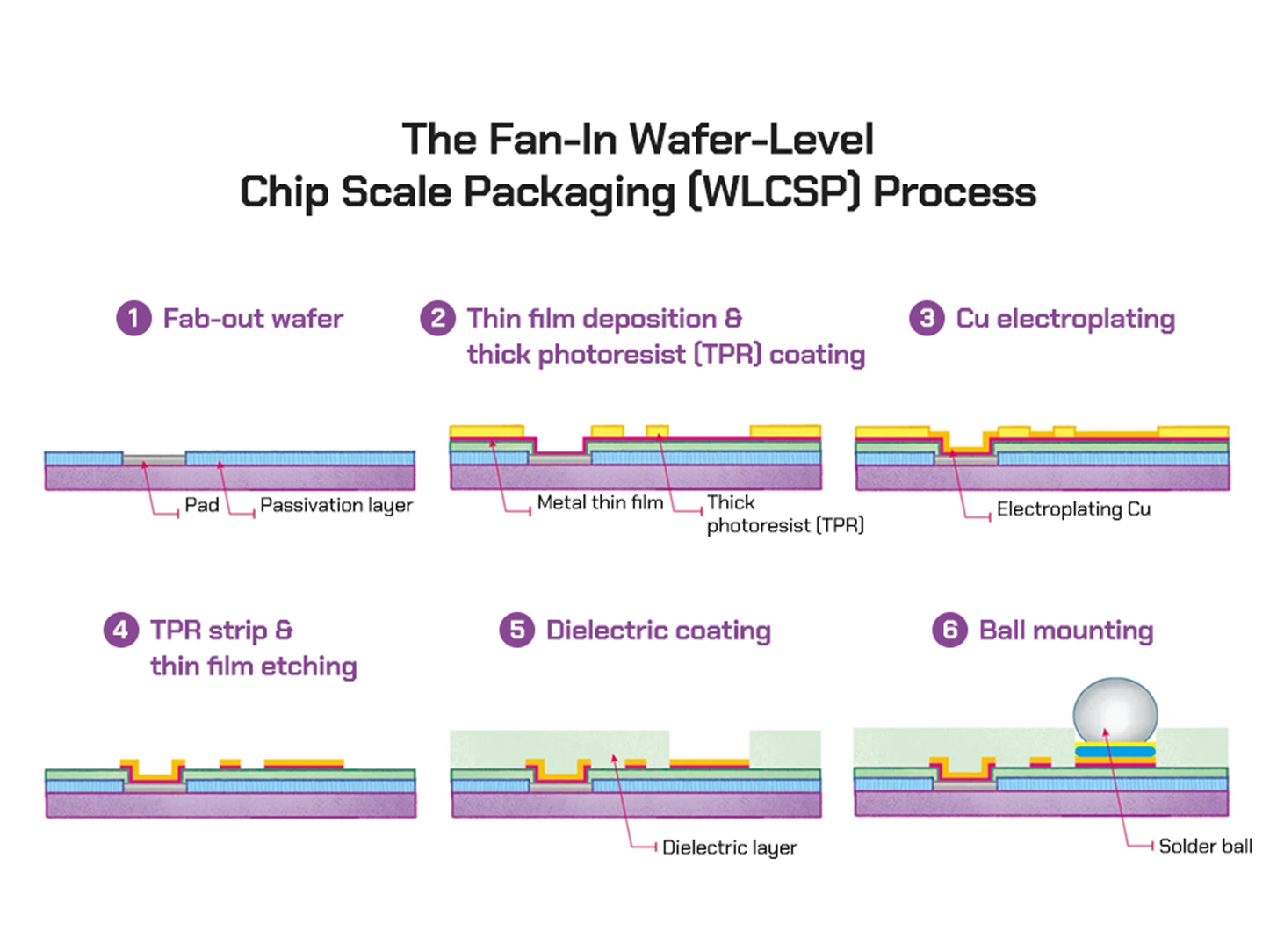
如上图,是WLP Fan in的基本工艺流程:
1. Fab-out Wafer
晶圆准备,这是整个封装过程的起始步骤。首先要有一个经过制造过程完成的晶圆,上面已经形成了电路结构。在晶圆的表面的钝化层(Passivation Layer),用于保护晶圆表面的电路不受外界湿气,化学物质的影响。
2. Thin Film Deposition & Thick Photoresist (TPR) Coating
薄膜沉积:在钝化层上沉积一层金属薄膜,通常是Ti,Cu,Cr,Au等,作为电镀的金属种子层。
厚光刻胶涂覆:在金属薄膜上涂覆一层厚光刻胶并曝光显影,该步将特定区域打开,有些部位则被光刻胶盖住。
3. Cu Electroplating
铜电镀:通过电镀工艺在已经图形化的光刻胶上电镀铜层。这一步是形成较厚的RDL,将PAD上的信号引出。
4. TPR Strip & Thin Film Etching
光刻胶去除:移除覆盖在不需要电镀的地方的光刻胶,暴露出下面的金属层。薄膜蚀刻:蚀刻掉未被光刻胶保护的金属薄膜部分,一般用湿法刻蚀的方法。
5. Dielectric Coating
介电层涂覆:在已经形成的金属结构上涂覆一层介电材料如氧化硅或PI等,以隔离金属层并保护它们不受外界环境的影响。
6. Ball Mounting
锡球安装:在介电层上的打开位置安装焊球。锡球用于实现芯片到电路板的电气连接。
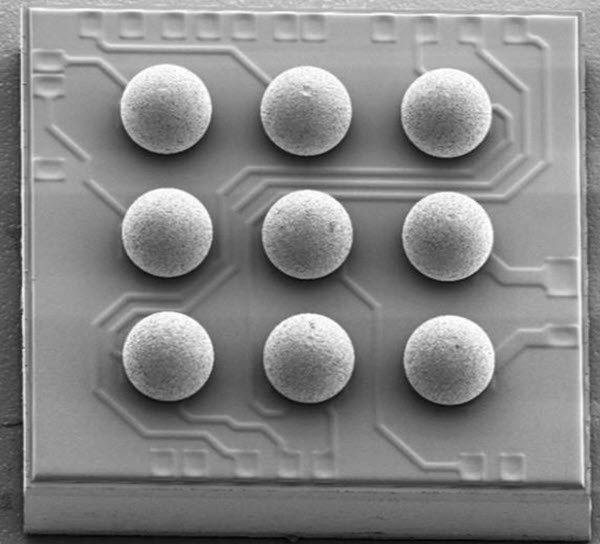
至此,晶圆级封装工艺流程结束。
|
------分隔线----------------------------