|
本文详细讲解了IC及相关电子元器件失效分析技术,从失效分析步骤到具体操作程序,如:X-RAY,IC开帽(decap),C-SAM,EBT等,并举以实例,是一篇很好的IC失效分析参考资料。主要内容如下:
一、电子元器件失效分析技术
1.1、失效分析的基本概念
1.2、失效分析的重要意义
1.3、失效分析的一般程序
1.4、收集失效现场数据
1.5、以失效分析为目的的电测技术
1.6、无损失效分析技术
1.7、样品制备技术
1.8、显微形貌像技术
1.9、以测量电压效应为基础的失效定位技术
1.10、以测量电流效应为基础的失效定位技术
1.11、电子元器件化学成份分析技术
1.1 失效分析的基本概念
目的: 确定失效模式和失效机理,提出纠正 措施,防止这种失效模式和失效机理重复出现。
失效模式:指观察到的失效现象、失效形 式,如开路、短路、参数漂移、功能失效等。失效机理:指失效的物理化学过程,如疲劳、 腐蚀和过应力等。
引起开路失效的主要原因:
过电损伤、静电击穿(SEM、图示仪)、金 属电迁移、金属的化学腐蚀、压焊点脱落、闩锁效应。其中淀积Al时提高硅片的温度可以提高Al原 子的晶块体积,可以改善电迁移。
典型的闩锁效应电源对地的I-V曲线

引起漏电和短路失效的主要原因:
颗粒引发短路、介质击穿、PN结微等离子击 穿、Si-Al互溶
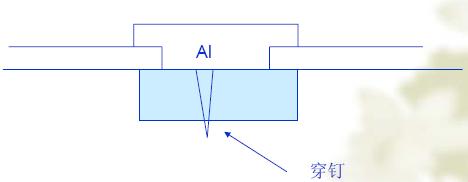
引起参数漂移的主要原因:
封装内水汽凝结、介质的离子粘污、欧姆接 触退化、金属电迁移、辐射损伤
例:
Pad点处无钝化层,有水汽的话,会导致短 路,水汽蒸发后又恢复绝缘性,表现为工作 时参数不稳定。
失效物理模型:
1、应力-强度模型(适于瞬间失效)
失效原因:应力>强度
例如:过电应力(EOS)、静电放电(ESD)、闩锁(Latch up)等。
2、应力-时间模型(适于缓慢退化)
失效原因:应力的时间积累效应,特性变化 超差。
例如:金属电迁移、腐蚀、热疲劳等。
1.2失效分析的重要意义
电子元器件研制阶段
纠正设计和研制中的错误,缩短研制周期
电子元器件生产阶段、测试和使用阶段 查找失效原因,判定失效的责任方
根据分析结果,生产厂可以改进元器件的设计和工艺,用户可以改进电路板的设计、改进器件和整机的测试和使用的环境参数或者改变供货商。
失效分析案例
案例1:GaAs微波器件的失效分析,表现为缓慢减小,通过研究金属-半导体接触退化的机理,确定了金半接触处原子互扩散是根本原因,提出了增加阻挡层作为改进措施,通过对比改进前后的可靠性评价,证明了失效分析的有效性。
1.3失效分析的一般程序
1、收集失效现场数据
2、电测并确定失效模式
3、非破坏性分析
4、打开封装
5、镜检
6、通电激励芯片
7、失效定位
8、对失效部位进行物理、化学分析
9、综合分析,确定失效原因,提出纠正措施
1.4 收集失效现场数据
1.4.1、应力类型与元器件失效模式或机理的关系举例

1.4.2收集失效现场数据的主要内容
失效环境、失效应力、失效发生期以及失效 样品在失效前后的电测试结果。
失效环境包括:温度、湿度、电源环境、元器件在电路图上的位置和所受电偏置的情况。
失效应力包括:电应力、温度应力、机械应力、气候应力和辐射应力。
失效发生期包括:失效样品的经历、失效时间处于早期失效、随机失效或磨损失效。
1.5以失效分析为目的的电测技术
电子元器件的电测失效分类:
连接性失效(开路、短路、电阻变化等) 多数是ESD和EOS引起的,比例大概50%。
电参数失效(值超出范围和参数不稳定) 例如:电流增益、光电流、暗电流等。
功能失效(给定输入信号,输出异常) 多数是集成电路。
电子元器件电测失效之间的相关性
例如数字集成电路,连接性失效可引起电参
数失效和功能失效。
输入端漏电->输入电流Iin、输入电压Vin达不到要求->功能失效、静态电流IDDQ失效
输入端开路和输出端开路->功能失效
电源对地短路->功能失效、静态电源电流IDDQ失效
电测的重要结论:
电测失效模式可能多种模式共存。
一般只有一个主要失效模式,该失效模式可能引发 其他失效模式。
连接性失效,电参数失效和功能失效呈递增趋势,功能失效和电参数失效时常可以归结于连接性失效。在缺少复杂功能测试设备时,有可能用简单的连接性测试和参数测试,结合物理失效分析技术,仍然可以获得令人满意的失效分析结果。
1.6无损失效分析技术
定义:不必打开封装对样品进行失效定位和失效分析的技术。
无损失效分析技术:X射线透视技术和反射式扫描声学显微技术(C-SAM)
表2、X射线透视技术和反射式扫描声学显微术(C-SAM)的比较

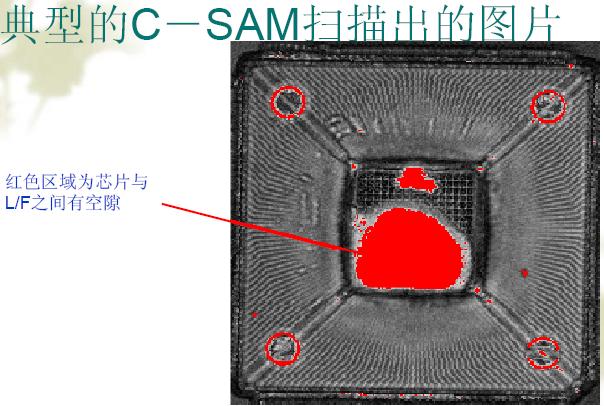
1.10基于测量电流效应的失效定位技术
1、显微红外热像分析技术
2、液晶热点检测技术
3、光辐射显微分析技术(PEM)
(Photo Emission Microscope)
1.10.1显微红外热像分析技术
1、测试原理:
芯片通电过程中会发热,由于芯片各部位电流强度不同,导致芯片表面温度不同,红外热像仪扫描整个芯片,可以获得芯片温度分布图。输出图的颜色对应该点的温度。
2、仪器性能指标:
热分辨率0.1℃,空间分辨率5um,测温范围30℃~550℃,最灵敏温度范围80℃~180℃。
10.2 液晶热点检测技术
1、什么是液晶:
液晶是一种既具有液体的流动性,又具有晶体各向异性的物质。它具有一个独特性质,当温度高于某一临界温度Tc时,就会变成各向同性。
2、液晶热点检测设备要求
偏振显微镜(长工作距离)温控样品台(温度精度0.1 ℃)样品的电偏置(prober或packaged device)
3、液晶热点检测的关键技术
显微镜在正交偏振光下观察,提高图象对液晶相变的灵敏度应控制样品温度在临界温度上下反复变化,以便找到合适的工作点检测时若偏置电压偏高,图象会变模糊,可改用脉冲偏置电压以改善图象质量
液晶热点检测的特点
1、速度快,大概10分钟就能做一次分析。
2、空间分辨率(1um)和热分辨率(3uw)
3、适用不良种类:
确定芯片能耗分布,确定漏电通道,PN结内
不规则的电流分布,CMOS电路闩锁区域等
10.3 光辐射显微分析(PEM)
1、原理:
半导体许多缺陷类型在特定电应力下会产生漏电,并伴随电子跃迁而导致光辐射。
2、操作方法:
首先,在外部光源下对制品进行数码照相。然后对此局部加偏压(直流偏压或信号),并在不透光的暗箱中进行微光照相。
最后两相片叠加。
3、适用范围:
漏电结、接触尖峰、氧化缺陷、栅针孔、静电放电(ESD)损伤、闩锁效应(Latch up)、热载流子、饱和晶体管及开关管等
4、缺点:
有些光辐射是正常的器件,如饱和晶体管,正偏二极管等。有些很明显的失效并不产生光辐射,如欧姆型短路等。还有些缺陷虽产生辐射,但由于在器件的深层或被上层物质遮挡,无法探测。
5、优点:
操作简单、方便,可以探测到半导体器件中的多种缺陷和机理引起的退化和失效,尤其在失效定位方面具有准确、直观和重复再现性。
无需制样,非破坏性,不需真空环境,可以方便的施加各种静态和动听过的电应力。
精度:几十PA/um2,定位精度为1微米。
另外还有光谱分析功能,通过对辐射点的特征光谱分析来确定辐射的性质和类型。
光辐射显微分析技术分析实例
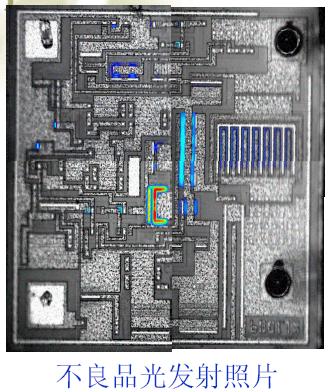 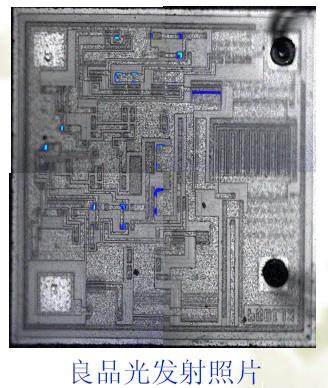
1.11 电子元器件化学成份分析技术
1、重要性:
器件失效主要原因是污染(颗粒污染和表面污染),确认污染源是实施改进措施的先决条件。
另外,界面之间原子互扩散也会引起特性退化和失效,也许要化学分析确认。
……………………
……………………
其余内容以及相关技术资料请下载参考:
电子元器件失效分析技术
失效分析技术及经典案例1
失效分析技术及经典案例2
失效分析技术及经典案例3
|





